-
基于可以产生动能可控带电粒子的特点,离子源已广泛应用于材料的清洗、超精加工、表面改性、薄膜沉积和蚀刻等领域[1-7]。在各种离子源中,射频感应耦合等离子体(Inductively Coupled Plasma, ICP)离子源由于其具有等离子体发生器结构简单、等离子体密度高、纯度高、引出离子束稳定可控等优点,引起了人们的广泛关注[8-11]。
高密度、高均匀性的等离子体是引出大面积、高流强、均匀离子束的重要条件之一。本文以提高等离子体密度及径向均匀性为目的,针对一款放电腔室直径为60 mm的平面型ICP离子源,应用COMSOL软件进行仿真实验,研究了射频天线及放电腔室结构参数对氩气放电等离子体特性的影响,并将模拟结果应用于离子源实验装置的研制,实现了氩离子束的稳定引出。
-
在等离子体流体模型中,为了满足计算域中的质量守恒,每一种流体都被看作是分离的流体。电子密度和电子能量密度由漂移-扩散方程给出。方程如下[12-13]:
式中ne和nε分别为电子密度和平均电子能量密度。
$ {\varGamma }_{{\mathrm{e}}} $ 和$ {\varGamma }_{ \text{ε} } $ 分别为电子密度通量和电子能量通量。Re和Sen分别是源项。u是流体速度。μe和με分别为电子迁移率和电子能量迁移率。De和Dε分别为电子扩散率和电子能量扩散率。E是空间静电场。放电腔内壁上的电子通量和电子能量通量如下方程给出:
式中,
$ n $ 为向外法向量。$ r $ 是放电腔内壁材料的电子反射系数。$ v\mathrm{_{th}} $ 是电子热速度。电子热速度由下式给出:其中,kb为玻尔兹曼常数,Te为电子温度,me为电子质量。
模型中重物质的质量守恒是指系统中除电子外的所有粒子,包括氩原子、氩离子和激发态氩原子需满足质量守恒方程。重粒子质量守恒方程如下:
该方程中ρ为混合物的密度。wk为第k种粒子的质量分数。u是流体速度。Jk是第k种物质的质量通量。Rk是第k种粒子的源项。
二维感应耦合氩等离子体模型中的电磁场方程则是由麦克斯韦方程组得到的频域磁矢量势计算得到:
方程中j是虚部,ω是电源的角频率,σ是等离子体电导率。ε0和εr分别为材料的真空介电常数和相对介电常数;μ0和μr分别为特定介质的真空磁导率和相对磁导率,其取值均来自COMSOL材料数据库。Aφ是磁矢量势。Je是感应电流。
模型内部静电场由泊松方程给出:
该式中,ρ是空间电荷密度,V是等离子体电势。空间电荷密度ρ是根据电子及其他带电粒子的数密度来计算的:
Zk是第k种物质的电荷数,nk是第k种物质的数密度。
-
图1为二维平面型线圈感应耦合氩等离子体发生器仿真实验的几何模型及网格剖分设置,模型以z轴为对称轴旋转360°即得到圆柱形ICP发生器的三维模型。
仿真模型初始条件设定为:放电腔内部为半径30 mm,放电腔材料为石英。放电腔内工作气体为氩气,气体压强为100 mTorr;射频天线为纯铜材料的线圈组,线圈组件周围为空气,线圈通入的射频功率P为200 W,射频频率f为13.56 MHz,气体温度300 K。表1为模型中所需的氩等离子体化学反应。
-
本节使用数值模拟的方法研究了该ICP离子源射频天线及放电腔结构参数对氩等离子体特性的影响,其结果可为离子源实验装置的研制提供一定的理论指导。
-
射频天线的结构参数会直接影响空间感应电磁场的位型,进而影响功率耦合效率和等离子体特性,通过调整天线的匝间距及其与介质窗口之间的间隙可以改变放电腔内氩等离子体的密度分布。如图2所示,均匀绕制的天线(Ⅰ)结构为r1=9.5 mm,r2=15.5 mm,r3=21.5 mm,r4=27.5 mm,优化后的非均匀绕制天线(Ⅱ)结构为r1=9.5 mm,r2=17.5 mm,r3=23.0 mm,r4=27.5 mm,第一匝天线与介质窗口之间的间隙为1.0 mm。
图3为优化前后两种天线在r=0 mm处轴向Ar+密度分布及Ar+密度最大值nmax处径向Ar+密度分布曲线。Ar+密度在放电腔内r=0 mm,z=17.5 mm处达到最大值。本文用平均Ar+密度nave和径向非均匀性α评估ICP的密度和径向均匀性,相比于均匀结构天线(Ⅰ),阶梯式线圈且内圈匝间距大外圈匝间距小的结构天线(Ⅱ)提高了放电腔内3.7 %的Ar+平均密度和z=17.5 mm处5 %的径向均匀性。这里的α定义为:
其中,
$ {n}_{\min} $ 为Ar+密度最小值。 -
由于阶梯状线圈的内圈与介质窗口存在间隙,考虑间隙对射频功率耦合效率的影响,研究了两种介质窗口结构,即平面式(a)和阶梯式(b)介质窗口产生ICP的Ar+密度分布,模拟结果如图4所示, 图5为Ar+密度分布曲线。
计算结果表明,在放电腔上半区,阶梯式介质窗口的ICP发生器具有高于平面式介质窗口的Ar+密度。阶梯式介质窗口ICP发生器的nave为2.103×1018 m−3,而平面式介质窗口的nave为2.061×1018 m−3,氩气电离率提高了大约2 %,但径向均匀性降低了1.5 %。此外,离子密度仅在放电腔上半区变大,而引出系统附近的等离子体密度分布并无差异。阶梯式会更容易造成材料溅射污染等问题。因此平面式介质窗口更适用于离子源的研制。
-
放电腔的高度h会直接影响到ICP发生器产生的等离子体密度及其分布,需根据离子源的尺寸和指标对h进行设计。图6为h=28、38、48、58 mm时产生氩等离子体的Ar+密度分布仿真实验结果。
图7为r=0 mm处轴向Ar+密度分布及Ar+密度最大值nmax处径向Ar+密度分布曲线。仿真结果表明,h=28 mm的放电腔产生的Ar+平均密度明显低于其他高度放电腔产生的Ar+密度,nave仅为1.759×1018 m−3。随着h的增加,nave先增大后减小,在h=38 mm时达到最大值nave=2.016×1018 m−3。且随着h的增大,放电腔内产生的氩等离子体受射频天线静电场作用汇聚在靠近介质窗口的区域而远离放电腔下方的离子引出电极,这不利于离子的高效引出。综上,放电腔高度确定为38 mm。
-
将上述模拟结果应用于ICP离子源的研制,并搭建了实验装置。图8为离子源结构示意图,图中标注分别为:(1)感应线圈,(2)石英放电腔,(3)等离子体电极,(4)加速电极,(5)接地电极。
离子源实验平台及示意图如图9所示,离子束电流由放置于真空室内部距接地电极50 mm处的法拉第杯测得;光谱诊断系统采用了八通道高分辨率光纤光谱仪(Avantes-ULS2048), 将光纤探头置于ICP放电腔体外, 探头与石英材料距离2 mm, 测量引出系统入口处的径向发射光谱数据, 由计算机采集并储存数据。
在天线馈入功率为80 W,通气后腔体气压为13 Pa,氩气流量为5 mL/min,等离子体电极电压为1300 V,加速电极为−300 V的工况下,可从真空室观察到明亮的离子束被引出,最大离子束电流为0.24 mA。图10分别展示了不同实验参数下,从真空室窗口目测束流引出情况,图10 (a)等离子体电极电压为600 V,加速电极电压为0 V,图10 (b)为等离子体电极电压为1300 V,加速电极电压为−300 V。
图11为光谱诊断的探测位置,针对引出系统入口处离子的径向分布,本文通过诊断波长982.24和434.80 nm的两条Ar谱线,分析等离子体在径向的分布[14]。
图12为引出系统入口上方3 mm处5个探测点测得的Ar (982.24、434.80 nm)谱线的强度,结果表明在同一水平高度,Ar谱线强度随径向位置的改变变化很小,表明等离子体径向分布均匀性较好。
-
针对放电腔直径为60 mm的射频ICP离子源研制,使用数值模拟的方法研究了射频及放电腔结构对氩气放电ICP特性的影响,确定了合适的天线及放电腔结构并搭建了离子源装置实验平台,结论如下:
(1) 设计的非均匀绕制射频天线结构相比于均匀绕制天线可同时提高氩离子的密度及其径向均匀性。
(2) 阶梯式介质窗口可以提高离子密度但会降低径向均匀性,并容易造成介质窗溅射带来的等离子体的污染。
(3) Ar+平均密度随着放电腔高度的增加,先增大后减小,在h=38 mm时达到最大值。当放电腔高度太小时会大幅度降低系统的电离率,产生较低密度的等离子体;当放电腔过高,等离子体会受射频天线静电场作用偏向介质窗口方向,导致离子引出效率变低。
(4) 模拟结果用于指导射频ICP离子源的设计,通过实验装置的搭建和测试,诊断了引出系统入口处等离子体的径向均匀性,并得到了稳定引出的0.24 mA均匀氩离子束。
感应耦合等离子体离子源放电特性仿真研究
Simulation of Discharge Characteristics of Inductively Coupled Plasma Ion Source
-
摘要: 针对于一款放电腔直径为60 mm的射频感应耦合等离子体离子源,采用数值模拟的方法研究了射频天线和放电腔结构对氩离子密度分布的影响。结果表明,相比于均匀绕制线圈,非等匝间距的射频天线可有效提高所产生等离子体中氩离子平均密度与其径向均匀性均;氩离子密度随着放电腔高度的增大先增大后减小,在高度为38 mm时达到最大值;使用阶梯式介质窗虽然可以提高氩离子的密度,但也增加了其被溅射的风险。将模拟计算结果应用于离子源实验装置的研制,实现了0.24 mA氩离子束稳定引出。Abstract: The effects of the radio-frequency (RF) antenna and the structure of the discharge chamber with a diameter of 60 mm on the distribution of argon ions were studied by numerical simulation. The results show that the average density of argon ions and its radial uniformity of plasma are effectively improved by using an RF antenna with non-uniform turn spacing compared with those by using an antenna with a uniformly wound coil. With the increase of the height of the discharge chamber, the average argon ion density increases first and then decreases, and reaches the maximum value when the discharge chamber height is 38 mm. Although the use of a stepped dielectric window can improve the argon ion density, it also increases the risk of it being sputtered. The simulation results were applied to the development of the ion source experimental device, and a stable extraction of a 0.24 mA argon ion beam was obtained.
-
Key words:
- Ion source /
- Numerical simulation /
- Inductively coupled plasma /
- Plasma generator .
-

-
表 1 氩等离子体化学反应
Table 1. Argon plasma chemical reaction
反应 反应方程 反应类型 能量变化/eV 1 e+Ar=>e+Ar 弹性碰撞 0 2 e+Ar=>e+Ar* 激发 11.5 3 e+Ar*=>e+Ar 超弹性碰撞 −11.5 4 e+Ar=>2e+Ar+ 电离 15.8 5 e+Ar*=>2e+Ar+ 电离 4.24 6 Ar*+Ar*=>e+Ar+Ar+ 潘宁电离 7 Ar*+Ar=>Ar+Ar 淬灭 -
[1] Kaufman H R. Technology of electron-bombardment ion thrusters[J]. Advances in Imaging and Electron Physics,1975,36:265−373 [2] Ochs D, Schroeder J, Cord B, et al. Glass substrate cleaning using a low energy ion source[J]. Surface and Coatings Technology,2001,142:767−770 [3] Cook J M, Ibbotson D, Flamm D. Application of a low-pressure radio frequency discharge source to polysilicon[J]. Journal of Vacuum Science & Technology B,1990,8:1−4 [4] James R F, Pilloux Y, Hegde H. Reactive ion beam etching of piezoelectric ScAlN for bulk acoustic wave device applications[J]. Journal of Physics: Conference Series,2019,1407(1):012083 doi: 10.1088/1742-6596/1407/1/012083 [5] Sovey J S. Ion beam sputtering of fluoropolymers[J]. Journal of Vacuum Science & Technology,1979,16:813−816 [6] Carter J, Holland J P, Peltzer E A, et al. Transformer coupled plasma etch technology for the fabrication of subhalf micron structures[J]. Journal of Vacuum Science & Technology,1993,11:1301−1306 [7] Patrick R, Schoenborn P, Toda H, et al. Application of a high density inductively coupled plasma reactor to polysilicon etching[J]. Journal of Vacuum Science & Technology,1993,11:1296−1300 [8] Efremov A, Min N K, Jeong J, et al. Etching characteristics of Pb(Zr, Ti)O3, Pt, SiO2 and Si3N4 in an inductively coupled HBr/Ar plasma[J]. Plasma Sources Science and Technology,2010,19:045020 doi: 10.1088/0963-0252/19/4/045020 [9] Im Y H, Kang H, Han B S, et al. High density plasma etching of Y-Ba-Cu-O superconductors[J]. ECS Solid State Letters,2001,4:C77−C79 doi: 10.1149/1.1398557 [10] Kim J W, Cheong H, Hong Y T, et al. The characteristics of high etch rate ion beam etcher with magnetized inductively coupled plasma source[J]. Plasma Sources Science and Technology,2017,26:035008 doi: 10.1088/1361-6595/aa595e [11] 尤大伟, 黄小刚, 任荆学. 用于薄膜制备的射频宽束离子源的设计[J]. 真空科学与技术学报,2004,24(6):451−454 (in Chinese) doi: 10.3969/j.issn.1672-7126.2004.06.015 You D W, Huang X G, Ren J X. Development of broad beam RF ion source for thin film growth[J]. Chinese Journal of Vacuum Science and Technology,2004,24(6):451−454 doi: 10.3969/j.issn.1672-7126.2004.06.015 [12] Zhao S X, Feng Z. Gas flow characteristics of argon inductively coupled plasma and advections of plasma species under incompressible and compressible flows[J]. Chinese Physics B,2018,27(12):124701 doi: 10.1088/1674-1056/27/12/124701 [13] Sun X Y, Zhang Y, Jing Y, et al. Modulation of the plasma uniformity by coil and dielectric window structures in an inductively coupled plasma[J]. Plasma Science and Technology,2021,23(9):111−222 [14] Song Z J, Xu H J, et al. Characteristics study and parameters diagnosis by spectral analysis of low pressure argon inductively coupled plasma[J]. Spectroscopy and Spectral Analysis,2019,39(4):1242−1246 -


 首页
首页 登录
登录 注册
注册



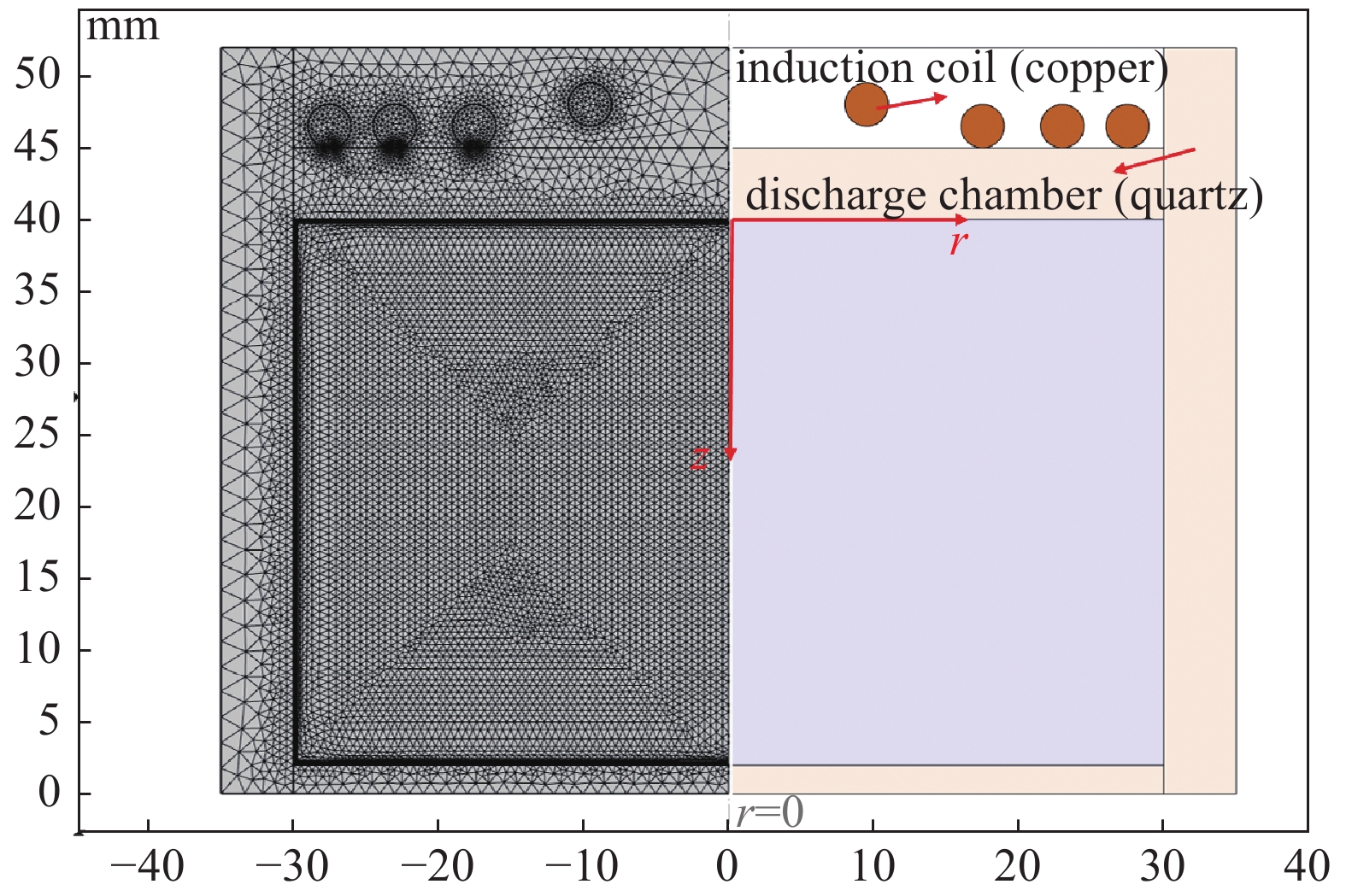
 下载:
下载: