-
III族氮化物, 包括AlN, GaN, InN以及它们的合金材料, 作为宽禁带半导体材料的重要代表, 是当今光电子领域、电力电子领域以及射频电子领域备受关注的重要材料[1–4]. 其中, AlN材料具有禁带宽度大(6.2 eV)、电子迁移率高(1100 cm2/(V·s))、击穿电压高(15.4 MV/cm)、压电系数高、热导率大(320 W/(m·K))、硬度大、化学稳定性和热稳定性好、体声波传播速度快(11270 m/s)等优点[5–9]. 因此, AlN材料在新一代电力电子器件、能量收集器件和声学器件的制备中得到广泛应用[10–12]. 同时, 这种材料非常适用于制造紫外发光二极管、光电探测器和激光二极管的基板[13–15]. 为了获得高性能的AlN基器件, 首先要生长出高质量的AlN材料. 目前AlN材料的主要获得方式为异质外延. 异质外延方法获得AlN具有成本低廉、工艺简单的优势. 由于蓝宝石材料具有工艺成熟、尺寸大、成本低廉等优势, 所以通常选取蓝宝石作为异质外延AlN的衬底. 但是氮化物材料与蓝宝石之间存在较大的晶格失配与热失配问题, 这会产生高密度的穿透位错, 这些位错一般会作为非辐射复合中心、带电散射中心、漏电流路径等等[16–19], 从而降低器件的性能. 为了提高异质外延获得的AlN材料的质量, 先后出现了基于金属有机化学气相淀积(metal-organic chemical vapor deposition, MOCVD)的两步生长法(two step growth, TSG)和多步生长法(multiple step growth, MSG)、基于图形衬底的横向外延过生长技术(epitaxial lateral overgrowth, ELOG)、基于磁控溅射的高温退火技术(high temperature annealing, HTA)、基于二维材料(石墨烯或h-BN)的准范德瓦耳斯外延技术(quasi-van der waals epitaxy, QvdWE)等多种方法[20]. TSG方法主要包括低温成核和高温生长两个步骤, 虽然工艺简单, 但是结晶质量不够好, 位错密度较高. 在此基础上衍生出的MSG技术虽然有所改进, 但是工艺复杂度高, 并且对位错密度的降低有限. 要通过ELOG技术获得高质量的AlN材料, 需要制备特殊的纳米图案化衬底. 采用基于磁控溅射的HTA技术想要获得位错密度较低的AlN材料, 则需要较厚的缓冲层, 而QvdWE方法需要借助二维材料作为媒介, 并且工艺步骤繁琐. 最近, 诱导成核技术在蓝宝石衬底获得了高质量的GaN以及AlGaN材料, 其通过对蓝宝石衬底进行铝离子注入, 在衬底表面形成了大量的悬挂键, 这些悬挂键作为成核位点, 促进了初始成核层快速有序的生长形成规律排列的成核岛, 进而有效地缓解了在后续的合并过程中产生的倾转和扭转, 降低了异质外延氮化物材料的位错密度[21,22], 但是该方法还未曾用来制备AlN材料.
为克服上述问题, 本文提出了一种工艺简单、成本低廉的获得高质量AlN基板的技术, 即通过N离子注入纳米图案化的蓝宝石衬底进行预处理, 随后基于此衬底用MOCVD外延生长AlN基板. 与无注入的样品相比, 对纳米图案化的蓝宝石衬底注入1×1013 cm–2剂量的N离子, 其位错密度降低了14%. 并以此制备了发光波长约为395 nm的UV-LED (ultraviolet light emitting diode, UV-LED)器件, 与无注入样品制备的UV-LED相比, 光致发光强度提高了52%, 并在100 mA注入电流下, 光输出功率(light output power, LOP)从71.1 mW增大至116.5 mW, 电光转换效率(wall-plug efficiency, WPE)从18.3%提升到29.6%, 光输出功率和电光转换效率分别提高了63.8%和61.7%.
-
所使用的衬底为纳米图案化的蓝宝石衬底, 厚度约为400 μm. 使用Sumitomo NV-GSD/HE型号离子注入设备以偏离表面法线7°的入射角在蓝宝石衬底上进行N离子注入, N离子剂量分别为1×1012, 1×1013和1×1014 cm–2, 离子注入的能量均为30 keV. 在完成离子注入预处理工艺后, 使用AIXTRON 2800 G4型MOCVD设备, 以三甲基铝(trimethyl aluminum, TMAl)作为反应Al源, NH3作为反应N源, H2作为载气. 采用相同的工艺方法对样品S1 (无注入)、样品S2 (注入N离子剂量为1×1012 cm–2)、样品S3 (注入N离子剂量为1×1013 cm–2)、样品S4 (注入N离子剂量为1×1014 cm–2)进行AlN(低温氮化铝成核层(LT-AlN)/高温氮化铝生长层(HT-AlN)—40 nm/ 700 nm)的外延生长, 具体外延工艺条件为: LT-AlN成核层, 设置生长温度780 ℃, 生长时间 5 min, 生长厚度40 nm; HT-AlN生长层, 设置生长温度1150 ℃, 生长时间50 min, 生长厚度700 nm.
对样品S1—S4的AlN基板外延后, 以TMAl作为反应Al源, 三甲基镓(trimethyl gallium, TMGa)和二甲基镓(dimethyl gallium, DMGa)作为反应Ga源, 三甲基铟(trimethyl indium, TMIn)作为反应In源, NH3作为反应N源, 使用H2和N2作为载气, SiH4和CP2Mg分别作为掺杂Si源与Mg源. 采用相同工艺方法对样品S1—S4进行UV-LED多量子阱结构的外延生长. 如图1所示, UV-LED结构自下向上依次为: 400 μm厚的纳米图案化的蓝宝石衬底、740 nm厚的AlN buffer层、2 μm厚的非故意掺杂U-GaN层、1.7 μm厚的N-GaN层、60 nm厚的阱前超晶格层、9个周期的In0.1Ga0.9N/Al0.17Ga0.84N(3 nm/13 nm)的多量子阱有源区, 有源区之上为40 nm厚的P-Al0.76Ga0.24N电子阻挡层、随后为100 nm厚的P-GaN层、最 后为5 nm厚的P型重掺杂P+-GaN层作为接 触层.
AlN基板生长完成之后, 使用Bruker ICON原子力显微镜(atomic force microscope, AFM)和Sigma-300型扫描电子显微镜(scanning electron microscopy, SEM)对AlN基板的表面形貌进行表征, 采用Bruke D8 Discover型高分辨率X射线衍射仪(high resolution X-ray diffraction, HRXRD)研究了AlN基板的晶体质量. LED多量子阱结构生长之后, 使用Horiba Jobin Yvon LavRam HR800型光谱仪进行PL和Raman测试, 对LED多量子阱结构的光学特性和应力状况进行了分析. 样品制备成UV-LED器件之后, 采用维明LED-617型测试仪研究了LED器件的光电特性.
-
为了观察AlN基板的表面形貌, 使用AFM的 轻敲模式对四个样品进行测试, 样品S1—S4的 5 μm×5 μm尺寸的3 D形貌如图2所示. 样品 S1—S4的表面均方根粗糙度(root mean square roughness, RMS)分别为2.65, 4.00, 2.08, 3.16 nm. 同时, 使用SEM观察样品表面形貌, 样品S1—S4的SEM的扫描结果如图3所示. 样品S3的扫描结果中显示出的孔的形状最小. SEM的扫描结果表明四个样品的二维生长速率不同[23], 这是由于适当剂量的N离子注入促进了AlN在外延生长过程中的横向生长与合并过程.
在纤锌矿结构中, 晶体的位错情况可以根据样品在HRXRD测试下的X射线摇摆曲线(rocking curve, RC)的半峰全宽(full width at half maximum, FWHM)反映, 具体表达式为[24]
式中Dscrew表示螺位错密度, Dedge表示刃位错密度, b(002)和b(102)分别是(002)晶面和(102)晶面的伯格斯矢量(Burgers vector), AlN晶体此处取值分别为4.982×10–8 cm和3.112×10–8 cm.
为了探究外延所得AlN基板的生长质量与衬底的离子注入剂量的关系, 使用HRXRD对外延所得的AlN 基板进行表征, 获得的摇摆曲线测试结果如图4所示: (002)面RC曲线FWHM值依次是827 arcsec, 1033 arcsec, 350 arcsec, 1913 arcsec; (102)面RC曲线的FWHM值依次是1470 arcsec, 1619 arcsec, 1427 arcsec, 2589 arcsec. 根据摇摆 曲线的FWHM值, 可以估算出样品S1—S4的 螺位错密度依次为1.48×109, 2.32×109, 2.66×108, 7.95×109 cm–2; 刃位错密度依次为1.20×1010, 1.46×1010, 1.13×1010和3.73×1010 cm–2. 其中, 注入样品S3与无注入样品S1相比, 螺位错密度降低了82%, 刃位错密度降低了6%, 总位错密度降低了14%. 可见对纳米图案化的蓝宝石衬底注入1×1013 cm–2的N离子, 有助于降低外延的AlN基板的位错密度, 尤其对降低螺位错密度效果显著, 这可能是因为N离子的注入, 抑制了初期成核过程中形成的扭曲的镶嵌结构, 有效地降低了AlN基板的螺位错以及刃位错密度.
为了研究外延的多量子阱结构的应力状态, 用波长为633 nm的激光对样品S1—S4进行Raman测试. 无应变状态下GaN的E2(high)峰的频率为567.6 cm–1, 当GaN受到压应力时该散射峰右移. 如图5所示, 样品S1—S4的GaN的E2 (high)峰的频率和半峰全宽分别为570.5 cm–1和5.95 cm–1, 571.4 cm–1和6.01 cm–1, 568.9 cm–1和5.64 cm–1, 569.2 cm–1和7.53 cm–1. 四个样品的E2 (high)峰的频率都大于567.6 cm–1, 说明四个样品均处于压应力状态. 对比样品S1—S4发现样品S3的E2(high)峰的半峰全宽最小, 峰位最接近567.6 cm–1, 这说明样品S3的结晶质量最好, 残余压应力最小. 此外沿着GaN的[0001]晶向入射Raman光, 测试光谱中除了有明显的E2(high)峰, 还在735 cm–1附近存在A1(LO)散射峰. 对比四个样品, 样品S3的Raman谱图的A1(LO)散射峰的右侧杂峰最小, 频率为737. 9 cm–1, FWHM为8.2 cm–1, 这也表明了样品S3具有相对最好的结晶质量[25,26].
为了表征四个样品外延所得的LED多量子阱结构的光学性质, 室温下(300 K)对四个样品S1—S4进行PL测试, 使用的激发激光的波长为325 nm. 测试结果如图6所示, 四个样品的峰值波长均在395 nm左右, 并且样品S1—S4的发光波长和半峰全宽分别为391.9 nm和13.2 nm, 395.5 nm和12.2 nm, 393.4 nm和11.7 nm, 391.8 nm和12.1 nm. PL的测试结果表明, 样品S3的FWHM最小, 且发光强度最大, 为S1的152%, 这表明其具有最好的光学特性和生长质量.
-
基于以上四个LED结构, 将无注入样品S1与注入样品S3制备成LED器件, 并分别将其作为对照组(Control LED)和实验组(Treatment LED), 以进一步验证AlN晶体质量的提高对器件性能的实际影响. 如图7所示, 分别表征了LED器件的I-V特性曲线、光输出功率与电光转换效率随注入电流的变化曲线. 如图7(a)所示, I-V特性曲线无明显差别, 说明晶体质量的提高对LED 的开启电压影响较小. 如图7(b)所示, 在100 mA的注入电流下, Treatment LED相比Control LED, 光输出功率从71.1 mW提高到116.5 mW, 光输出功率提升了63.8%. 如图7(c)所示, 100 mA的注入电流下器件的电光转换效率从18.3%增加到29.6%, 提高了61.7%. 由此不难看出, 离子注入预处理衬底技术是一种获得高质量AlN材料有效的方法, 且基于该AlN基板可以有效地提升紫外LED器件的性能.
-
文献[21]和[22]中将诱导成核技术用于GaN和AlGaN外延时所用的衬底是常规的平面蓝宝石衬底, 通过在其上离子注入不同剂量的Al离子实现诱导成核作用, 因为图形衬底是制备LED 的主要衬底, 本文采用了纳米图案化的蓝宝石衬底, 同时注入离子为N离子. 综合本文与文献中的工作, 可见离子注入预处理衬底可以获得高质量的异质外延氮化物材料, 该方法的作用机理在于, 注入离子促进了异质外延过程中初始成核层的高质量生长, 形成密度可控(离子注入剂量控制)的规则有序的成核岛, 从而促进了AlN材料在横向生长与合并过程中湮灭更多的位错, 有效地降低了氮化物材料的螺位错和刃位错密度, 提高了材料质量.
-
本文对纳米图案化的蓝宝石衬底注入不同剂量的N离子(1×1012, 1×1013, 1×1014 cm–2), 同时设置无注入对照样品. 随后用MOCVD在四个衬底上外延AlN基板, 随后生长多量子阱结构, 最终制备出波长约为395 nm的UV-LED. 对AlN基板进行了HRXRD与AFM测试, 结果表明当注入N离子剂量为1×1013 cm–2时, 外延所得的AlN基板展现出最低的表面粗糙度, RMS仅为2.08 nm, 并且位错密度最低, 比无注入样品降低了14%. 此外, 对多量子阱结构进行了Raman和PL测试, 结果表明当注入N离子剂量为1×1013 cm–2时, 样品具有最小的残余压应力和最大的光致发光强度且比无注入样品高出52%. 基于上述结果, 选取了N离子注入剂量为1×1013 cm–2的样品作为实验组, 以及无注入的样品作为对照组, 分别制备了UV-LED器件. 光电性能测试结果表明, 在100 mA的注入电流下, 实验组LED的LOP从71.1 mW提高到了116.5 mW, 并且WPE从18.3%提高到了29.6%. 综上所述, 本文开发了一种N离子注入诱导成核的方法, 提高了异质外延AlN材料的质量, 并基于此技术制备出了高性能LED器件. 实验结果证实, 提高AlN晶体质量可以有效地增强器件性能, 表明离子注入诱导成核技术在制造高性能AlN基器件方面具有巨大的潜力.
离子注入诱导成核外延高质量AlN
Ion implantation induced nucleation and epitaxial growth of high-quality AlN
-
摘要:
超宽禁带AlN材料具有禁带宽度大、击穿电场高、热导率高、直接带隙等优势, 被广泛应用于光电子器件和电力电子器件等领域. AlN材料的质量影响着AlN基器件的性能, 为此研究人员提出了多种方法来提高异质外延AlN晶体的质量, 但是这些方法工艺复杂且成本高昂. 因此, 本文提出了诱导成核的新方法来获得高质量的AlN材料. 首先, 对纳米图案化的蓝宝石衬底注入不同剂量的N离子进行预处理, 随后基于该衬底用金属有机化学气相沉积法外延AlN基板, 并在其上生长多量子阱结构, 最后基于此多量子阱结构制备紫外发光二极管. 研究结果表明, 在注入N离子剂量为1×1013 cm–2的衬底上外延获得的AlN基板, 其表面粗糙度最小且位错密度最低. 由此可见, 适当剂量的N离子注入促进了AlN异质外延过程中的横向生长与合并过程; 这可能是因为N离子的注入, 抑制了初期成核过程中形成的扭曲的镶嵌结构, 有效地降低了AlN的螺位错以及刃位错密度. 此外, 基于该基板制备的多量子阱结构, 其残余应力最小, 光致发光强度提高到无注入样品的152% . 此外, 紫外发光二极管的光电性能大幅提高, 当注入电流为100 mA时, 光输出功率和电光转换效率分别提高了63.8%和61.7%.
-
关键词:
- 氮化铝 /
- 离子注入 /
- 金属有机化学气相淀积 /
- 发光二极管
Abstract:AlN materials have a wide range of applications in the fields of optoelectronic, power electronic, and radio frequency. However, the significant lattice mismatch and thermal mismatch between heteroepitaxial AlN and its substrate lead to a high threading dislocation (TD) density, thereby degrading the performance of device. In this work, we introduce a novel, cost-effective, and stable approach to epitaxially growing AlN. We inject different doses of nitrogen ions into nano patterned sapphire substrates, and then deposit the AlN layers by using metal-organic chemical vapor deposition. Ultraviolet light-emitting diode (UV-LED) with a luminescence wavelength of 395 nm is fabricated on it, and the optoelectronic properties are evaluated. Compared with the sample prepared by the traditional method, the sample injected with N ions at a dose of 1×1013 cm–2 exhibits an 82% reduction in screw TD density, the lowest surface roughness, and a 52% increase in photoluminescence intensity. It can be seen that appropriate dose of N ion implantation can promote the lateral growth and merging process in AlN heteroepitaxy. This is due to the fact that the process of implantation of N ions can suppress the tilt and twist of the nucleation islands, effectively reducing the density of TDs in AlN. Furthermore, in comparison with the controlled LED, the LED prepared on the high quality AlN template increases 63.8% and 61.7% in light output power and wall plug efficiency, respectively. The observed enhancement in device performance is attributed to the TD density of the epitaxial layer decreasing, which effectively reduces the nonradiative recombination centers. In summary, this study indicates that the ion implantation can significantly improve the quality of epitaxial AlN, thereby facilitating the development of high-performance AlN-based UV-LEDs.
-
Key words:
- AlN /
- ion implantation /
- metal-organic chemical vapor deposition /
- light emitting diode .
-

-
-
[1] 徐爽, 许晟瑞, 王心颢, 卢灏, 刘旭, 贠博祥, 张雅超, 张涛, 张进成, 郝跃 2023 物理学报 72 196101 doi: 10.7498/aps.72.20230793 Xu S, Xu S R, Wang X H, Lu H, Liu X, Yun B X, Zhang Y C, Zhang T, Zhang J C, Hao Y 2023 Acta Phys. Sin. 72 196101 doi: 10.7498/aps.72.20230793 [2] 武鹏, 张涛, 张进成, 郝跃 2022 物理学报 71 158503 doi: 10.7498/aps.71.20220161 Wu P, Zhang T, Zhang J C, Hao Y 2022 Acta Phys. Sin. 71 158503 doi: 10.7498/aps.71.20220161 [3] 郭海君, 段宝兴, 袁嵩, 谢慎隆, 杨银堂 2017 物理学报 66 167301 doi: 10.7498/aps.66.167301 Guo H J, Duan B X, Yuan S, Xie S L, Yang Y T 2017 Acta Phys. Sin. 66 167301 doi: 10.7498/aps.66.167301 [4] Niass M I, Wang F, Liu Y H 2022 Chin. J. Electron. 31 683 doi: 10.1049/cje.2020.00.178 [5] Taniyasu Y, Kasu M, Makimoto T 2006 Nature 441 325 doi: 10.1038/nature04760 [6] Yu R X, Liu G X, Wang G D, Chen C M, Xu M S, Zhou H, Wang T L, Yu J X, Zhao G, Zhang L 2021 J. Mater. Chem. C 9 1852 doi: 10.1039/D0TC04182C [7] Fu H Q, Baranowski I, Huang X Q, Chen H, Lu Z J, Montes J, Zhang X D, Zhao Y J 2017 IEEE Electron Device Lett. 38 1286 doi: 10.1109/LED.2017.2723603 [8] Cheng Z, Koh Y R, Mamun A, Shi J, Bai T, Huynh K, Yates L, Liu Z, Li R, Lee E 2020 Phys. Rev. Mater. 4 044602 doi: 10.1103/PhysRevMaterials.4.044602 [9] Amano H, Collazo R, Santi D C, Einfeldt S, Funato M, Glaab J, Hagedorn S, Hirano A, Hirayama H, Ishii R 2020 J. Phys. D: Appl. Phys. 53 503001 doi: 10.1088/1361-6463/aba64c [10] Fei C L, Liu X L, Zhu B P, Li D, Yang X F, Yang Y T, Zhou Q F 2018 Nano Energy 51 146 doi: 10.1016/j.nanoen.2018.06.062 [11] Ni X F, Fan Q, Hua B, Sun P H, Cai Z Z, Wang H C, Huang C N, Gu X 2020 IEEE Trans. Electron Devices 67 3988 doi: 10.1109/TED.2020.2991397 [12] Chu Y W, Kharel P, Yoon T, Yoon T, Frunzio L, Rakich P T, Schoelkopf R J 2018 Nature 563 666 doi: 10.1038/s41586-018-0717-7 [13] Kneissl M, Seong T Y, Han J, Amano H 2019 Nat. Photonics 13 233 doi: 10.1038/s41566-019-0359-9 [14] Wu H L, Wu W C, Zhang H X, Chen Y D, Wu Z S, Wang G, Jiang H 2016 Appl. Phys. Express 9 052103 doi: 10.7567/APEX.9.052103 [15] Mackey T K, Contreras J T, Liang B A 2014 Sci. Total Environ. 472 125 doi: 10.1016/j.scitotenv.2013.10.115 [16] Look D C, Hemsky J W, Sizelove J R 1999 Phys. Rev. Lett. 82 2552 doi: 10.1103/PhysRevLett.82.2552 [17] Peng R S, Xu S R, Fan X M, Tao H C, Su H K, Gao Y, Zhang J C, Hao Y 2023 J. Semicond. 44 042801 doi: 10.1088/1674-4926/44/4/042801 [18] Jena D, Gossard A C, Mishra U K 2000 Appl. Phys. Lett. 76 1707 doi: 10.1063/1.126143 [19] Brazel E G, Chin M A, Narayanamurti V 1999 Appl. Phys. Lett. 74 2367 doi: 10.1063/1.123853 [20] Wu H L, Zhang K, He C G, He L F, Wang Q, Zhao W, Chen Z T 2022 Crystals 12 38 doi: 10.3390/cryst12010038 [21] Tao H C, Xu S R, Zhang J C, Su H K, Gao Y, Zhang Y C, Zhou H, Hao Y 2023 Opt. Express 31 20850 doi: 10.1364/OE.492088 [22] Tao H C, Xu S R, Su H K, et al. 2023 Mater. Lett. 351 135097 doi: 10.1016/j.matlet.2023.135097 [23] Wang J M, Xie N, Xu F J, et al. 2023 Nat. Mater. 22 853 doi: 10.1038/s41563-023-01573-6 [24] Ban K, Yamamoto J, Takeda K, Ide K, Iwaya M, Takeuchi T, Kamiyama S, Akasaki I, Amano H 2011 Appl. Phys. Express 4 052101 doi: 10.1143/APEX.4.052101 [25] Hushur A, Manghnani M H, Narayan J 2009 J. Appl. Phys. 106 54317 doi: 10.1063/1.3213370 [26] Kozawa T, Kachi T, Kano H, Nagase H, Koide N, Manabe K 1995 J. Appl. Phys. 77 4389 doi: 10.1063/1.359465 -


 首页
首页 登录
登录 注册
注册



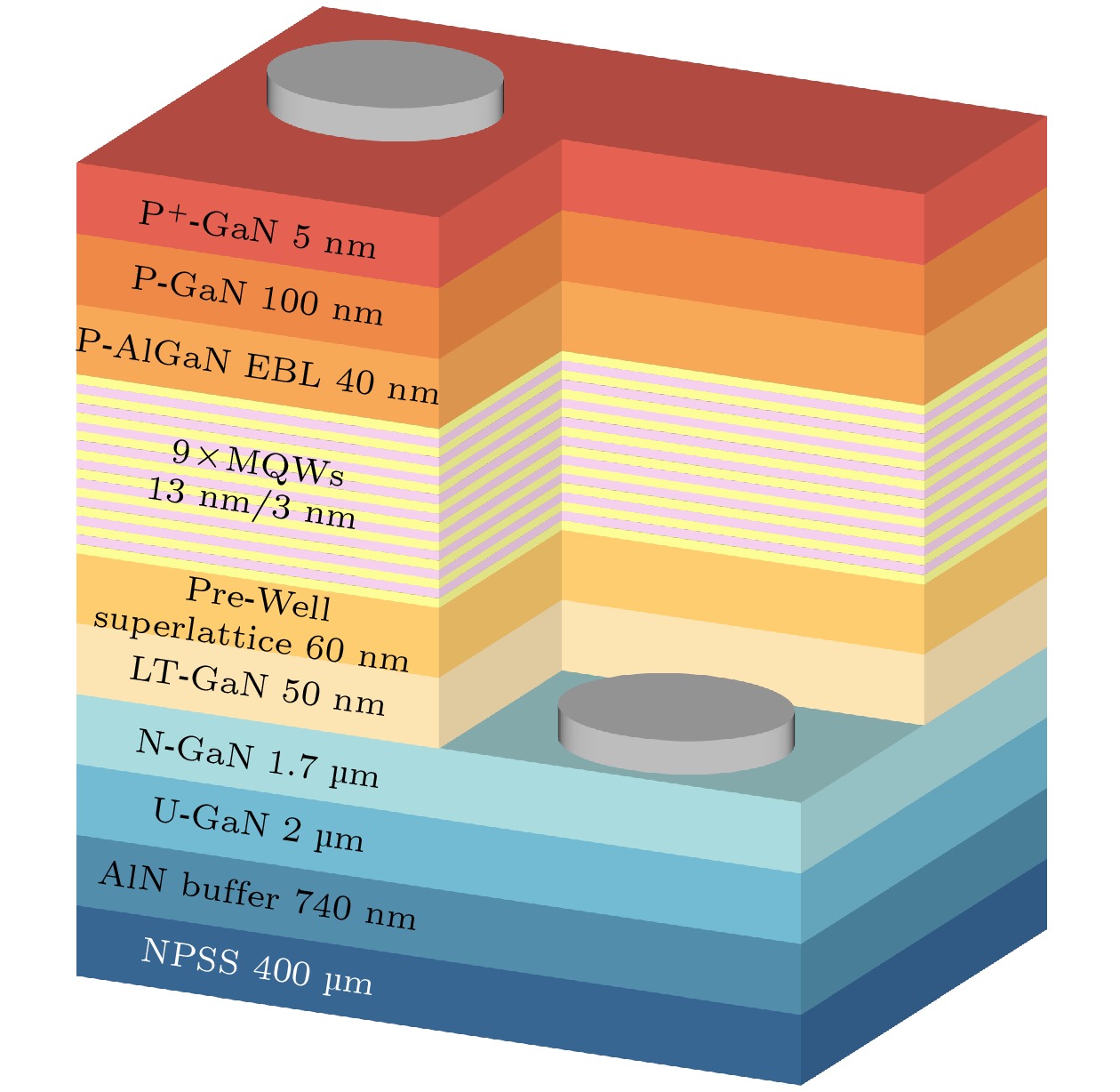
 下载:
下载: