-
半导体碳化硅(SiC)是一种具有重要研究价值和极高应用潜力的材料。它的立方和六方相具有带隙宽,热稳定性高的特点,使得SiC特别适合用于高温、高频、大功率、高压和高速的电子器件和传感器[1]。另外,SiC还具有化学惰性和极高的硬度,使它成为一种极其适合在恶劣环境下工作的特殊材料[2]。除此之外,SiC还是很好的生物相溶性材料之一,在生物物理学上具有很好的应用前景[3]。实际上微电子器件的关键问题之一是需要得到具备低缺陷密度的高质量SiC表面,因此深入研究碳化硅表面质量以及表面重构对制备高性能的电子器件具有重要意义。无论是立方碳化硅还是六方碳化硅都具有多种重构相,并且重构相随温度变化会有所不同[4-6]。而六方的6H-SiC(2.9 eV)和4H-SiC(3.3 eV)相对于立方碳化硅(2.4 eV)具有更宽的带隙,更适合应用于高温和高功率器件领域[7-9]。
因此,研究6H和4H-SiC的表面重构十分有必要。到目前为止,研究碳化硅表面重构有多种手段,比如利用低能电子衍射low energy electron diffraction (LEED)获得碳化硅表面原子堆积情况[10]、利用理论计算方法预测碳化硅重构表面原子排布[11]、利用反射高能电子衍射reflection high-energy electron diffraction (RHEED)分析碳化硅表面形貌随温度的变化等[12]。随着扫描隧道显微镜scanning tunneling microscopy (STM)的问世, 更多研究者开始关注碳化硅表面形貌。利用STM人们能够在实空间观察到碳化硅表面结构,为从原子尺度上研究碳化硅表面重构提供了重要手段;同时,利用扫描隧道谱scanning tunneling spectroscopy (STS)研究碳化硅的带隙随温度的变化也成为当下的一个研究热点,这些研究成果对理解碳化硅的表面结构和电子信息具有重要指导意义,为制备出高效的电子器件提供实验指导。
利用STM研究单晶样品表面形貌是物理化学上非常有效的一种表征方法。它具有以下优势:(1)能够在实空间上获得样品表面形貌特征; (2)可以与其它表面表征手段相结合,如X射线光电子能谱X-ray photoelectron spectroscopy (XPS),RHEED,LEED等对表面进行原位表征,可以得到更精准化的表面重构信息; (3)从实验上给理论计算更直观的图像指导。STM能够实空间探测原子在金属或者半导体表面的状态和物理化学性质,对表面科学研究产生了深远的影响,关于STM具体工作原理和理论基础,读者可以参考相关文献[13]。本文将主要介绍利用STM研究六方碳化硅表面重构,主要包括4H和6H-SiC表面重构的研究进展。
-
起初,人们通过额外补充Si束流,用LEED可以观察到SiC(0001) 3×3重构。但是直到1996年,Kulakov等[17]才首次利用超高真空扫描隧道显微镜(UHV-STM)研究6H-SiC(0001)表面原子结构。他们将6H-SiC(0001)在硅气氛下退火后,得到3×3重构,但是表面并不是完美无瑕,存在很多缺陷,如图2(a)。同年,Tsong等[5]系统的研究了6H-SiC(0001)和(000
$ \stackrel{-}{1} $ )表面的原子结构,他们发现在合适的退火条件下不仅6H-SiC(0001)面可以获得3×3重构相,6H-SiC(000$ \stackrel{-}{1} $ ) 面同样可以获得3×3重构相。另外,当改变退火条件,他们还可以获得$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 、6×6、9×9等多种重构相。虽然前面研究者获得3×3重构的STM,但是从文献图片上看质量都不太高,而且也没有关于6H-SiC(0001) 表面3×3重构电子结构相关方面的研究。直到1997年,Tindall等[18]在研究6H-SiC(0001)表面结构和振动的时候才获得质量比较高的STM图像。1997年,Hoster等[19]利用STM结合LEED和俄歇电子能谱(AES)系统地研究和分析了6H-SiC(000$ \stackrel{-}{1} $ )表面 3×3重构的形貌和原子结构。他们制备3×3重构与以往的方法略有不同,他们首先在低温下沉积Si,然后样品在1200−1300℃退火,但是每隔5−10 s中断一次退火直至3×3重构出现。并且重构的质量可以通过继续多次短时间退火来提高,相应的STM图像如图2(b)所示。并且他们发现6H-SiC(000$ \stackrel{-}{1} $ )表面 3×3重构的形貌与扫描偏压的正负有很大关系。虽然到目前为止关于6H-SiC表面3×3重构形貌特征和原子结构的研究已经很多,但是有关其电子结构的研究还不清楚。直到2000年,Gasparov等[20]利用STM/STS对n型6H-SiC(0001)表面3×3重构进行形貌以及电子结构表征。与其他的一些表征手段相比,STS的优点是一个隧穿谱能够同时提供EF上方和下方的能带结构信息。图3(a)为3×3重构扫描参数为(−2.2 V, 0.03 nA)的STM图像,图中缺陷位置以及规则3×3重构表面的I-V曲线如图3(b)所示。从图中可以发现缺陷位置在负的样品偏压下具有比较大的隧穿电流,然而规则的表面位置处显示相差约一个数量级的电导填充态和一个相同的空态。值得注意的是,n型I-V曲线对于缺陷态不对称,而对于规则的表面态则是对称[21]。并且他们在归一化的电导曲线中他们还发现局域态密度(LDOS)在缺陷附近有微小的变化。理论模型假定在Si层上有Si的多聚体存在[17, 22]。因此,对于缺陷和规则的表面,隧穿电流的不同来自于Si层,这也可能是规则表面和缺陷表面之间LDOS存在微小变化的原因。2012年,Hiebel等[23]也用STM/STS研究了6H-SiC(000
$ \stackrel{-}{1} $ )表面的3×3重构,他们发现3×3重构的占据态和未占据态的STM表现明显不同,并且用STS揭示在3×3重构表面费米能级以下存在一个宽的表面带隙。 -
6H-SiC(0001)表面几个确定的重构相中,
$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )重构被广泛研究。1995年,Owman和Mårtensson在950℃高温加热后,利用STM获得$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )重构相,并且他们还提出了一种原子模型,他们认为Si或C原子吸附在T4或者H3的位置上(图4(a))[24]。但是在这篇文章中STM图不是特别清晰,第二年他们又发表了相关文章,改变退火温度后(1100℃)获得了清晰的$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构STM图像,如图4(b)所示[25]。从STM图像中可以看出,表面上大部分是$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构相,但是也会出现一些其他的表面重构,如5×5,6×6,这几种重构相随着SiC退火温度变化覆盖率会不同,这两种重构相后面再介绍。1997年,Li等[18]利用STM以及高分辨电子能量损失谱研究了6H-SiC(0001)表面$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 以及3×3两种重构。图4(c)是正偏压下$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构STM图像,除了重构以外,表面还存在一些星型的缺陷,大约是表面面积的5−10%。图4(d)是同一位置负偏压下所示的STM 图像,可以发现在正负偏压下STM图像明显不同。以前对该表面的STM研究显示,表面图像对偏置电压或极性的大小没有明显的依赖关系。但是一些缺陷对偏压有依赖关系[24]。但是在T4吸附原子模型下,在正偏压下星型缺陷不会形成,而且光电效应的结果与T4模型也不符合[26]。根据光电效应的结果,Li等提出表面空位模型[27],图4(c)和图4(d)以及高分辨电子能量损失谱能够与这个模型保持一致,而不是原先的T4模型。 -
前面提到,在950℃加热,6H-SiC(0001)面表现出
$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o重构相,再进一步加热到1100℃ 用LEED发现会有新的重构相出现,这是一种$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ 重构。后来Chang等[28]以及Tsai等[29]在用STM研究3C-SiC(111)表面时直接在$ 6\sqrt{\text{3}}\text{×6} \sqrt{\text{3}} $ 重构表面观察到单晶石墨的出现。Life和Tsong对Si在$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ 表面蒸发的STM研究,证明了$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ 表面石墨模型[5]。1996年,Owman等利用STM和LEED研究了$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ,他们发现当LEED图像中显示规则的$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ 周期时,而在STM图像中除了会出现$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构外,也会出现周期大约是分别是5×5,6×6的周期性结构,如图5(a)所示[30]。5×5周期性结构在图的左侧标记为A,其结构单元具有不同的形状、大小和方向。每个A型结构单元是由几个突起组成,它们在单元内以密排的方式出现。相邻的A结构之间平均距离大约在16 Å左右,这个长度大约是SiC晶格常数的5倍,因此称其为5×5重构。在图的右侧有一种比5×5重构更复杂的结构,而这种结构还包含两种不同的结构单元一种是星形,标记为B,另一种为三角形,标记为C。这种重构的晶胞大小为19 Å左右,大约是SiC晶格的6倍,因此这种结构被称为6×6重构。在SiC加热过程中6×6和5×5重构开始出现的数量差不多,但是随着加热温度的升高,6×6重构将会占主导地位。Tok 等在6H-SiC(0001)表面也同样获得6×6重构[31]。Li等通过在1150℃闪退火6H-SiC(0001)同样获得6×6重构,他们在正负偏压下发现这种重构表现为不同的形貌,分别为蜂窝状结构和六角密排结构,如图5(b)和5(c)[5]。他们认为这种差异与下面有Si原子的C原子和没有Si原子的C原子的石墨态的电子贡献差异有关[29]。这种蜂窝状的结构Chen 等在文献里也曾报道过,他们称之为碳纳米网[32]。纳米网由不对称的蜂窝状结构组成,大部分蜂窝的直径为20.0±2.0 Å,非常接近SiC表面6×6周期性结构(大约19 Å)。另外作者在另一篇文章中曾报道碳纳米网孔的大小会随着SiC退火时间变长而变大[33]。如图5(d)和5(e)所示,增加退火时间蜂窝结构的直径会从20 Å增大为25 Å,并且结构变得不规则。因此他们认为这种碳纳米网是在高温下碳原子自发形成的一种超晶格结构,并且通过延长退火时间可以改变蜂窝的大小。SiC热分解是大规模生产石墨烯的方法之一,其结构和形成机理得到了广泛的研究[34-36]。
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o(以下用$ 6\sqrt{\text{3}} $ 来代替)缓冲层通常被认为在热分解过程中参与石墨化的第一阶段。因此,$ 6\sqrt{\text{3}} $ 前驱体决定了石墨烯的质量,从而影响石墨烯基器件的电子迁移率和热导率[37-39]。$ 6\sqrt{\text{3}} $ 缓冲层已经从Morie模式中推断出来,它是由于石墨烯和SiC晶格不匹配造成的。6H-SiC(0001)表面在高温加热过程中从富Si的3$ \text{×} $ 3重构经历一系列表面重构,最终石墨烯的形成只会发生在富碳前驱体$ 6\sqrt{\text{3}} $ 形成时。但是在STM的表征中它主要表现为6×6周期性[31,40-41]。Choi等在1100℃直接退火6H-SiC(0001),他们发现在这个条件下表面上富碳的$ 6\sqrt{\text{3}} $ 重构即图6(a)中6R3占主导地位,其余的结构为单层石墨烯(标记为M),说明在这个温度下不足以形成具有优势的石墨烯[42]。接下来,他们获得$ 6\sqrt{\text{3}} $ 重构与单层石墨烯的共存的高分辨图,如图6(b)所示,在图中还可以清晰的看到6×6结构。并且继续升高退火温度,表面上单层石墨烯的比例增加,$ 6\sqrt{\text{3}} $ 重构减少。Hu等人在用STM研究6H-SiC(0001)表面外延石墨烯扶手椅方向时也同时获得石墨烯与缓冲层共存的图像,他们认为扶手椅方向一直平行于6×6重构的基矢方向和6H-SiC的密排方向[43]。其实实验中石墨烯不易与前驱体结构区分,因为在单层石墨烯的STM图像中有$ 6\sqrt{\text{3}} $ 周期性的中间层[44]。Poon等利用Co在石墨烯和$ 6\sqrt{\text{3}} $ 重构上吸附特性不同解决了这一问题[45]。他们在1150℃退火得到$ 6\sqrt{\text{3}} $ 重构表面,$ 6\sqrt{\text{3}} $ 以及6×6晶胞分别用蓝色和黑色四边形标出,如图6(c)所示。增加退火温度到1300℃,表面上为蜂窝状的晶格和1×1的石墨烯晶胞 (U= −0.1 V)。在不同得偏压下(U= −1.2 V)得到的 STM图像和$ 6\sqrt{\text{3}} $ 相形貌相似,如图6d所示,这就导致在实际中很难区分$ 6\sqrt{\text{3}} $ 重构和石墨烯。为了解决之一问题,他们将Co沉积到石墨化的6H-SiC(0001) 面上,他们发现高密度的Co 团簇会吸附在$ 6\sqrt{\text{3}} $ 重构上,然而低密度的Co团簇会吸附在石墨烯平台上。这一结果为在实验中区分石墨烯和$ 6\sqrt{\text{3}} $ 重构提供了指导。 -
通过前面对6H-SiC表面重构的介绍,会发现SiC表面的重构对样品的制备过程具有强烈的依赖关系。并且在超高真空条件下直接退火有可能使SiC表面碳化或石墨化。4H-SiC相比较与6H-SiC拥有更宽的带隙、较高的载流子迁移率和较好的电子迁移各向同性,因此4H-SiC更适合应用与大功率以及高温系统。按理说前期关于4H-SiC表面重构的研究应该很多,但是事实并非如此。由于刚开始在实际生产SiC中,4H-SiC的生长工艺并不完善,生产出来的4H单晶质量并不完美,而6H-SiC的生长工艺相对完善,所以6H-SiC吸引了更多科研人的注意力。关于6H-SiC表面重构的研究比较多,而4H-SiC则相对较少。下面本文介绍4H-SiC一些比较典型的重构相。
-
1996年,Tsukamoto等利用 UHV-STM研究4H(6H)-SiC(0001)面在1000℃没有补硅的情况下获得3×3重构相[46]。同年该课题组在研究4H(6H)-SiC(0001)面的退火效应时也在相同的温度下用STM观察到3×3重构相[47]。虽然在文章中作者对于3×3重构描述比较细致,但是STM质量较差,从图像中难以分辨重构结构的细节。随后,Kulakov等利用UHV-STM研究了4H(6H)-SiC(0001)的表面形貌的原子结构。与Tsukamoto等处理SiC样品条件不同的是,他们在加热SiC的过程中增加了Si源,由于在高温加热时Si原子迅速从表面蒸发,造成表面缺陷比较多,而SiC在Si的气氛下进行加热,可以及时补充SiC表面硅原子的缺失,所以他们在850-1000℃获得了高质量3×3重构相,如图7(a)所示[48]。2000年,Schardt等结合多种表面分析仪器,如LEED,STM和 AES系统的研究了立方及六方碳化硅表面3×3重构[49]。他们发现3×3重构不仅存在于4H-SiC(0001)表面(如图7(b)),也存在于3C-SiC(111)和6H-SiC(0001),也就是说3×3重构与SiC的晶型无关。从STM图像中可以发现每个3×3晶胞中只有一个原子突起。2009年,Starke和Riedl给出了3×3重构的理论模型,如图7(c)和7(d)所示[50]。他们认为在3×3重构相中,SiC衬底被具有sp2型的Si键配位的近平面Si层覆盖,在这个Si层的顶部,三个Si原子以三配位的方式支持一个额外的Si吸附原子形成一个具有(3×3)周期性的Si吸附团簇,这是一种富Si的重构相。
-
在6H和4H-SiC(0001)表面,Si气氛下在800℃左右退火可以产生富Si的3×3重构相,另外两个稳定的重构相
$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o和$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o将会在900−1250℃加热区间产生。2002年,Kubler等利用LEED结合光谱类表面分析仪器证明了这一现象[51]。但是对于利用STM 表征4H-SiC表面这两种重构相的文章较少,大部分STM研究集中在6H-SiC上,下面作者对有关STM研究4H-SiC表面的$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o和$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构进行介绍。1997年,Kulakov等首先在Si的气氛下,通过退火的方法首先获得了3×3重构相[48]。然后在关闭硅源的情况下进一步退火,由于在这个过程中SiC表面的硅原子在不断地从表面脱附,造成硅减少而碳增加。受局部硅/碳浓度比的影响,硅和碳可以在表面上排列成许多不同的组合,因此此时在SiC表面会出现多种不同的重构相。如4×4,
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R15o以及$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o等多种重构相,如图8(a)-8(c)所示。实验中他们还发现在退火温度为850-1100℃时没有额外硅原子补入的情况下,若是退火时间在15−20 min,任何表面结构都会转化成$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o。随后Starke等用LEED进一步证明表面存在3×3重构的4H-SiC(0001)样品,在大约950℃下退火(有或者没有硅额外补入)都可以演化成$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o相[50]。在这个过程中,表面经历一个复杂的相变过程,其中包含多个亚稳定相在表面共存,直至$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o相出现。在没有硅补入的情况下,进一步退火到1100℃将会导致$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构出现。这些过程相转变示意图如图8(d)-(g)所示[50],从图中可以看出初始的3×3相可以经过A,B,C三条不同的路径转变成相应的重构相,这个过程与退火温度有关。Starke等在另一篇中报道说明
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构在不同偏压下的STM图像会展现出两个不同周期性结构,分别为(6×6)的蜂窝状周期性结构以及另一个(5×5)周期性结构,如图9(a)所示[52]。(5×5)结构是由不同原子组成的团簇构成,并且(5×5)结构的出现与退火路径不相关。(6×6)重构在正偏压下的STM如图9(b)所示,这是一种比较复杂的重构相,并且缺乏明显的长程有序性。$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构的STM图像非常依赖遂穿电压。(6×6)周期一般出现在高的隧穿电压,而在低偏压时,很难观察到清晰的长程周期性结构。如图9(c)采用1.7 V扫描偏压,呈现出(6×6)周期,但是如果将扫描偏压降低到0.2 V会出现两种大小不同的环,形成了比(6×6)周期更大的晶胞$ ,\mathrm{为}(6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o,如图9(d)所示。随后他们给出了(6×6)和$ (6\sqrt{\text{3}}\text{×6} \sqrt{\text{3}} $ ) R30o晶胞中原子排列情况,如图9(e)所示。 -
碳化硅的表面在碳化硅电子器件的制造中是极其重要的,然而高温对碳化硅的表面影响很大。高温退火又是电激活离子注入掺杂杂质的必要步骤,因为这些杂质是高压肖特基二极管和场效应晶体管边缘端所必须的。然而高温会诱导表面原子的解附和重排,导致碳化硅表面受损或“阶梯形”,表面粗糙度高达退火前的10倍,从而导致SiC器件性能大幅度降低或者损坏。因此研究高温退伙下SiC表面形貌结构也异常重要。
2008年,Guy等首先利用STM揭示氧化的4H-SiC表面的微管缺陷,这些缺陷的直径大概在300 nm左右[53]。为了进一步研究高温对碳化硅表面的影响,他们将碳化硅的退火温度升高到1000℃,这时在表面不同的区域会出现多种重构共存的,许多就有石墨化的表面特征[53],也有与石墨化的表面不同的富碳 SiC(1×1)表面,如图10(a)所示。原子之间的距离是3.11 Å与体相4H-SiC(0001)的晶格常数3.09Å接近,称为(1×1)c。石墨化的重构如图10(b)所示,原子之间的距离约为2.5 Å,这与石墨的原子间(2.46 Å)距非常接近,称为(1×1)graphitic。900−1000℃的温度下,碳化硅的解离增加,产生的额外的碳原子聚集在表面,从而形成石墨化的表面。游离的碳通常处于石墨态,尤其是在1000℃退火以后。Bernhardt 等将SiC加热至1150℃后,也曾用LEED观察到 (1×1)graphitic 石墨重构[54]。Guy等也曾用XPS检测到4H-SiC在1000℃表面石墨化的演化[55]。
Blackwood等在用STM/STS研究退火对4H-SiC(0001)表面Ni吸附的影响时也观察到了(1×1)c以及(1×1)graphitic重构[56]。他们首先将0.5 Å厚的Ni沉积到
$ \mathrm{表}\mathrm{面}\mathrm{重}\mathrm{构}\mathrm{为}\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 的SiC表面,Ni以团簇的方式随意分布在SiC表面。然后将样品加热到1000℃,这同样获得了(1×1)c以及(1×1)graphitic重构。此时镍硅化合物团簇虽然依然可见,但是已经完全扩散到SiC表面以下,如图10(c)所示。除此之外,他们还用STS表征了样品在400,500,900,和1000℃下Ni团簇的I-V曲线以及400℃,600℃,和700℃的归一化电导谱,如图10(d)和10(e)所示。从I-V曲线(图10(d))上可以看出从400℃到500℃表面电导性变差,这一趋势在较高温度下开始逆转,因为在900℃时隧穿电流明显增加。到1000℃时I-V曲线已经是明显的欧姆特性。从图10(e)上可以看出从室温到600℃带隙增大,随后在700℃时减小。这是因为退火后由于镍硅化合物的形成,金属半导体接触的表面发生变化,由Ni/SiC转变为镍硅化合物/SiC或Ni/镍硅化合物/SiC结。这一变化可能引起表面电学性质的改变,从而对碳化硅器件性能造成影响。 -
尽管n型和p型6H-SiC以及n型4H-SiC的表面很容易用STM进行成像,但是由于p型4H-SiC不存在任何表面电导,在进行STM表征时无法形成隧穿电流,所以其无法直接用STM进行成像。
2005年,Laikhtman等研究发现将p型4H-SiC(0001)表面长时间重复暴露在Si气氛下,然后进行退火,在电导率足够高的情况下便可以获得STM图像[57]。图11(a)是他们在经过几个Si沉积/退火的循环过程,获得的STM图像,扫描参数为(−4.0V, 0.5 nA)。STM显示为赝立方表面重构,为3×2重构相,形貌与Si(113)的3×2重构相似[58]。改变扫描参数为(−4 V, 0.3nA), 表面形貌将会变成类似Si(110) 表面16×2重构(图11(b))[59]。接下来他们制备出经过大量Si沉积/SiC退火循环的样品,对应的STM如图11(c)所示。这种结构与Si(111) 的7×7结构非常相似[60],虽然图中晶胞大小略有不同,这种不同可能是压电校准差异或者是Si与SiC晶格不匹配造成的。他们偶尔也会在表面发现4×4重构。表面出现这些几种不同的重构,明显Si的特征已经超过SiC,说明长时间和反复暴露于Si气氛中,至少会形成三种不同重构的Si面结构。尽管SiC表面有几个原子层过剩的Si存在,但是他们依然可以根据STS谱带隙的不同来区分SiC和Si相。
-
综上所述,本文介绍了4H, 6H-SiC在超高真空环境下,通过退火在表面上形成的重构相,我们阐述了4H, 6H-SiC的多种重构相,包括3×3、
$ (\sqrt{\text{3}}\text{×} \sqrt{\text{3}} $ )R30o、$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o、6×6、5×5等。目前利用STM/STS研究六方碳化硅表面重构是一种比较有效的表征手段,极大的推动了人们对碳化硅表面性质的认知。利用STM不仅可以在实空间上对碳化硅表面重构进行表征,而且还可以通过STS谱获得碳化硅表面重构相的电子结构信息。在超高真空环境利用STM研究碳化硅表面重构,能够真实地的观察到碳化硅在加热过程中表面的变化情况,对研究碳化硅器件性能随温度变化的机理提供一些实验上的思路和可行性。此外,将来可以利用STM/STS研究金属或其他材料与不同SiC表面重构相接触时的表面特征以及电学性质。还可以利用STM/STS研究SiC与金属或其他材料的界面信息。但是,利用STM研究半导体SiC时也会有很多局限性。由于STM本身的局限性,需要SiC样品高掺杂然后经过高温除气后才能进行表征。其次,用STM获得的图像一般是表面局域区域的特征,难以直接将SiC表面全部的信息直接呈现出来,需要结合其他表面表征手段才能更准确的呈现表面重构特征。另外,STM是表面表征仪器,而器件方面主要关注的是金属或其他材料与碳化硅的界面信息,用STM很难直接获得界面信息。但是我们相信在未来随着STM技术的不断发展,对碳化硅的表面以及与其他材料的界面性质的研究必将会更深入,会为基础研究以及碳化硅器件的发展带来广阔的前景。
4H(6H)-SiC表面重构的STM/STS研究
STM/STS Study of 4H(6H)-SiC Surface Reconstructions
-
摘要: 半导体碳化硅由于具有宽的带隙,高的导热系数以及大的电子迁移率等优点,使其成为一种在高温、高频、大功率电子器件中具有应用前景的材料。碳化硅器件的性能受表面和界面质量的影响。在高温条件下退火碳化硅表面的重构,形貌也会发生变化,导致与金属或其他材料接触的表面结构不同。因此,碳化硅器件会受到表面重构和形貌的影响。扫描隧道显微镜/扫描隧道谱(STM/STS)是一种可以在实空间获得表面重构的形貌信息以及电子结构非常有用的工具。这篇综述介绍了用STM/STS分析了4H(6H)-SiC的各种表面重构及其电子结构,旨在促进表面科学和碳化硅生长以及器件的发展和进步。
-
关键词:
- 碳化硅 /
- 4H(6H) /
- 表面重构 /
- 扫描隧道显微镜/扫描隧道谱
Abstract: Semiconductor silicon carbide (SiC) is a promising material for high temperature, high frequency, and high power electron devices because of its wide band gap, high thermal conductivity, and high mobility. The performance of SiC devices can be affected by the quality of surfaces and interfaces. After annealing at high temperature, the surface reconstructions and morphologies of SiC can be changed, leading to different surface structures contact with metals or other materials. Therefore, the SiC devices will be affected by surface reconstructions and morphologies. Scanning tunneling microscopy/spectroscopy (STM/STS) is an extremely useful tool for getting the topographic information of reconstructed structures in real space and their electronic structures on surfaces. In this review, we introduce various surface reconstructions of 4H(6H)-SiC as well as their electronic structures which are analyzed by STM/STS, aiming to promote the development and progress of surface science and SiC devices.-
Key words:
- Silicon carbide /
- 4H(6H) /
- surface reconstructions /
- STM/STS .
-

-
图 4
$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 的结构模型以及STM图像。(a)$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构 T4或H3吸附模型[24]; (b)同时具有$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构,5×5和6×6的满态STM图像[25];(c)和(d) 分别在偏压为U=1.2 V和−1.2 V下$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ 重构的STM图像[18]Figure 4. Structure model and STM images of
$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ . (a) Structure model of T4 and H3 sites for$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ reconstruction[24]; (b) A filled state STM image contains$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ , 5×5 and 6×6 reconstructions[25]; (c) and (d) STM images of$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ reconstruction are acquire at the sample bias of 1.2 V and −1.2 V, respectively[18]图 5 6×6和5×5 重构以及碳纳米网对应的STM图像。(a)一个包含6×6和5×5重构的STM图像[30]; (b)和(c)相同位置6×6重构的STM图像。样品偏压分别为−2.0 V和2.0 V[5];(d)和(e)延长退火前后碳纳米网STM图像 [33]
Figure 5. STM images of 6×6, 5×5 reconstructions and carbon nanomesh. (a) An STM image contains 6×6 and 5×5 reconstructions[30]; (b) and (c) STM images acquired on the same area of the 6×6 reconstruction at the sample bias of −2.0 V and 2 V, respectively[5]; (d) and (e) STM image of the carbon nanomesh before and after prolonged annealing, respectively[33]
图 6 (a) 6R3和单层石墨烯在6H-SiC(0001)表面的大范围STM图像;(b) 图a的放大图[42];(c)
$ 6\sqrt{\text{3}} $ 重构在6H-SiC(0001)表面的STM图像;石墨化的表面在(d) U= −0.6 V, (e) U= −1.1 V下获得的STM图像;(f) Co团簇在$ 6\sqrt{\text{3}} $ 重构和石墨烯表面的STM图像[45]Figure 6. (a) Large-scale STM image of 6R3 and monolayer graphene on 6H-SiC(0001); (b) A magnified image of figure (a) [42]; (c) STM image of
$ 6\sqrt{\text{3}} $ reconstruction of 6H-SiC(0001); STM images of Graphitized surface acquired at (d) U= −0.6 V, (e) U= −1.1 V; (f) STM image of Co clusters on$ 6\sqrt{\text{3}} $ reconstruction and graphene[45]图 8 4H-SiC(0001)表面多种表面重构。(a)-(c) 4×4重构,
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R15o和$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o重构对应的STM图像[48];(d) 4H-SiC(0001)的形貌图;(e)-(g) 4H-SiC(0001)表面3×3,$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o以及$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o对应的LEED图[50]Figure 8. Many surface reconstructions on 4H-SiC(001) surface. (a)-(c) STM images of 4×4,
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R15o, and$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o reconstructions[48];(d) The morphology of 4H-SiC(0001); (e)-(g) LEED images of 3×3,$ (\sqrt{\text{3}}\text{×}\sqrt{\text{3}} $ )R30o and$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o reconstructions [50]图 9
$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构的STM图像以及原子排列。(a)和(b)$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o重构的STM图像主要表现为6×6周期,有时候会出现5×5周期; 在偏压为U= 1.7 V(c) and U= 0.2 V (d)下获得的STM图像;(e)$ (6\sqrt{\text{3}}\text{×} $ $ 6\sqrt{\text{3}} $ ) R30o 和6×6结构的原子排列[52]Figure 9. STM images and atoms arrangement of
$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o reconstruction. (a) and (b) STM images of$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o reconstruction mainly show 6×6 periodicity but sometimes appear 5×5 periodicity; STM images are acquired at bias U= 1.7 V(c) and U= 0.2 V (d); (e) The atoms arrangement of$ (6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ ) R30o and 6×6 structures[52]图 10 (1×1)重构的STM图像和STS曲线。(a)和(b) 4H-SiC(0001) 面上(1×1) c 与(1×1)graphitic的STM图像[53];(c) Ni-硅化物团簇在4H-SiC表面下方的形貌图;(d)和(e) Ni团簇在4H-SiC(0001)表面从400-1000℃退火后的I-V曲线和400到 700℃退火后的归一化电导谱[56]。
Figure 10. STM images and STS cures of (1×1) reconstructions. (a) and (b) The STM images of (1×1)c 与(1×1)graphitic on 4H-SiC(0001)[53]; (c) The morphology of the Ni-silicide cluster under the 4H-SiC surface; (d) and (e) I-V curves and normalized conductivity spectra of the Ni clusters on 4H-SiC(0001) surface after annealing from 400 to 1000℃ and from 400 to 700℃[56]
-
[1] Capano M A,Trew R J,Editors G. Silicon carbide electronic materials and devices[J]. MRS Bulletin,1997,22(3):19−22 doi: 10.1557/S0883769400032711 [2] Nakamura D,Gunjishima I,Yamaguchi S,et al. Ultrahigh-quality silicon carbide single crystals[J]. Nature,2004,430(7003):1009−1012 doi: 10.1038/nature02810 [3] Moll P,Pfusterschmied G,Schneider M,et al. Biocompatible a-SiC: H-based bistable MEMS membranes with piezoelectric switching capability in fluids[J]. Journal of Microelectromechanical Systems,2022,31(3):372−383 doi: 10.1109/JMEMS.2022.3163477 [4] Xie X N,Loh K. Observation of a 6×6 superstructure on 6H-SiC (0001) by reflection high energy electron diffraction[J]. Applied Physics Letters,2000,77(21):3361−3363 doi: 10.1063/1.1328050 [5] Li L,Tsong I. Atomic structures of 6H-SiC (0001) and (000$ \stackrel{-}{1} $) surfaces[J]. Surface Science,1996,351(1-3):141−148 doi: 10.1016/0039-6028(95)01355-5 [6] Enriquez H,Derycke V,Aristov V Y,et al. 1D electronic properties in temperature-induced c (4×2) to 2×1transition on the β-SiC (100) surface[J]. Applied Surface Science,2000,162:559−564 [7] Johannesson D,Member S,IEEE,et al. Evaluation of ultrahigh-voltage 4H-SiC gate turn-off thyristors and insulated-gate bipolar transistors for high-power applications[J]. IEEE Transactions on Power Electronics,2022,37(4):4133−4147 doi: 10.1109/TPEL.2021.3122988 [8] Langpoklakpam C,Liu A C,Chu K H,et al. Review of silicon carbide processing for Power MOSFET[J]. Crystals,2022,12(2):1−27 [9] Cuong V V,Member,IEEE,et al. Amplifier based on 4H-SiC MOSFET operation at 500℃ for harsh environment applications[J]. IEEE Transactions on Power Electronics,2022,69(8):4194−4199 doi: 10.1109/TED.2022.3184663 [10] Starke U,Schardt J,Franke M. Morphology, bond saturation and reconstruction of hexagonal SiC surfaces[J]. Applied Physics A-Materials Science & Processing,1997,65(6):587−596 [11] Starke U. Non-basal plane SiC surfaces: Anisotropic structures and low-dimensional electron systems[J]. Physica Status Solidi B-Basic Solid State Physics,2009,246(7):1569−1579 doi: 10.1002/pssb.200945170 [12] Liu Zhongliang,Kang Chaoyang,Tang Jun,et al. Homoepitaxial growth of SiC thin film on 4H-SiC substrate[J]. Journal of Synthetic Crystals,2012,41(1):106−109 (刘忠良,康朝阳,唐军,等. 4H-SiC衬底表面SiC薄膜的同质外延生长[J]. 人工晶体学报,2012,41(1):106−109(in chinese) Liu Zhongliang, Kang Chaoyang, Tang Jun, et al. Homoepitaxial Growth of SiC Thin Film on 4H-SiC Substrate[J]. Journal of Synthetic Crystals, 2012, 41(1): 106-109 (in chinese) [13] Binning G,Rohrer H,Gerber Ch,et al. Surface studies by scanning tunneling microscopy[J]. Physical Review Letters,1982(49):57−61 [14] Hass J,Heer W A d,Conrad E H. The growth and morphology of epitaxial multilayer graphene[J]. Journal of Physics:Condensed Matter,2008,20(32):323202 doi: 10.1088/0953-8984/20/32/323202 [15] Moreau E,Godey S,Wallart X,et al. High-resolution angle-resolved photoemission spectroscopy study of monolayer and bilayer graphene on the C-face of SiC[J]. Physical Review B,2013,88(7):075406 doi: 10.1103/PhysRevB.88.075406 [16] 黄筱淳. Te超薄膜在石墨烯衬底上的外延生长与电子结构调控[D]. 北京: 中国科学院大学, 2017 Huang Xiaochun. Epitaxial growth and electronic structure modulation of tellurium films on graphene[D]. Beijing: University of Chinese Academy of Sciences, 2017 [17] Kulakov M A,Henn G,Bullemcr B. SiC(0001)3 × 3-Si surface reconstruction-a new insight with a STM[J]. Surface Science,1996,346(1-3):49−54 doi: 10.1016/0039-6028(95)00919-1 [18] Li L,Tindall C,Takaoka O,et al. Structural and vibrational properties of 6H-SiC(0001) surfaces studied using STM/HREELS[J]. Surface Science,1997,385(1):60−65 doi: 10.1016/S0039-6028(97)00143-X [19] Hoster H E,Kulakov M A,Bullemer B. Morphology and atomic structure of the SiC(000$ \stackrel{-}{1} $) surface reconstruction[J]. Surface Science,1997,382:L658−L665 doi: 10.1016/S0039-6028(97)00084-8 [20] Gasparov V A,Riehl-Chudoba M,Schröter,B,et al. Scanning tunneling spectroscopy on the 6H-SiC(0001)(3 × 3) surface[J]. Europhysics Letters,2000,51(5):527−533 doi: 10.1209/epl/i2000-00370-1 [21] Stroscio J A,Fccnstra,R M,Fein A P. Electronic structure of the Si(111) 2 × 1 surface by scanning-Tu»cling microscopy[J]. Physical Review Letters,1986,57(20):2579−2582 doi: 10.1103/PhysRevLett.57.2579 [22] Martrou D,Leoni T,Chaumeton F,et al. Giant (12×12) and (4×8) reconstructions of the 6H-SiC(0001) surface obtained by progressive enrichment in Si atoms[J]. Physical Review B,2018,97(8):081302 doi: 10.1103/PhysRevB.97.081302 [23] Hiebel F,Magaud L,Mallet P,et al. Structure and stability of the interface between graphene and 6H-SiC(000$ \stackrel{-}{1} $) (3 × 3): an STM and ab initio study[J]. Journal of Physics D:Applied Physics,2012,45(15):154003 doi: 10.1088/0022-3727/45/15/154003 [24] Owman F,Mårtensson P. STM study of the SiC(0001)$ \sqrt{\text{3}}\text{×}\sqrt{\text{3}} $surface[J]. Surface Science,1995,330(1):L639−L645 doi: 10.1016/0039-6028(95)00427-0 [25] Owman F,Mårtensson P. Scanning tunneling microscopy study of SiC(0001) surface reconstructions[J]. Journal of Vacuum Science & Technology B,1996,14(2):933−937 [26] Johansson L I,Owman F,Mårtensson P. High-resolution core-level study of 6H-SiC(0001)[J]. Physical Review B,1996,53(20):13793−13802 doi: 10.1103/PhysRevB.53.13793 [27] Li L,Hasegawa Y,Sakurai T. Field-ion scanning tunneling microscopy study of the atomic structure of 6H-SiC(0001) surfaces cleaned by in situ Si molecular beam etching[J]. Journal of Applied Physics,1996,80(4):2524−2526 doi: 10.1063/1.363037 [28] Chang C S,Tsong I S T,Wang Y C,et al. Scanning tunneling microscopy and spectroscopy of cubic β-SiC(111) surfaces[J]. Surface Science,1991,256(3):354−360 doi: 10.1016/0039-6028(91)90877-U [29] Tsai M H,Chang,C S,Dow,J D,et al. Electronic contributions to scanning-tunneling-microscopy images of an annealed β-SiC(111)surfac[J]. Physical Review B,1992,45(3):1327−1332 doi: 10.1103/PhysRevB.45.1327 [30] Owman F,Mårtensson P. The SiC(0001)$ 6\sqrt{\text{3}}\text{×6}\sqrt{\text{3}} $ reconstruction studied with STM and LEED[J]. Surface Science,1996,369(1-3):126−136 doi: 10.1016/S0039-6028(96)00919-3 [31] Tok E S,Ong W J,Wee A T S. 6H-SiC(0 0 0 1) phase transition: evolution of the (6 × 6) magic clusters[J]. Surface Science,2004,558(1-3):145−158 doi: 10.1016/j.susc.2004.03.062 [32] Chen W,Loh K P,Xu H,et al. Nanoparticle dispersion on reconstructed carbon nanomeshes[J]. Langmuir,2004,20(25):10779−10784 doi: 10.1021/la048530m [33] Chen W,Xu H,Liu L,et al. Atomic structure of the 6H–SiC(0001) nanomesh[J]. Surface Science,2005,596(1-3):176−186 doi: 10.1016/j.susc.2005.09.013 [34] Emtsev K V,Bostwick A,Horn K,et al. Towards wafer-size graphene layers by atmospheric pressure graphitization of silicon carbide[J]. Nature Materials,2009,8(3):203−207 doi: 10.1038/nmat2382 [35] Hu Jugang,Jia zhenyu,Li Shaochun. Electron transport property of epitaixial bilayer graphene on SiC substrate[J]. Acta Physica Sinica,2022,71(12):127204 (胡聚罡,贾振宇,李绍春. 碳化硅衬底上外延双层石墨烯的电输运性质[J]. 物理学报,2022,71(12):127204(in chinese) doi: 10.7498/aps.71.20220062 Hu Jugang, Jia zhenyu, Li Shaochun. Electron transport property of epitaixial bilayer graphene on SiC substrate[J]. Acta Physica Sinica, 2022, 71(12): 127204 (in chinese) doi: 10.7498/aps.71.20220062 [36] Lin Y M,Dimitrakopoulos C,Jenkins K A,et al. 100-GHz transistors from wafer-scale epitaxial graphene[J]. Science,2010,327(5966):662−662 doi: 10.1126/science.1184289 [37] Seungchul K,Jisoon J,Joon C H,et al. Origin of anomalous electronic structures of epitaxial graphene on silicon carbide[J]. Physical Review Letters,2008,100(17):17802 [38] Zhou S Y,Gweon G H,Fedorov A V,et al. Substrate-induced bandgap opening in epitaxial graphene[J]. Natures Materials,2007,6(10):770−775 doi: 10.1038/nmat2003 [39] Varchon F,Feng R,Hass J,et al. Electronic structure of epitaxial graphene layers on SiC: effect of the substrate[J]. Physical Review Letters,2007,99(12):126805 doi: 10.1103/PhysRevLett.99.126805 [40] Rutter G M,Guisinger N P,Crain J N,et al. Imaging the interface of epitaxial graphene with silicon carbide via scanning tunneling microscopy[J]. Physical Review B,2007,76(23):235416 doi: 10.1103/PhysRevB.76.235416 [41] Hu T W,Ma F,Ma D Y,et al. Evidence of atomically resolved 6 ×6 buffer layer with long-range order and short-range disorder during formation of graphene on 6H-SiC by thermal decomposition[J]. Applied Physics Letters,2013,102(17):171910 doi: 10.1063/1.4804290 [42] Choi J,Lee H,Kim S. Atomic-scale investigation of epitaxial graphene grown on 6H-SiC(0001) using scanning tunneling microscopy and spectroscopy[J]. Journal of Physical Chemistry C,2010,114(31):13344−13348 doi: 10.1021/jp1048716 [43] Hu T W,Ma D Y,Ma F,et al. Preferred armchair edges of epitaxial graphene on 6H-SiC(0001) by thermal decomposition[J]. Applied Physics Letters,2012,101(24):241903 doi: 10.1063/1.4769967 [44] Mallet P,Varchon F,Naud C,et al. Electron states of mono- and bilayer graphene on SiC probed by scanning-tunneling microscopy[J]. Physical Review B,2007,76(4):041403 [45] Poon S W,Chen W,Wee A T S,et al. Growth dynamics and kinetics of monolayer and multilayer graphene on a 6H-SiC(0001) substrate[J]. Physical Chemistry Chemical Physics,2010,12(41):13522−13533 doi: 10.1039/b927452a [46] Tsukamoto T,Hirai M,Kusaka M,et al. Structural analysis of the heat-treated 4H(6H)-SiC(0001)Si surface[J]. Surface Science,1997,37(2-3):316−320 [47] Tsukamoto T,Hirai M,Kusaka M,et al. Annealing effect on surfaces of 4H(6H)-SiC(0001)Si face[J]. Applied Surface Science,1997,113:467−471 [48] Kulakov M A,Hoster,H,Henn,G,et al. Morphology and atomic structure of SiC(0001) surfaces: a UHV STM study[J]. Materials Science and Engineering B,1997,46(1-3):227−230 doi: 10.1016/S0921-5107(96)01980-0 [49] Schardt J,Bernhardt J,Starke U,et al. Crystallography of the 3×3 surface reconstruction of 3C-SiC(111), 4H-SiC(0001), and 6H-SiC(0001) surfaces retrieved by low-energy electron diffraction[J]. Physical Review B,2000,62(15):10335−10344 doi: 10.1103/PhysRevB.62.10335 [50] Starke U,Riedl C. Epitaxial graphene on SiC(0001) and SiC(000$ \stackrel{-}{1} $): from surface reconstructions to carbon electronics[J]. Journal of Physica condensed Matter,2009,21(13):134016 doi: 10.1088/0953-8984/21/13/134016 [51] Kubler L,Simon L,Aubel D,et al. 6H- Aand 4H-SiC(0001) Si surface richness dosing by hydrogen etching: a way to reduce the formation temperature of reconstructions[J]. Surface Review and Letters,2003,10(1):55−63 doi: 10.1142/S0218625X03004652 [52] Riedl C,Starke U. Structural properties of the graphene-SiC(0001) interface as a key for the preparation of homogeneous large-terrace graphene surfaces[J]. Physical Review B,2007,76(24):245406 doi: 10.1103/PhysRevB.76.245406 [53] Guy O J,Lodzinski M,Teng K S,et al. Investigation of the 4H–SiC surface[J]. Applied Surface Science,2008,254(24):8098−8105 doi: 10.1016/j.apsusc.2008.03.056 [54] Bernhardt J,Nerding M,Starke U,et al. Stable surface reconstructions on 6H-SiC(000$ \stackrel{-}{1} $)[J]. Materials Science and Engineering B,1999,61-62:207−211 doi: 10.1016/S0921-5107(98)00503-0 [55] Guy O J,Pope G,Blackwood I,et al. Creating room temperature Ohmic contacts to 4H–SiC: studied by specific contact resistance measurements and X-ray photoelectron spectroscopy[J]. Surface Science,2004,573(2):253−263 doi: 10.1016/j.susc.2004.09.035 [56] Blackwood I,Teng K,Maffeïs T,et al. Investigation of annealing effects on the adsorption of Ni on 4H–SiC (0001) surfaces using scanning tunneling microscopy and spectroscopy[J]. Journal of Applied Physics,2005,98:103528 doi: 10.1063/1.2136423 [57] Laikhtman A,Baffou G,Mayne A J,et al. Scanning tunnelling microscopy imaging and spectroscopy of p-type degenerate 4H-SiC(0001)[J]. Journal of Physics:condensed Mater,2005,17(26):4015−4022 doi: 10.1088/0953-8984/17/26/002 [58] Tanaka H,Ohno S,Miki K,et al. Thermal oxidation process on Si(113)-(3 × 2) investigated using high-temperature scanning tunneling microscopy[J]. Journal of nanotechnology,2022,13:172−181 [59] Mahato J C,Das D,Das P,et al. Tuning the length/width aspect ratio of epitaxial unidirectional silicide nanowires on Si(110)-16 × 2 surface[J]. Nano Express,2021,1(2):020045 [60] Osiecki J R,Suto S,Chutia A. Periodic corner holes on the Si(111)-7×7 surface can trap silver atoms[J]. Nature Communications,2022,13(1):2973 doi: 10.1038/s41467-022-29768-6 -


 首页
首页 登录
登录 注册
注册



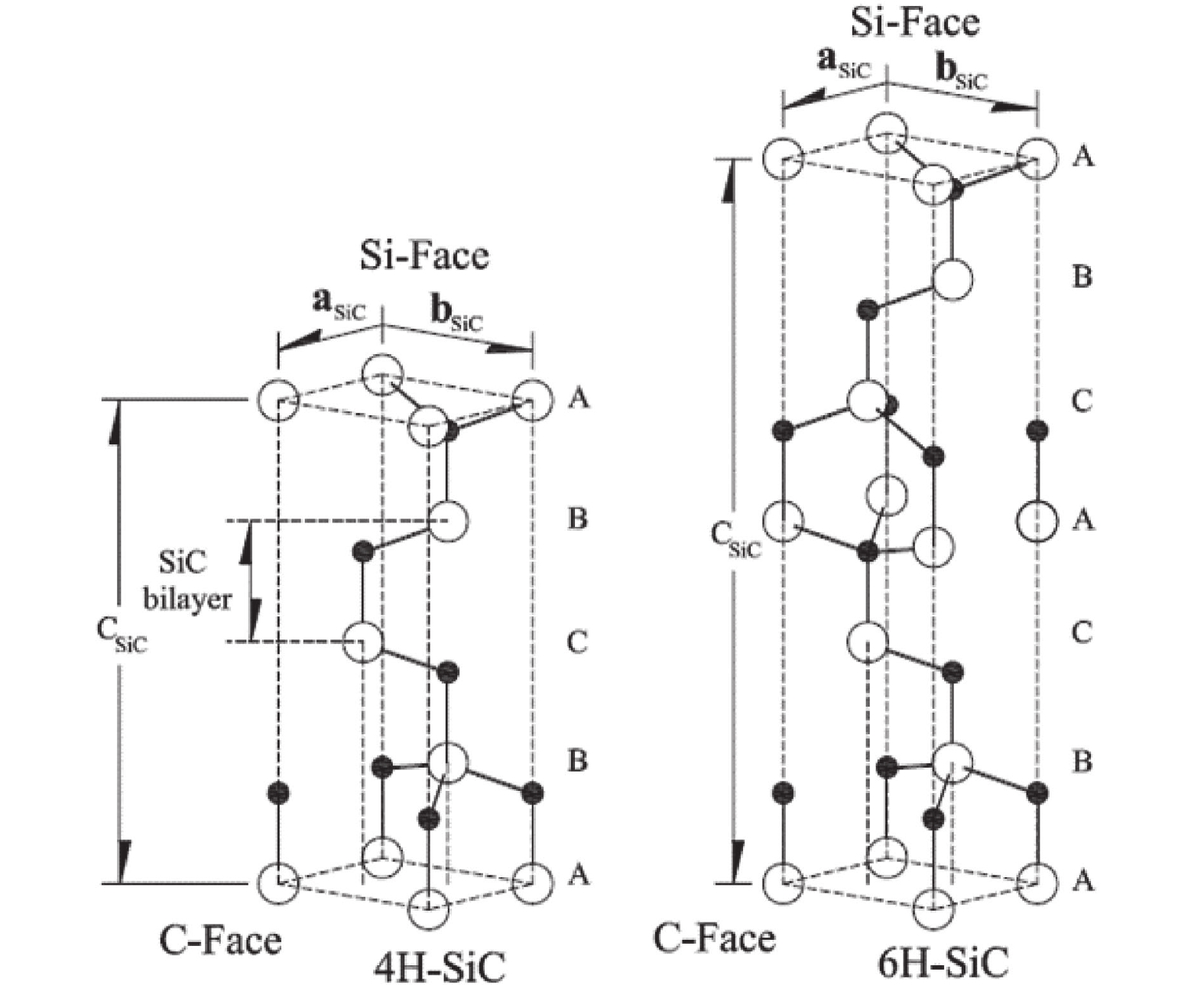
 下载:
下载: