-
非晶硅是近年来广受关注的半导体材料。非晶硅材料带隙范围较宽,且变化可控,光吸收系数高,能够实现从可见光到短波红外的高效光吸收[1-2]。另外其具有电阻温度系数高,可控掺杂工艺较易实现,以及与半导体制造工艺相兼容等特点[3]。因此,它在太阳能电池、MEMS器件、薄膜晶体管及偏振光栅结构等研究领域都有着广泛的应用[4-7]。非晶硅薄膜的制备方法主要有化学气相沉积(CVD)、磁控溅射(MS)以及电子束蒸发(EBE)等[8-10]。在目前已报道的沉积非晶硅薄膜的方法中,CVD法具有极大的多功能性,并可控制所得薄膜的沉积速率以及光学和机械性能。CVD生长非晶硅最常用的工艺是等离子增强CVD(PECVD)和电感耦合等离子CVD(ICPCVD)[11-12]。其中,PECVD法制备的非晶硅折射率高,热光性能好,工艺简单,便于集成。但是由于其电容耦合射频结构特点,容易在生长过程中因高能离子撞击而对生长薄膜造成损伤,并且PECVD生长非晶硅薄膜工艺较高的温度要求,一般为250-350℃。ICPCVD在低温下生长非晶硅薄膜方面具有较大优势,因为它具有~1012 cm−3的高等离子体密度和良好的均匀性,能够在工艺过程中实现更低的功率和更低的温度下的等离子体离解。并且与PECVD相比,由于等离子体电势值较低,对生长表面的离子轰击较少,减轻了离子轰击对生长表面的影响,从而确保了沉积的非晶硅薄膜中的低缺陷密度[13]。对于ICPCVD生长非晶硅工艺,目前所报道的文献中大多数温度都控制在120℃以上,很少有研究者关注120℃以下的生长工艺[14]。而有些器件结构如柔性聚合物MEMS器件和光学薄膜则有着更低温度生长非晶硅薄膜的需求。
布拉格反射结构(DBR)是实现光学MEMS可调法布里-珀罗(FP)滤波器的重要组成部分。一个简单的三层DBR一般由两个高折射率介电材料中间夹一层低折射率介电层所组成。每一层材料都是四分之一波长的光学厚度。非晶硅、氮化硅和氧化硅是制作DBR结构的候选系列材料之一,其相较于其他半导体材料体系的优点在于合成薄膜方式的简易性及低成本。其中的非晶硅层需具备较高的折射率和较低的消光系数[15]。
本文利用ICPCVD在100℃以下温度生长非晶硅薄膜,并通过调节气体流量比例、射频功率及反应温度等参数,实现低温下高质量非晶硅薄膜的生长。还研究了非晶硅薄膜折射率、透过率等光学特性,最后制备了两种布拉格反射结构,实现在可见光和红外波段的分别为90.4%和88.9%的高反射率。
-
制备非晶硅薄膜的衬底分别采用玻璃片(BF33)和蓝宝石片。玻璃片厚度约500 μm,主要用于非晶硅薄膜生长后的应力测试、拉曼测试及光透过率测试;蓝宝石片厚度约为500 μm,主要用于非晶硅薄膜的椭偏仪测试。首先将衬底依次放入丙酮、无水乙醇和去离子水中,分别超声波清洗10 min,完成有机清洗流程后迅速用高纯氮气枪吹干,将洁净的衬底片放入ICPCVD设备中进行非晶硅薄膜的沉积工艺。ICPCVD设备采用牛津仪器的OXFORD PLASMALAB 100,它的电感耦合线圈是通过匹配单元连接到13.56 MHz、3.0 kW的射频电源上。ICP线圈功率可以单独控制等离子体密度。下电极是一个独立的13.56 MHz、功率为300 W的射频源,可以独立控制轰击衬底的能量。ICPCVD是在电感线圈上施加高频电流,线圈在射频电流驱动下,激发变化的磁场,变化的磁场感生回旋电场。电子在有旋电场的加速下作回旋运动,将反应源气体分子碰撞并将其离解,产生了大量的活性等离子基团,并在气流的作用下被输运到衬底表面并被吸附,然后通过表面反应形成薄膜。ICP中电子的回旋加速增加了其与气体分子的碰撞几率,能够产生比传统电容式放电更高的等离子体密度,使低温快速沉积高质量的薄膜成为可能[16]。在工艺过程中,影响薄膜性能的主要沉积参数包含工艺气体流量比、ICP功率、RF功率和温度等。进入工艺阶段,通过改变Ar和SiH4的气体流量比、ICP功率、RF功率和温度等工艺参数,制备出不同条件下的非晶硅薄膜,生长时间都为10 min,压力都为10 mTorr。实验中典型参数如表1所示。
-
采用美国FSM公司的FSM8800分析非晶硅薄膜的应力;采用德国布鲁克公司的DektakXT探针式台阶仪测试样品的生长厚度;采用日本HORRIBA-JY公司的LABRAM HR激光共聚焦拉曼光谱仪进行样品的拉曼表征;采用美国Woollam J A的椭偏仪验证薄膜厚度和折射率测试。采用美国PerkinElmer公司的LAMBDA 750紫外/可见/红外分光光度计分析薄膜的光透过率性能。
-
ICP功率通常会对非晶硅薄膜的成膜速度产生影响。较高的ICP功率会导致更多的离子和电子在反应室中产生,从而增加非晶硅薄膜的成膜速度。如图1(a)所示,当ICP功率从500 W逐步增加到2000 W时,非晶硅薄膜的沉积速率从3.6 nm/min增加到10.3 nm/min。但是,如果ICP功率过高,可能会引起过度的表面反应和结晶,从而导致非晶硅薄膜质量下降。因此,在ICPCVD生长非晶硅薄膜时,需要根据具体的实验条件选择适当的ICP功率,以获得较高的生长速率和优良的薄膜质量。而薄膜应力随着ICP功率的增加而增大,到1500 W时,应力增加至−1875 MPa。可以看出高ICP功率通常也会导致非晶硅薄膜的内部应力增大,这主要是因为高功率产生的离子轰击和沉积速率不均匀等因素。功率增加至2000 W时,应力反而有所下降,可能是由于反应离子过饱和导致薄膜致密性有所下降。
图1(b)展示了下电极射频功率对沉积速率和薄膜应力的影响。可以看出其他条件不变时,随着RF功率从50 W提升到150 W,沉积速率从5.5 nm/min提升至9 nm/min;应力也从−106 MPa增加至−1099 MPa。分析速率提高是由于下电极射频功率的增加会增加等离子体的能量和密度,促进非晶硅前体气体的解离和反应。下电极射频也会增强对衬底表面新沉积薄膜的物理轰击,使薄膜更加致密,因此薄膜应力也随之增加。
气体比例对沉积速率和应力有显著的影响,因为不同气体在等离子体中的化学反应和物理过程是不同的。通常,气体比例的改变会改变等离子体的性质和反应过程,从而影响沉积速率和应力。如图1(c)所示,本实验采用反应气体SiH4和Ar的混合气体。SiH4为主反应气体,而加入Ar取代常用的H2可以降低非晶硅薄膜的含H量,从而提升薄膜的光学特性,还可以提高对衬底表面的物理轰击作用,提高薄膜质量。从曲线可以看出最开始沉积速率随着SiH4/Ar比例的增加而增加,而应力则随之减小。这是由于SiH4主反应气体的增加导致反应等离子密度提高增强了化学反应。而当气体比例增加到一定程度时,等离子密度过饱和,沉积速率有所降低,而应力有所增加。
根据上述参数分析,当衬底温度为温度75℃时, ICP功率1000 W,RF功率150 W,压力10 mTorr及SiH4:Ar=40:80 mL/min的工艺参数具有较高的沉积速率和合适的薄膜应力,可作为最优参考条件。
-
拉曼光谱是表征微晶硅结构的一种重要手段。以最优参考条件为基础,在不同衬底温度下沉积的样品的拉曼光谱如图2(a)所示。在25℃和50℃下沉积的薄膜显示出已481 cm−1为中心的宽带,这表示薄膜结构是非晶态的。当衬底温度升高到75℃时,出现了约506 cm−1的主峰,这说明出现了小微晶结构。当衬底温度增加至100℃时,主峰位置移动至516 cm−1附近,说明薄膜逐渐向微晶硅转变。
拉曼光谱中的谱带可以解耦为三个独立的高斯峰:以约480 cm−1为中心的宽峰、在520 cm−1处的主峰和在510 cm−1 附近的中间峰。结晶分数FC可以通过如下公式表示:
式中I480、I510和I520分别代表480、510和520 cm−1附近的高斯峰的积分强度[17]。对衬底温度为100℃时沉积的非晶硅薄膜的拉曼光谱进行高斯拟合,未发现中间峰。两个峰位实际得到的结晶分数FC约为64.4%。主峰的实际峰位约在516cm−1附近,可以根据式2进一步计算出薄膜样品的晶粒尺寸:
式中B为常数,一般取值为2.24 nm2/cm,Δω表示拉曼散射频移,即为晶态峰位与硅单晶峰位之差。通过计算可以得到100℃时,薄膜的最大晶粒尺寸可以达到约4.7 nm。
-
本实验采用蓝宝石衬底上生长的非晶硅薄膜进行椭偏仪测试,得到了较优的软件拟合曲线。使用柯西色散方程,从测得的光学数据中提取了非晶硅薄膜的折射率n和消光系数k。如图3(a)和(b)所示。
柯西色散方程可表示为:
式中,n(λ)是薄膜的折射率,k是薄膜的消光系数,n0、n1、n2、k0和k1是拟合系数。计算中包括了蓝宝石衬底的背面反射[15]。
从图3(a)可以看出随着温度的升高,非晶硅薄膜的折射率也相应提高,在100℃时已波长1000 nm为标准,折射率约为3.29。这是由于在较高衬底温度下沉积的薄膜结构孔隙较少,并且提升了薄膜的致密性。如图3(b)所示,消光系数也和温度的变化存在一定的联系。可以看出随着衬底温度的升高,消光系数随之降低。非晶硅薄膜的消光系数与密度和折射率有关,而这两个参数都受到沉积温度的影响。当沉积温度升高时,非晶硅薄膜中的硅键密度增加,从而使薄膜密度增加,折射率也随之变化,从而使消光系数降低。从而也验证了温度升高可以提高薄膜的结晶质量,与拉曼的测试结构相符。
图4为不同温度条件下沉积的非晶硅薄膜的光透过率曲线,显示了波长从500−1100 nm测量的光透射率和衬底温度的函数关系。本实验的光透过率曲线未出现干涉条纹振荡,这可能是由于所有实验条件生长的非晶硅薄膜较薄。可以看出在可见光波段(500−600 nm),曲线幅度都是急剧衰减,这表明该区域比红外波段(700−1100 nm)具有更高的吸收。在红外波段,随着温度的提高而吸收减少,光透过率提高,这同样源于薄膜晶体质量的提高。
此外,非晶硅薄膜的光学带隙可以用Tauc公式来计算:
式中,α是吸收系数,hν为光子能量,Eg为光学带隙的能量,B是被称为边缘宽度参数的常数[18]。从光透射率图转换的Tauc图中线性状态部分延伸与横轴的交点即为样品的光学带隙宽度Eg。如图5所示,在衬底温度为25℃时,所计算的薄膜光学带隙约为1.83 eV,而当温度上升到100℃时,光学带隙降低至1.68 eV。一般认为非晶硅材料的光学带隙在1.12 eV−2.4 eV,而质量较好的非晶硅带隙宽度要小于1.7 eV。这说明随着衬底温度的提高,非晶硅薄膜逐渐从非晶态向微晶态转变。这同样与拉曼光谱的分析结果相一致。原因可能为衬底温度升高导致等离子体中SiH3基团迁移速率加快。薄膜表面吸附的H原子大量放出,加强了硅悬挂键的钝化效果,使薄膜定域态密度下降,从而导致薄膜光学带隙宽度下降。
-
为了验证ICPCVD非晶硅薄膜的光学性能,作者在玻璃片衬底上采用本实验ICPCVD的最优沉积条件(温度100℃,ICP功率1000 W,RF功率150 W,压力10 mTorr,SiH4:Ar=40:80 mL/min)生长的非晶硅薄膜作为上下两层高折射率层,中间由一层同设备生长的SiO2低折射率层隔开,SiO2的生长条件为:衬底温度75℃,ICP功率2000 W,RF功率150 W,SiH4:N2O=17:80 mL/min,压力5 mTorr。从而形成Si-SiO2-Si结构。ICPCVD沉积的SiO2层在可见光到近红外波长范围内可忽略消光系数。每一层在适当波段的中心波长处的厚度为四分之一波长。根据可见光和近红外两种不同波段,制备了两种薄膜厚度的DBR,如图6(a)所示,在可见光波段,顶层非晶硅、中间层SiO2和底层非晶硅的厚度分别为36 nm、100 nm和41 nm。在500−700 nm波段所测得的峰值反射率约为90.4%。如图6(b)所示,在近红外波段,顶层非晶硅、中间层SiO2和底层非晶硅的厚度分别为62 nm、132 nm和60 nm。在700−1000 nm波段所测得的峰值反射率约为88.9%。接近于理论计算值93%和92%[15]。这说明尽管所制备非晶硅薄膜在可见光和近红外波段处有明显的吸收,但薄四分之一波长硅层会产生高反射率DBR,并且适用于FP滤波器制造。这DBR结构具有较大的光学带宽,也适用于光谱学等相对较宽光谱范围内的应用。
-
在本项工作中,利用ICPCVD在100℃及以下生长非晶硅薄膜,并通过调节气体流量比例、射频功率及衬底温度等参数,得到较优的沉积条件,实现低温下高质量非晶硅薄膜的生长。随后用拉曼光谱表征分析研究了衬底温度变化对非晶硅薄膜沉积质量的影响。研究发现随着温度的提升,薄膜非晶硅516 cm−1附近的主峰逐渐形成,表面薄膜质量的逐步提高。通过公式计算出衬底温度为100℃时,非晶硅薄膜的结晶分数和微晶尺寸分别为64.4%和4.7 nm。此外还研究了非晶硅薄膜折射率、透过率等光学特性,并计算出薄膜的光学带隙最低为1.68。最后制备了两种布拉格反射结构,实现在可见光和红外波段的分别为90.4%和88.9%的峰值高反射率,与理论计算值相接近,适用于FP滤波器制造及光谱学等相对较宽光谱范围内的应用。
ICPCVD低温生长非晶硅的工艺及光学特性研究
Technology and Optical Properties of Amorphous Silicon Grown at Low Temperature by ICPCVD
-
摘要: 文章利用ICPCVD在100℃及以下玻璃和蓝宝石片衬底上生长非晶硅薄膜,并通过调节Ar和SiH4气体流量比例、射频功率及衬底温度等参数,实现低温下高质量非晶硅薄膜的生长。随后用拉曼光谱表征分析研究了衬底温度变化对非晶硅薄膜沉积质量的影响,并计算出衬底温度为100℃时,非晶硅薄膜的结晶分数和微晶尺寸分别为64.4%和4.7 nm。此外还研究了非晶硅薄膜折射率和透过率等光学特性,并计算出薄膜的光学带隙最低为1.68。最后制备了两种a-Si/SiO2/a-Si布拉格反射结构,厚度分别为36/100/41 nm和62/132/60 nm。两种结构在可见光和红外波段分别实现了90.4%和88.9%的最高反射率。Abstract: In this paper, amorphous silicon thin films were grown on glass and sapphire substrates at temperatures of 100℃ and below, using the ICPCVD method. The growth of high-quality amorphous silicon films at low temperatures was achieved by adjusting parameters such as the gas flow ratio of Ar to SiH4, radio frequency power, and substrate temperature. The effect of substrate temperature on the deposition quality of amorphous silicon films was characterized and analyzed using Raman spectroscopy. It was found that at a substrate temperature of 100°C, the crystalline fraction and microcrystalline size of the amorphous silicon film were 64.4% and 4.7 nm, respectively. In addition, the optical properties such as refractive index and transmittance of the amorphous silicon films were studied, and the calculated optical bandgap of the films was found to be 1.68 eV. Finally, two types of a-Si/SiO2/a-Si Bragg reflector structures were fabricated with thicknesses of 36/100/41 nm and 62/132/60 nm, respectively. These two structures achieved high reflectivity of 90.4% in the visible light range and 88.9% in the infrared range, respectively.
-
Key words:
- ICPCVD /
- Amorphous silicon film /
- RF power /
- Refractive index /
- Bragg reflection .
-

-
表 1 非晶硅薄膜典型沉积参数
Table 1. Typical deposition parameters of amorphous silicon films
温度/℃ ICP功率/W RF功率/W SiH4流量/
(mL/min)Ar流量/
(mL/min)75 2000 150 17 80 100 1000 150 40 80 75 1000 150 40 80 75 1000 100 40 80 75 1000 100 40 40 50 1000 150 40 80 -
[1] Wagner S. Amorphous silicon: Vehicle and test bed for large‐area electronics[J]. Physica Status Solidi,2010,207(3):501−509 doi: 10.1002/pssa.200982910 [2] Li Z,Zhang X,Han G. Electrical and optical properties of boron‐doped nanocrystalline silicon films deposited by PECVD[J]. physica status solidi (a),2010,207:144−148 doi: 10.1002/pssa.200925107 [3] Strum A, Fenigstein A. Complementary metal-oxide-semiconductor (CMOS) X-ray sensors[J]. High Perform. Silicon Imaging, 2020: 413-436 [4] Ramanujam J,Bishop D M,Todorov T K,et al. Flexible CIGS, CdTe and a-Si: H based thin film solar cells: A review[J]. Prog Mater Sci,2019,110:100619 [5] Cianci E,Coppa A,Foglietti V,et al. Fabrication of RF-MEMS switches on LTCC substrates using PECVD a-Si as sacrificial layer[J]. Microelectron Eng,2007,84(5-8):1401−1404 doi: 10.1016/j.mee.2007.01.096 [6] Chen C W,Chang T C,Liu P T,et al. High-performance hydrogenated amorphous-Si TFT for AMLCD and AMOLED applications[J]. IEEE Electron Device Lett,2005,26(10):731−733 doi: 10.1109/LED.2005.855405 [7] Lee S,Kim S. Optical absorption characteristic in thin a-Si film embedded between an ultrathin metal grating and a metal reflector[J]. IEEE Photonics J,2013,5(5):4800610 doi: 10.1109/JPHOT.2013.2280339 [8] Takagi T,Takechi K,Nakagawa Y,et al. High rate deposition of a-Si: H and a-SiNx: H by VHF PECVD[J]. Vacuum,1998,51(4):751−755 doi: 10.1016/S0042-207X(98)00284-X [9] Triendl F,Pfusterschmied G,Fleckl G,et al. On the crystallization behavior of sputter-deposited a-Si films on 4H-SiC[J]. Thin Solid Films,2020,697:137837 doi: 10.1016/j.tsf.2020.137837 [10] Sontheimer T, Becker C, Ruske F, et al. Challenges and opportunities of electron beam evaporation in the preparation of poly-Si thin film solar cells[C]. 2010 35th IEEE Photovoltaic Specialists Conference, 2010: 000614−000619 [11] Chen K C,Ming Q T,Po H T,et al. Fabrication and characterization of amorphous Si films by PECVD for MEMS[J]. J Micromech Microeng,2004,15(1):136 [12] Castro F G,Sagazan O D,Coulon N,et al. ICP-CVD μ-Si layers optimization for strain gauges on flexible substrates[J]. Sens and Actuators A,2020,315:112261 doi: 10.1016/j.sna.2020.112261 [13] Brookshire K L, Martyniuk M, Silva K, et al. Long-term stability of ICPCVD a-Si under prolonged heat treatment[C]. 2014 Conference on Optoelectronic and Microelectronic Materials & Devices. IEEE, 2014: 160-163 [14] Han S M,Lee M C,Shin M Y,et al. Poly-Si TFT fabricated at 150 deg C using ICP-CVD and excimer laser annealing[J]. Proc IEEE,2005,93(7):1297−1305 doi: 10.1109/JPROC.2005.851535 [15] Tripathi D K,Jiang F,Martyniuk M,et al. Optimization of ICPCVD amorphous silicon for optical MEMS applications[J]. J Microelectromech Syst,2015,24(6):1998−2007 doi: 10.1109/JMEMS.2015.2459066 [16] Doris K T N,Wang Q,Wang T,et al. Exploring high refractive index silicon-rich nitride films by low-temperature inductively coupled plasma chemical vapor deposition and applications for integrated waveguides[J]. ACS Appl Mater Interfaces,2015,7(39):21884−21889 doi: 10.1021/acsami.5b06329 [17] Dalal V,Graves J,Leib J. Influence of pressure and ion bombardment on the growth and properties of nanocrystalline silicon materials[J]. Appl Phys Lett,2004,85(8):1413−1414 doi: 10.1063/1.1784550 [18] Qin Y,Yan H,Li F,et al. The optoelectronic properties of silicon films deposited by inductively coupled plasma CVD[J]. Appl Surf Sci,2010,257(3):817−822 doi: 10.1016/j.apsusc.2010.07.071 -


 首页
首页 登录
登录 注册
注册



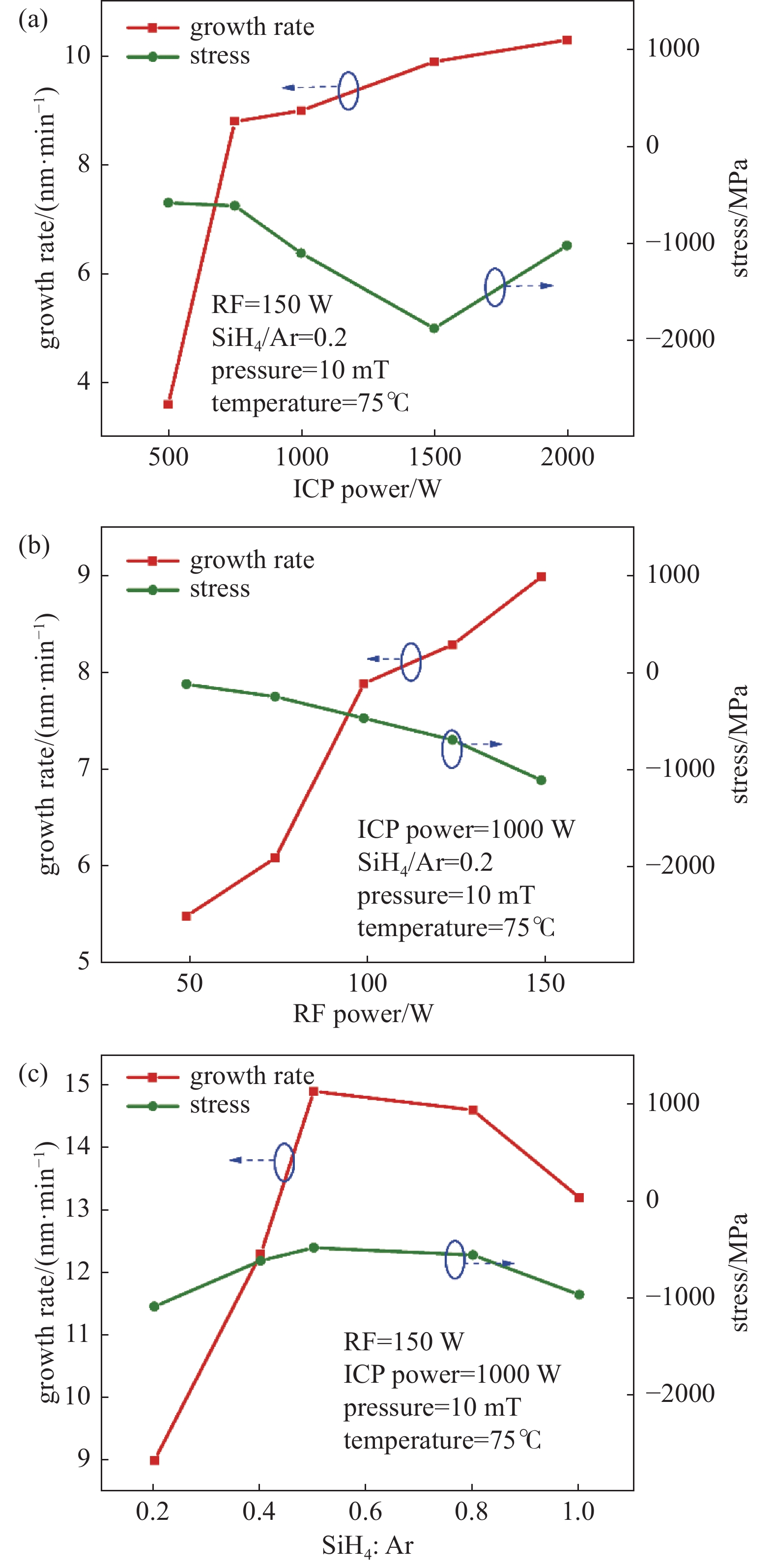
 下载:
下载: