-
随着平面半导体微缩技术的不断发展,摩尔定律逐渐走到物理极限,传统平面器件逐渐向三维器件转变。考虑到三维器件工艺的高投入,业界倾向于用超高深宽比(>50)结构提升器件密度以此平衡三维器件工艺的高成本。特别是近些年快速发展的3D NAND存储器,深宽比基本在70以上,最新公布的进展甚至超过100。这就要求在传统热原子层沉积(TALD)优越的台阶覆盖性(step coverage),较大的工艺窗口,良好的保形性(conformal)的基础上,开发出反应速率尽可能高,工艺成本尽可能低的ALD技术。因此业界导入等离子体增强原子层沉积工艺(PEALD);等离子体的引入可以大幅降低反应温度,提高薄膜沉积速率。PEALD单次循环的总时长一般不超过2 s,其中化学吸附(dose)是决速步。在氧化硅沉积过程,通常吡啶(C5H5N)和氨(NH3)可以作为催化剂来加速化学吸附速率,但残留在薄膜中的催化剂会使薄膜性能降低[1-4]。PEALD工艺中,对多种硅前体做了评估; 主要有硅烷基酰胺[5-10],硅烷氧基化物[11]和硅卤化物[12-14]。在各类型硅前体中,硅烷基酰胺前驱体与其他类型前驱体相比,具有低蚀刻速率、高薄膜密度、低沉积温度、低前体消耗量和合理的生长速率成为当下应用最广泛的氧化硅PEALD前驱体[7, 9, 11]。
目前半导体工业实际使用的硅烷基酰胺前驱体有DIPAS (Diisopropylamino Silane), BDEAS(Bis(diethylamino) Silane),BTBAS(Bis(tertiarybutylamino) Silane),BDIPADS(1,2-Bis(diisopropylamino)disilane)等如表1所示。硅烷基酰胺前驱体中氮(N)原子存在孤对电子,极易吸附在Si—OH结尾的硅基底表面。这是由于Si—N的键离解能(BDE)在前驱体所有键中是相对低的,当这些前驱体与活性硅表面反应时,Si—N键很容易断裂,形成Si—O—Si键,解离的胺基不会对体系产生刻蚀作用[15-19]。 BDIPADS和DIPAS一样,反应速率随温度升高而加快。相比于DIPAS,BDIPADS的低温反应性能更优,这是由于BDIPADS的Si—Si容易断裂产生新的反应位点,而DIPAS中Si—H在低温下(100℃)不容易断裂,ALD 循环难以继续下去。因而DIPAS适用于高温ALD,而BDIPADS适用温度范围更广;但由于分子位阻较大,且饱和蒸汽压过低,导致每个ALD 循环中化学吸附步骤吸附的前驱体量有限,单次ALD循环生长厚度(GPC)低 [20]。BDEAS的热稳定性较BTBAS差,因而BDEAS一般不会用作高温ALD的前驱体。 在高深宽比结构填充的相关应用中,为了使深孔内薄膜质量满足结构支撑作用,一般会采用高温ALD制程(≥500℃)。业界常用的高温PEALD前驱体是BTBAS。以BTBAS为前驱体填充含有多晶硅导电沟道的高深宽比结构常存在电性失效问题。传统工艺一般在电性测试后才能找到失效区域,最后再用切片做分析。反馈时间周期长,不利于快速解决问题。本文则利用电子束扫描技术,提前发现失效区域。
-
EBI(Electrons Beam Inspection)是半导体标准在线缺陷监测工具。 失效机制是通过EBI测特定缺陷的横截面来识别。暗电压对比(DVC)和亮电压对比(BVC)是电子束缺陷检测的两种类型。EBI检测以聚焦电子束为检测源,入射电子束激发出二次电子,然后对二次电子进行收集和分析捕捉到光学检查设备无法检测到的缺陷。例如,高深宽比导电结构在结构底部出现损伤或断裂,很难用光学暗场或明场仪器检测到,但该缺陷会影响入射电子的传输,所以会形成电压反差影像,从而检测到影响电性的各种缺陷。此外,由于检测源为电子束,检测结果不受某些表面物理性质例如颜色异常、厚度变化或前层缺陷的影响,还可用于检测很小的表面缺陷例如栅极刻蚀残留物等。在实际应用中,由于DVC信号具有明显的可检测性,验证DVC信号要比BVC容易得多;其次,由于短路方式的可能性太多,采用BVC信号分析失效模型非常困难。因此本文采用DVC的方式判断失效位置,再通过透射电镜(TEM)检查失效结构,并通过能量弥散X射线光谱仪(EDX)分析失效结构的元素特征,据此分析可能的失效原因。
-
在DVC(ASML HMI ESCAN 430)检测中,会将失效区域坐标点记录下来,如图1所示。对任意标记点做定点TEM切片分析后发现多晶硅沟道出现损伤,通过EDX确定多晶硅变性转化为氧化硅,如图2所示。其中以BTBAS为前驱体的氧化硅生长在多晶硅的外侧,部分多晶硅导电沟道受到破坏转变成氧化硅。且受损区域的多晶硅处于深孔结构的偏下部分,孔的上半部分以及顶端不会出现多晶硅损伤。
-
以BTBAS为前驱体的氧化硅生长过程中会产生的多种副产物,其中侧链胺基在氧气和射频等离子体作用下会产生碱性水合胺基产物[20-21],反应机理如图3所示。在dose步骤中,BTBAS与衬底的硅羟基发生亲核取代反应,前驱体通过Si—O键与衬底发生化学吸附反应,并释放第一个胺基;接下来的吹扫(purge)步骤中,未与衬底发生化学吸附的前驱体以及大部分胺基副产物会被purge出反应体系,但仍有少量会残留在体系中;最后再通入氧气并同时开启射频电源产生等离子体,完成成膜反应,硅羟基得以恢复,一次PEALD反应结束;再经过一步吹扫过程就可以进行下一步PEALD循环。在这一反应循环中残留的胺基会在氧气和等离子体作用下转变成NHx·H2O;在550℃反应体系中NHx·H2O会将多晶硅导电通道转化为氧化硅,从而被EBI DVC检测到。
-
为避免多晶硅沟道的氧化,结合PEALD特点与化学反应机理,本研究设计三种防范工艺:(1)PEALD循环开始前通入NF3作为抑制剂并同步开启射频等离子体。NF3在射频离子体作用下转变成氟自由基吸附在基底表面将部分Si—OH转变成Si—F,使得反应表面有效吸附位点(Si—OH)数量降低,从而使NHx.H2O的产生量相应减少,如图4所示;(2)采用单胺基的DIPAS替代双胺基的BTBAS作为反应前驱体,以减少purge步骤后胺基的残留;(3)在使用BTBAS作为前驱体的前提下,提高purge步骤的效率。
-
NF3抑制BTBAS吸附有两个控制维度,分别是通入时长和通入流量。如表2所示,绿色代表在此抑制强度下多晶硅导电沟道功能没有丧失,这说明通入NF3抑制BTBAS吸附以减少副产物NHx·H2O原理上可行。红色代表抑制强度不够。表中Base代表NF3通入时间和剂量的基础条件,其他条件是在此基础上做相应的增加。但需注意过度抑制会导致PEALD净生长速率缓慢,如图5所示,图中A,B的条件如表2中所标记,相比于无NF3条件,引入F越多GPC (Growth per cycle)越低,恢复GPC所用的ALD循环越久;且引入过量的氟可能会造成栅极和栅极氧化层受损,影响电性功能。
DIPAS替代BTBAS, DVC测量以及实际电性结果是满足功能要求的。图6说明前驱体中含有的胺基少对应的副产物NHx·H2O亦会减少。DIPAS分子量较小,具有较高的饱和蒸汽压(如表1所示),较低的分子空间位阻等优点,在550℃条件下以DIPAS为前驱体的PEALD的氧化硅的生长速率为1.9 Å /s,而BTBAS 只有0.77 Å /s。另外随着器件深宽比的增加,低位阻效应有助于分子更快地扩散入更深的结构中,确保台阶覆盖性不会因为分子大位阻受到抑制。
通过简单增加purge步骤的时长,抽速,导电沟道多晶硅损伤的问题并没有得到改善。对结构分析发现超高深宽比结构不利于副产物排出。目前采用的多段蚀刻来构造超高深宽比结构,这就必然出现横向尺寸突变的结构。如图7所示,该位置阻挡了反应副产物的排出,导致尺寸突变结构以下的多晶硅导电结构出现不可逆损伤,这与受损区域位于深孔偏下部分的现象吻合。因此需要对结构做相应的优化,确保副产物能够高效的从深孔下端排出。本实验通过偏移上部刻蚀的位置,分界处开口更小,更不利于副产物排出,做恶化实验,如图8所示,其他实验条件与对照组相同。DVC测量结果表明,这样的结构设计明显比对照组差,如图9所示,DVC异常区域的密度远大于图1。这说明多段蚀刻形成的横向尺寸突变结构不利于副产物排出,容易富集造成多晶硅材料的损伤。
-
在超高深宽比结构氧化硅填充中,硅烷基酰胺反应前驱体易对多晶硅导电沟道产生损伤。通过EBI、TEM、EDX等失效分析手段得知造成导电沟道多晶硅被氧化损伤的是硅烷基酰胺反应的副产物NHx·H2O。实验结果表明:NF3作为抑制剂可减少dose步骤前驱体的吸附量,保护多晶硅导电沟道,但过度抑制会导致PEALD净生长速率缓慢,且可能会影响器件的电性功能;超高深宽比结构中横向尺寸突变结构是造成多晶硅材料损伤的结构性原因。DIPAS不仅抑制了多晶硅导电沟道受损问题,而且沉积速率明显高于BTBAS,具有较大应用前景。
等离子体增强原子层沉积二氧化硅对多晶硅的损伤机理及防范工艺研究
The Mechanism and the Prevention of Plasma Enhanced Atomic Layer Deposition Induced Polysilicon Damage
-
摘要: 文章通过电子束检测(EBI)手段研究了等离子体增强原子层沉积(PEALD) SiO2过程中硅烷基酰胺类前驱体副产物对多晶硅产生不可逆损伤的机理。提出用单胺基硅烷基酰胺替代多胺基硅烷基酰胺作为前驱体,来减轻对多晶硅材料的损伤。在不损伤多晶硅前提下,进一步研究化学位阻较小的单胺基前驱体二异丙胺硅烷(DIPAS)对反应速率的影响。
-
关键词:
- 等离子体增强原子层沉积 /
- 硅烷基酰胺 /
- 氧化硅 /
- 二异丙胺硅烷(DIPAS)
Abstract: In this study, electron beam inspection (EBI) was used to investigate the mechanism of irreversible damage caused by by-products of the aminosilane precursors during the deposition of silicon oxide thin films with plasma enhanced atomic layer deposition (PEALD). It is proposed to replace polyamine based aminosilane with monoamine based aminosilane as precursors to reduce the damage to polysilicon materials. The effect of monoamine based diisopropylamine (DIPAS) precursors with small steric hindrance on the reaction rate of PEALD silicon oxide was studied without the damage of polysilicon. -

-
图 2 DVC异常点定点的TEM。EDX元素分析谱显示在红框区域导电通道多晶硅转化为氧化硅,红框上部的多晶硅未受损。 (a) TEM原图, (b)氧元素,(c) 硅元素
Figure 2. Fixed location TEM of DVC abnormal point. The conductive channel polysilicon conversion into silicon oxide proved by EDX element analysis spectrum, as shown in the red box, the upper part of the polysilicon is not damaged. (a) TEM original map, (b) spectrum of oxygen, (c) spectrum of silicon
图 4 NF3抑制示意图。(a)氟自由基吸附取代部分Si—OH转化为Si—F (1-4分别是阻挡层,电荷俘获层,隧穿层,导电沟道多晶硅),(b) Si—F抑制BTBAS吸附
Figure 4. Schematic diagram of NF3 inhibition. (a) Fluorine free radical adsorption replaces some Si—OH and transforms into Si—F(1-4 are the block layer, trap layer, tunnel layer and channel ploy, respectively), (b) Si—F inhibits BTBAS adsorption
表 1 常用的硅烷基酰胺前驱体基本信息
Table 1. Basic information on commonly used aminosilane precursors
NameCharacter DIPAS BDEAS BTBAS BDIPADS Structure formula 



Chemical formula C6H17NSi C8H22N2Si C8H22N2Si C12H32N2Si2 Molecular weight (g/mol) 131.30 174.36 174.36 260.57 Vapor pressure/Torr 70@50℃ 15.7@50℃ 7.0@50℃ 1.0@75℃ 表 2 NF3抑制条件与DVC关系图
Table 2. Relationship between NF3 inhibition conditions and DVC
NF3 flow /(mL/min) NF3 flow time/s Base Base
+0.01Base
+0.02Base
+0.03Base
+0.04Base
+0.05Base
+0.06Base
+0.07Base
+0.08······ Base
+0.20Base Base +3 Base +5 Base +10 Base +15 Base +20 A B Base +25 
-
[1] Klaus J W, George S M. Growth of SiO2 at room temperature with the use of catalyzed sequential half-reactions[J]. Science,1997,278(5345):1934−1936 doi: 10.1126/science.278.5345.1934 [2] Klaus J W, George S M. Atomic layer deposition of SiO2 at room temperature using NH3-catalyzed sequential surface reactions[J]. Surface Science,2000,447(1−3):81−90 doi: 10.1016/S0039-6028(99)01119-X [3] Du Y, George S M. SiO2 film growth at low temperatures by catalyzed atomic layer deposition in a viscous flow reactor[J]. Thin Solid Films,2005,491(1−2):43−53 doi: 10.1016/j.tsf.2005.05.051 [4] Kim D H, Lee H J, Jeong H, et al. Thermal atomic layer deposition of device-quality SiO2 thin films under 100°C using an aminodisilane precursor[J]. Chemistry of Materials,2019,31(15):5502−5508 doi: 10.1021/acs.chemmater.9b01107 [5] Maeng W J, Kim H. Thermal and plasma-enhanced ALD of Ta and Tioxide thin films from alkylamide precursors[J]. Electrochemical and Solid-State Letters,2006,9(6):191−194 doi: 10.1149/1.2186427 [6] Yang J H, Baek S B, Kim Y C. Initial surface reaction of di-isopropylaminosilane on a fully hydroxyl-terminated Si (001) surface[J]. Journal of Nanoscience and Nanotechnology,2014,14(10):7954−7960 doi: 10.1166/jnn.2014.9474 [7] Suzuki I, Dussarrat C, Yanagita K. Extra low-temperature SiO2 deposition using aminosilanes[J]. Ecs Transactions,2007,3(15):119−118 doi: 10.1149/1.2721480 [8] Baek S B, Kim D H, Kim Y C. Adsorption and surface reaction of bis-diethylaminosilane as a Si precursor on an OH-terminated Si (001) surface[J]. Applied surface science,2012,258(17):6341−6344 doi: 10.1016/j.apsusc.2012.03.033 [9] Burton B B, Kang S W, Rhee S W, et al. SiO2 atomic layer deposition using tris (dimethylamino) silane and hydrogen peroxide studied by in situ transmission FTIR spectroscopy[J]. The Journal of Physical Chemistry C,2009,113(19):8249−8257 doi: 10.1021/jp806638e [10] Jeong Y C, Baek S B, Kim D H, et al. Initial reaction of silicon precursors with a varying number of dimethylamino ligands on a hydroxyl-terminated silicon (001) surface[J]. Applied surface science,2013,280:207−211 doi: 10.1016/j.apsusc.2013.04.129 [11] Ferguson J D, Smith E R, Weimer A W, et al. ALD of SiO2 at room temperature using TEOS and H2O with NH3 as the catalyst[J]. Journal of The Electrochemical Society,2004,151(8):528−535 doi: 10.1149/1.1768548 [12] Lee W J, Han C H, Park J K, et al. Atomic layer deposition and properties of silicon oxide thin films using alternating exposures to SiH2Cl2 and O3[J]. Japanese Journal of Applied Physics,2010,49(7):01−04 [13] Lee J H, Kim U J, Han C H, et al. Investigation of silicon oxide thin films prepared by atomic layer deposition using SiH2Cl2 and O3 as the precursors[J]. Japanese journal of applied physics,2004,43(3A):328−330 doi: 10.1143/JJAP.43.L328 [14] Kang J K, Musgrave C B. Mechanism of atomic layer deposition of SiO2 on the silicon (100)-2×1 surface using SiCl4 and H2O as precursors[J]. Journal of applied physics,2002,91(5):3408−3414 doi: 10.1063/1.1436294 [15] George S M. Atomic layer deposition: an overview[J]. Chemical Review,2010,110(1):111−131 doi: 10.1021/cr900056b [16] Ding Y Y, Zhang Y C, Ren Y M, et al. Machine learning based modeling and operation for ALD SiO2 thin films using data from a multiscale CFD simulation[J]. Chemical Engineering Research and Design,2019,151:131−145 doi: 10.1016/j.cherd.2019.09.005 [17] Huang L, Han B. Density functional theory study on the full ALD process of silicon nitride thin film deposition via BDEAS or BTBAS and NH3[J]. Physical Chemistry Chemical Physics,2014,16(34):18501−18512 doi: 10.1039/C4CP02741H [18] Nam T, Lee H, Choi T, et al. Low-temperature, high-growth-rate ALD of SiO2 using aminodisilane precursor[J]. Applied Surface Science,2019,485:381−390 doi: 10.1016/j.apsusc.2019.03.227 [19] Musgrave C B, Gordon R G. Precursors for atomic layer deposition of high-k dielectrics[J]. Future Fab International,2005,18:126−128 [20] De V, Glen A. Kinetics and mechanisms of nitrate and ammonium formation during ozonation of dissolved organic nitrogen[J]. Water Research,2017,108(16):451−461 [21] Lim s, Mcardell C S, Gunten U V. Relations of aliphatic amines with ozone: Kinetics and mechanisms[J]. Water Research,2019,157(15):514−528 -


 首页
首页 登录
登录 注册
注册



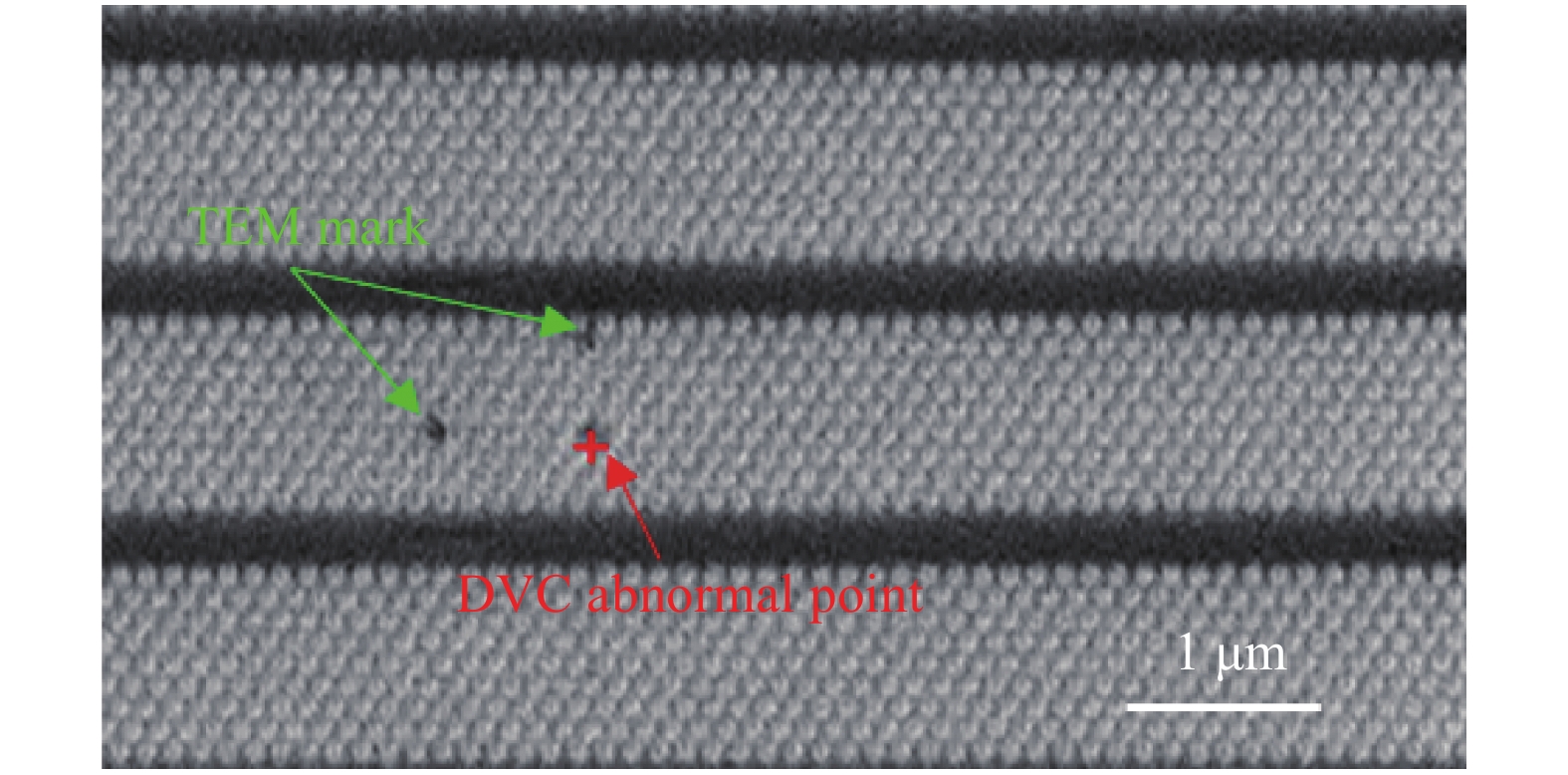
 下载:
下载: