-
氧化镓(Ga2O3)作为一种典型的宽禁带半导体材料,具有宽的禁带宽度(约为4.6-5.2 eV)、高的理论击穿场强(8 MV/cm)、耐高温、抗辐照、稳定性高以及成本低等优点,成为制备高功率电子器件的优选材料[1-3]。此外,Ga2O3材料的吸收截止边位于日盲紫外区域,近紫外透过率超过80%,在“日盲”紫外探测器的研究中具有优异的发展前景[4-6]。
MOCVD由于其生长速度快,薄膜质量高,可重复性好及有望进行大规模生产而成为最适合产业化生产的外延生长技术。目前,基于MOCVD进行的Ga2O3薄膜异质和同质外延研究已经受到了广泛关注[7-11]。异质外延生长(例如蓝宝石衬底上)的Ga2O3薄膜,由于薄膜与衬底存在大的晶格失配,导致生长的Ga2O3薄膜质量低且具有高的缺陷密度[12-13]。随着Ga2O3衬底工艺的进展,目前已经可以通过传统的熔体生长技术,生产大尺寸高晶体质量的单晶衬底,为Ga2O3同质外延研究提供保障[14-16]。
近年来,基于MOCVD的Ga2O3同质外延薄膜的研究已经有不少人展开工作[8, 17-19]。虽然目前MOCVD同质外延的Ga2O3薄膜质量有很大提升,但是关于MOCVD同质外延Ga2O3薄膜的制备环境,例如生长温度、压强以及腔体清洁程度对于薄膜性质的影响仍不明晰,相关的系统性研究仍然较少。因此,本工作将利用Fe掺(010)Ga2O3衬底对MOCVD同质外延薄膜进行系统性研究。主要针对外延生长的重要参数,例如生长温度和生长压强,研究其对外延薄膜表面形貌,晶体质量以及电学特性等的影响,为高质量的外延薄膜生长提供参数指导,进一步地为基于MOCVD外延技术的高性能器件制备奠定基础。
-
本实验使用的MOCVD设备是在Agnitron公司定制设计制造的,专门用于对氧化物材料进行外延生长研究,包括Ga2O3,AlGaO和InGaO薄膜。同质外延生长的衬底片为(010)晶面的Fe掺半绝缘Ga2O3衬底。MOCVD的金属有机源采用三乙基镓(TEGa),用以获得高质量的外延薄膜。另外一种参与的反应源为高纯氧气(6N),与金属有机源发生化学反应生成Ga2O3薄膜。高纯氩气(N)用作金属有机源的载气,负责将有机源从源瓶携带至反应腔室。高纯氮气(6N)用于吹扫管道和腔室。生长过程中需要设置的参数众多,参数的设置遵循了控制变量法,实验中设置的工艺参数如表1所示。
薄膜生长工艺流程如下:
(1)衬底清洗:将(010)面单晶衬底先依次在丙酮,异丙醇溶液中超声清洗2 min,之后用去离子水冲洗干净,氮气枪吹干。超声频率不易过大,时间也不能过长,否则容易造成衬底片的裂解。有机溶液清洗之后将衬底片依次在食人鱼(H2SO4+H2O2 3:1)溶液中浸泡15 min,BOE溶液中浸泡30 min,去离子水冲洗数次,氮气枪吹干。将清洗后的衬底放入石墨盘中并经传送腔放入手套箱中保存。
(2)设备开启:设置源瓶水浴温度,开启所有加热线,确保相应气瓶阀门正常开启。检查热交换机,真空泵等是否开启。
(3)送样:在软件界面运行破真空程序,将样品放入反应腔室,盖上腔盖后运行抽真空程序。在运行这些程序时,利用高纯氮气反复抽充5次,保证腔体干净并使腔体处于高真空状态。
(4)运行生长程序:编写生长程序,确认参数后运行程序。
(5)材料生长:打开源瓶手阀,运行过程中石墨盘的转速为60 r/min,生长过程中温度分段式上升。
(6)结束生长取样:生长结束后待加热温度降至70℃以下,运行破真空操作。因为反应后腔体中会有残留尾气,因此会进行多次抽气充气操作以排除残留物。在腔体回到大气压状态后取出样品,之后再次对腔体抽真空,使之维持在高真空状态。
(7)设备关闭:最后关闭源瓶水浴,关闭加热线,以及热交换机等,设备进入待机状态。
-
在进行MOCVD的外延生长之前,腔体清洁是非常重要的一步。实验中常用的清洁方式是利用高温长时间烘烤腔体,称之为“bake腔体”。烘烤温度设置为860℃,烘烤时间为0.5-2 h,具体时间视腔体情况而定。在bake的过程中,将石墨盘放入腔体中一起清洁。图1所示是腔体清洁前后外延生长的薄膜表面,可以清楚看到清洁前生长的薄膜表面布满颗粒,光学显微镜下薄膜表面粗糙,类似于磨砂面,这毫无疑问会影响基于此外延薄膜制备的器件性能。而在bake腔体之后外延薄膜表面非常光滑,薄膜表面的清洁程度与送进腔体之前的衬底表面基本没有区别。若腔体环境特别恶劣,即bake腔体作用效果不明显时则会选择开腔处理,用酒精仔细擦拭腔体内部。保持腔体的清洁十分必要,高度清洁的薄膜表面对于高性能器件的制备具有重要的意义。
-
采用光学显微镜、原子力显微镜(AFM)、扫描电子显微镜(SEM)、X射线衍射(XRD)以及物性综合测量系统(PPMS),分别对MOCVD同质外延Ga2O3薄膜进行表面形貌、截面、晶体结构与质量以及电学特性的表征。
-
腔室生长温度是外延薄膜质量重要的影响因素,其直接影响了薄膜的形貌、晶体结构和载流子迁移率。因此,本实验首先研究了不同生长温度对外延生长Ga2O3单晶薄膜的影响,衬底温度分别设置为730℃、780℃、830℃和880℃,生长压强固定为60 Torr。
(1) 生长温度对β-Ga2O3薄膜生长速率的影响
由于同质外延晶格匹配度高,薄膜界面区分不明显,因此本文采用与同质外延样品同一批生长的蓝宝石异质外延薄膜的厚度近似表示同质外延薄膜的厚度,很多相关工作也采用了同样的表征手段[20]。通过SEM对截面的表征可以获得异质外延薄膜的厚度信息,再结合薄膜生长时间即可计算不同生长温度下薄膜的生长速率。图2为各个生长温度下SEM对蓝宝石衬底上外延薄膜截面的表征结果,可以看到外延薄膜和衬底的明显界面。图3所示是外延的β-Ga2O3薄膜在生长温度为730℃-880℃变化范围内生长速率曲线。由图可以看出外延薄膜生长速率随着生长温度的增加而略微增加,但是总体变化不大。这样的生长速率与衬底温度的依赖关系也与其他工作的发现一致[8],即反应速率对衬底温度的依赖关系不大。
(2) 生长温度对β-Ga2O3薄膜表面形貌的影响
β-Ga2O3外延薄膜的表面形貌对衬底温度有着强烈的依赖关系。图4展示了不同生长温度下外延薄膜的AFM表面形貌,扫描范围为5 μm×5 μm,插图是三维形貌图,生长温度分别为730℃、780℃、830℃和880℃。可以看出,在780℃-880℃的温度变化范围内,主导的薄膜表面形貌为沿着[001]晶向生长的细长的柱状晶粒,三维结构图则更为清晰的展示出薄膜生长的特征。并且随着生长温度的增加,在β-Ga2O3表面上吸附原子的扩散长度在[001]方向上显著增强。这些薄膜呈现出阶梯束(step bunching)的生长方式,这在其他的MBE和MOCVD的生长工作中都有观测到类似的结果[9, 21]。但是当生长温度过低时(比如730℃),薄膜表面形貌明显变差,薄膜表面的晶体取向性弱化较多。这可能是温度太低不利于反应原子在衬底表面的迁移,导致反应原子的扩散长度不够难以到达衬底表面的阶梯处,从而难以形成step bunching的生长方式。随着衬底生长温度的增加,外延薄膜的表面粗糙度分别为1.09、1.26、1.82和2.06 nm。薄膜表面的粗糙度呈轻微变大的趋势,这可能与生长速率的略微增加有关,更为直观的原因则可能是高温下生长薄膜的晶粒尺寸在变大。
(3) 生长温度对β-Ga2O3薄膜晶体质量的影响
不同生长温度下β-Ga2O3薄膜的晶体质量可利用XRD进行表征。如图5(a)所示,是不同生长温度下β-Ga2O3薄膜以及衬底的典型θ-2θ扫描图谱,扫描范围为10°-70°。从图中可以看出各个生长温度下β-Ga2O3薄膜和衬底只在60.9°位置存在一个衍射峰,通过和标准比色卡对比发现这个峰位对应于β-Ga2O3薄膜的(020)晶面衍射峰。并且在衍射谱大的扫描范围内所有的衍射峰都在(020)峰位,没有观察到其他相(α,γ,δ和ε)的出现,这说明了在(010)半绝缘衬底上生长的薄膜是纯β相单晶薄膜。值得注意的是,由于薄膜是同质外延生长,在XRD的测量中β-Ga2O3薄膜的信号和衬底的信号是不容易区分的,这种薄膜和衬底信号的重叠恰好也证实了优异外延生长的实现。类似于之前的工作,在XRD测试曲线中也出现了肩峰[22]。和衬底峰类似,在较低生长温度(730℃和780℃)下生长的β-Ga2O3薄膜没有肩峰的出现,表明衬底和低温生长下的外延薄膜在(020)平面不存在应变。当增加衬底生长温度至830℃和880℃时,外延的β-Ga2O3薄膜相对于衬底峰在其左侧出现了肩峰,表明此温度下生长的薄膜存在着(020)面内的压缩应变。
为了进一步表征不同生长温度下外延薄膜的质量,进行了XRD摇摆曲线测试,如图5(b)所示。从XRD的摇摆曲线中分析半高宽(FWHM)的值可以获得薄膜的晶体质量信息,通常情况下半高宽值越小代表薄膜质量越好。如图5(b)所示,衬底的半高宽为75.6 arcsec,730℃、780℃、830℃和880℃下外延薄膜的半高宽分别为114.9 arcsec、136.3 arcsec、45.7 arcsec和64.8 arcsec。可以看到薄膜的半高宽随着温度增加先增大后减小,830℃和880℃条件下薄膜的半高宽低于衬底,可能是高温条件下有利于反应粒子的横向迁移。XRD测试结果表明高质量的Ga2O3同质外延薄膜可以通过调控MOCVD的生长温度获得。
(4) 生长温度对β-Ga2O3薄膜电学特性的影响
电学特性表征是MOCVD外延薄膜表征中的重要环节,其直接决定了生长的薄膜是否适用于器件的制备,外延薄膜的电学特性在很大程度上决定了器件性能。我们采用范德堡结构对不同生长温度下β-Ga2O3薄膜的电学特性进行测试。不同生长温度下外延β-Ga2O3薄膜的室温电子迁移率与载流子浓度的依赖关系如图6所示。730℃、780℃、830℃和880℃下的载流子浓度分别为4.47×1017 cm−3、2.21×1017 cm−3、3.34×1017 cm−3和1.44×1017 cm−3,室温电子迁移率分别为62.16,76,68.91和67.47 cm2/Vs。一般情况下随着载流子浓度的增加,电离杂质散射会增强,从而导致迁移率下降,即电子迁移率和载流子浓度呈负相关关系。由图6(a)可以看到730℃,780℃和830℃的样品中,呈现出很好的接近线性的关系,而880℃的样品在载流子浓度低的情况下迁移率仍然很低,说明生长温度过高可能不利于MOCVD薄膜的生长。
为了更直观的评估生长温度对载流子浓度和迁移率的影响,绘制了如图6(b)所示的关系图。从图中可以看出,载流子浓度随着生长温度的增加总体上有略微减小的趋势,但是并没有数量级上的变化。考虑到每次实验腔体环境的差异性等不确定性因素,该结果说明生长的Ga2O3薄膜载流子浓度和生长温度没有明显的依赖关系。Feng等[8]也报道过相似的实验结果。
-
在MOCVD的外延生长中,反应腔体的压强是β-Ga2O3薄膜外延的重要控制参数,因此本实验在研究衬底温度的基础上继续对生长压强的影响进行了探索。实验中设置了不同的腔体压强20,40,60和80 Torr,研究了其对外延β-Ga2O3薄膜生长速率,表面形貌,晶体质量以及电学特性的影响。为了保证单一变量,薄膜生长工艺保持一致,除腔体压强外的其他工艺参数仍按照表1的设定值,且生长温度固定为830℃。
(1) 生长压强对β-Ga2O3薄膜生长速率的影响
测试了不同生长压强下外延β-Ga2O3薄膜的生长速率,测试方法和研究衬底生长温度时一致,通过利用同批生长的蓝宝石异质外延截面的厚度,推算出由(010)半绝缘衬底同质外延的β-Ga2O3薄膜的生长速率。如图7所示是各个腔体压强下蓝宝石衬底上外延薄膜的SEM截面图,可以看出外延薄膜和蓝宝石衬底界面非常清晰。在20、40、60和80 Torr的生长压强下薄膜的厚度分别为407、360、300和264 nm,生长时间均为30 min,计算出的生长速率分别为13.57、12、10、8.8 nm/min。
生长速率与压强的变化关系如图8所示,薄膜生长速率随着腔体压强的增加接近线性下降,且变化幅度较大,这与其他的研究结果相吻合[8, 23]。生长速率下降的原因可归因于:(1)从气相扩散至生长表面的前驱体源减少;(2)生长压强的增加会放大吉布斯自由能的变化,导致更剧烈的气相反应,镓源和氧源的耗尽导致了外延生长速率的下降[24]。
(2) 生长压强对β-Ga2O3薄膜表面形貌的影响
如图9所示为不同生长压强下β-Ga2O3薄膜的AFM表面形貌图,插图是对应的三维结构图,扫描范围为5 μm×5 μm,分别对应20、40、60和80 Torr的生长压强。从AFM形貌中可以看出在40-80 Torr生长压强范围内β-Ga2O3薄膜表面均展示出沿[001]晶向生长的细长的柱状晶粒,且晶粒尺寸没有明显的变化。但是当生长压强低至20 Torr时表面的晶粒界限变得模糊。随着生长压强的增加,各个薄膜表面粗糙度(RMS)分别为0.53,1.62,1.82和1.70nm。薄膜表面的粗糙度和生长压强并未显示出明显的依赖关系。此外,薄膜粗糙度与其他MOCVD生长报道的值相当[8, 20],略微大于MBE外延薄膜的粗糙度,这可能与我们的薄膜生长速率较大有关。
(3) 生长压强对β-Ga2O3薄膜晶体质量的影响
利用XRD对不同生长压强下的β-Ga2O3薄膜进行了晶体质量的表征,如图10(a)所示为各个生长压强条件下的薄膜以及衬底的XRD典型扫描图谱θ-2θ扫描,扫描范围为10°-70°。从图中可以看到,在整个扫描谱中薄膜和衬底都只能观察到一个衍射峰,该峰位位于60.9°附近,对应于β-Ga2O3薄膜的(020)晶面衍射峰,表明在各个生长压强下的β-Ga2O3薄膜都是同质外延生长,形成了与衬底一致的β相单晶薄膜。为了能够观察图谱的细节变化,我们将峰位附近的图谱放大,可以看到在60 Torr生长条件下出现了肩峰,说明此条件下生长的薄膜在生长过程中存在着应变,不过这种应变可能存在偶然性,并且通过工艺的优化可以消除。
为了获得各个生长压强条件下的半高宽信息,我们将XRD摇摆曲线扫描中的参数ω固定在30.45°,然后在正负方向扫描0.5°进行XRD的摇摆曲线测试,测试结果如图10(b)所示。经过计算,衬底、20 Torr、40 Torr、60 Torr和80 Torr的半高宽分别为75.6 arcsec、104.4 arcsec、79.2 arcsec、45.7 arcsec和57.6 arcsec。可以看到60和80 Torr条件下生长的薄膜半高宽低于衬底,且在研究的压强范围内可以获得多个高品质的Ga2O3外延薄膜。这说明了MOCVD可以在多个生长压强的条件下获得高晶体质量的薄膜,极大降低了生长难度。
(4) 生长压强对β-Ga2O3薄膜电学特性的影响
通过范德堡结构测试了不同生长压强下β-Ga2O3薄膜的载流子浓度和迁移率。如图11(a)所示,展示了各个生长压强条件下薄膜电子迁移率与载流子浓度的依赖关系。其中,20 Torr、40 Torr、60 Torr和80 Torr下的载流子浓度分别为4.41×1017 cm−3、3.44×1017 cm−3、3.34×1017 cm−3和3.67×1017 cm−3,室温电子迁移率分别为41.58 cm2/Vs,47.1 cm2/Vs,68.91 cm2/Vs和51.41 cm2/Vs。由图中可以看出薄膜的载流子浓度和迁移率一定程度上遵循着负相关关系,然而40 Torr条件下生长的样品出现了轻微的偏离。
为了更直观的显示外延生长的Ga2O3薄膜的电学性质与生长压强的依赖关系,绘制了11(b)所示的关系图。可以看到,在所研究的生长压强变化范围内载流子浓度基本没有变化,其中,60 Torr生长压强下的薄膜迁移率最高。
-
通过MOCVD外延技术,利用(010)Fe掺半绝缘Ga2O3衬底进行同质外延薄膜生长,系统地研究了不同生长温度和生长压强对外延薄膜的影响。结果表明生长的薄膜表面形貌光滑,粗糙度均在1-2 nm之间;在研究的生长温度和压强范围内,830 ℃和60 Torr条件下薄膜的半高宽达到最低值且低于衬底,获得了高晶体质量的外延薄膜;电学特性测试结果表明,薄膜的迁移率与载流子浓度呈接近线性的负相关关系,且在830 ℃和60 Torr时具备良好的迁移率。综合结果表明,最优的生长条件为830 ℃、60 Torr。本文为高质量Ga2O3材料的同质外延生长提供了经验和参数指导,也为制备与实现高性能器件奠定了基础。
MOCVD同质外延生长的单晶β-Ga2O3薄膜研究
Study on Single Crystal β-Ga2O3 Thin Films Grown by MOCVD Homoepitaxy
-
摘要: 采用金属有机化学气相沉积(MOCVD)技术,在(010)Fe掺Ga2O3半绝缘衬底上进行同质外延生长Ga2O3薄膜,系统性地研究了生长温度(880℃/830℃/780℃/730℃)和生长压强(80/60/40/20 Torr)对外延薄膜表面形貌、晶体质量以及电学特性等的影响。结果表明随着生长温度和压强的增加:薄膜生长速率分别呈现出略微增加和大幅下降的趋势;薄膜表面阶梯束(step bunching)的生长方式逐渐增强,并且呈现出沿着[001]晶向生长的柱状晶粒;高分辨X射线衍射(XRD)扫描显示薄膜均只在(020)面存在衍射峰,表明生长的薄膜为纯β相单晶薄膜,且半高宽可达到45.7 arcsec;霍尔测试表明780℃和60 Torr的生长条件下薄膜的室温电子迁移率最高。本文为基于MOCVD的Ga2O3同质外延生长提供了系统的参数指导,为高质量Ga2O3薄膜的制备奠定了基础。Abstract: Ga2O3 films were homoepitaxy grown on Fe-doped Ga2O3 (010) semi-insulating substrate by metal-organic chemical vapor deposition (MOCVD). The effects of chamber temperature (880/830/780/730℃) and pressure (80/60/40/20 Torr) on the surface morphology, crystal quality and electrical properties of epitaxial films were systematically investigated. The results show that with the increasement of the growth temperature and pressure, the growth rate of the films increases slightly and decreases dramatically, respectively; The growth pattern of step bunching on the surface of the films is gradually enhanced, and the morphology is dominated by elongated grains oriented along the [001] direction; High resolution X-ray diffraction (XRD) scanning shows that only diffraction peaks exist on (020) plane, which indicates that the films are pure β-phase single crystal, and the full width at half maximum can reach 45.7 arcsec; Hall test shows that the film has the highest room temperature electron mobility under the growth conditions of 780℃ and 60 Torr, respectively. This paper provides a systematic parameter guidance for the homoepitaxy growth of Ga2O3 based on MOCVD, and lays a foundation for the preparation of high-quality Ga2O3 films.
-
Key words:
- Ga2O3 /
- MOCVD /
- Homoepitaxy /
- Growth temperature /
- Growth pressure .
-

-
图 6 (a)不同生长温度下β-Ga2O3外延薄膜室温电子迁移率与载流子浓度的依赖关系,(b)β-Ga2O3外延薄膜的载流子浓度和迁移率与生长温度的依赖关系
Figure 6. (a) Dependence of electron mobility at room temperature and carrier concentration of β-Ga2O3 epitaxial films at different growth temperatures, (b) Dependence of carrier concentration and mobility of β-Ga2O3 epitaxial films on growth temperature
图 11 (a)不同生长压强下β-Ga2O3薄膜的室温迁移率与载流子浓度的依赖关系,(b)载流子浓度和迁移率与生长压强的依赖关系
Figure 11. (a) Dependence of electron mobility at room temperature and carrier concentration of β-Ga2O3 epitaxial films at different growth pressures, (b) Dependence of carrier concentration and mobility of β-Ga2O3 epitaxial films on growth pressure
表 1 MOCVD外延生长工艺参数
Table 1. Process parameters in MOCVD epitaxial growth
工艺参数 设定值 生长温度/℃ 880/830/780/730 生长压强/Torr 80/60/40/20 电机转速/(r/min) 60 氧气流量/(mL/min) 1000 TEGa流量/(mL/min) 70 镓源水浴温度/℃ 20 生长时间/min 30 -
[1] Pearton S J,Yang J,Cary P H,et al. A review of Ga2O3 materials, processing, and devices[J]. Applied Physics Reviews,2018,5:011301 doi: 10.1063/1.5006941 [2] Higashiwaki M,Sasaki K,Murakami H,et al. Recent progress in Ga2O3 power devices[J]. Semiconductor Science and Technology,2016,31:034001 doi: 10.1088/0268-1242/31/3/034001 [3] Mastro M A,Kuramata A,Calkins J,et al. Perspective—opportunities and future directions for Ga2O3[J]. ECS Journal of Solid State Science and Technology,2017,6:P356 doi: 10.1149/2.0031707jss [4] Hou X H,Zou Y N,Ding M F,et al. Review of polymorphous Ga2O3 materials and their solar-blind photodetector applications[J]. Journal of Physics D:Applied Physics,2020,54:043001 [5] Kong W Y,Wu G A,Wang K Y,et al. Graphene-β-Ga2O3 heterojunction for highly sensitive deep UV photodetector application[J]. Advanced Materials,2016,28:10725−10731 doi: 10.1002/adma.201604049 [6] Lee S H,Kim S B,Moon Y-J,et al. High-responsivity deep-ultraviolet-selective photodetectors using ultrathin gallium oxide films[J]. Acs Photonics,2017,4:2937−2943 doi: 10.1021/acsphotonics.7b01054 [7] Du X J,Li Z,Luan C N,et al. Preparation and characterization of Sn-doped β-Ga2O3 homoepitaxial films by MOCVD[J]. Journal of Materials Science,2015,50:3252−3257 doi: 10.1007/s10853-015-8893-4 [8] Feng Z X,Anhar Uddin Bhuiyan A,Karim M R,et al. MOCVD homoepitaxy of Si-doped (010) β-Ga2O3 thin films with superior transport properties[J]. Applied Physics Letters,2019,114:250601 doi: 10.1063/1.5109678 [9] Baldini M,Albrecht M,Fiedler A,et al. Si-and Sn-doped homoepitaxial β-Ga2O3 layers grown by MOVPE on (010)-oriented substrates[J]. ECS Journal of Solid State Science and Technology,2016,6:Q3040 [10] Boschi F,Bosi M,Berzina T,et al. Hetero-epitaxy of ε-Ga2O3 layers by MOCVD and ALD[J]. Journal of Crystal Growth,2016,443:25−30 doi: 10.1016/j.jcrysgro.2016.03.013 [11] Sun H D,Li K-H,Castanedo C. T, et al. HCl Flow-induced phase change of α-, β-, and ε-Ga2O3 films grown by MOCVD[J]. Crystal Growth & Design,2018,18:2370−2376 [12] Tadjer M J,Mastro M A,Mahadik N A,et al. Structural, optical, and electrical characterization of monoclinic β-Ga2O3 grown by MOVPE on sapphire substrates[J]. Journal of Electronic Materials,2016,45:2031−2037 doi: 10.1007/s11664-016-4346-3 [13] Kjapsna A,Dimitrocenko L,Tale I,et al. Characterization of crystalline structure and morphology of Ga2O3 thin film grown by MOCVD technique[J]. Key Engineering Materials,2016,721:253−257 doi: 10.4028/www.scientific.net/KEM.721.253 [14] Zhang S N,Lian X Z,Ma Y C,et al. Growth and characterization of 2-Inch high quality β-Ga2O3 single crystals grown by EFG method[J]. Journal of Semiconductors,2018,39:083003 doi: 10.1088/1674-4926/39/8/083003 [15] Hoshikawa K,Kobayashi T,Matsuki Y,et al. 2-Inch diameter (100) β-Ga2O3 crystal growth by the vertical bridgman technique in a resistance heating furnace in ambient air[J]. Journal of Crystal Growth,2020,545:125724 doi: 10.1016/j.jcrysgro.2020.125724 [16] Tomm Y,Reiche P,Klimm D,et al. Czochralski grown Ga2O3 crystals[J]. Journal of crystal growth,2000,220:510−514 doi: 10.1016/S0022-0248(00)00851-4 [17] Seryogin G,Alema F,Valente N,et al. MOCVD growth of high purity Ga2O3 epitaxial films using trimethylgallium precursor[J]. Applied Physics Letters,2020,117:262101 doi: 10.1063/5.0031484 [18] Anooz S B,Grüneberg R,Chou T,et al. Impact of chamber pressure and Si-doping on the surface morphology and electrical properties of homoepitaxial (100) β-Ga2O3 thin films grown by MOVPE[J]. Journal of Physics D:Applied Physics,2020,54:034003 [19] Wagner G,Baldini M,Gogova D,et al. Homoepitaxial growth of β‐Ga2O3 layers by metal‐organic vapor phase epitaxy[J]. physica status solidi (a),2014,211:27−33 doi: 10.1002/pssa.201330092 [20] Alema F,Zhang Y,Osinsky A,et al. Low temperature electron mobility exceeding 104 cm2/V s in MOCVD grown β-Ga2O3[J]. APL Materials,2019,7:121110 doi: 10.1063/1.5132954 [21] Sasaki K,Higashiwaki M,Kuramata A,et al. Growth temperature dependences of structural and electrical properties of Ga2O3 epitaxial films grown on β-Ga2O3 (010) substrates by molecular beam epitaxy[J]. Journal of Crystal Growth,2014,392:30−33 doi: 10.1016/j.jcrysgro.2014.02.002 [22] Leedy K D,Chabak K D,Vasilyev V,et al. Highly conductive homoepitaxial Si-doped Ga2O3 films on (010) β-Ga2O3 by pulsed laser deposition[J]. Applied Physics Letters,2017,111:012103 doi: 10.1063/1.4991363 [23] Alema F,Hertog B,Osinsky A,et al. Fast growth rate of epitaxial β-Ga2O3 by close coupled showerhead MOCVD[J]. Journal of Crystal Growth,2017,475:77−82 doi: 10.1016/j.jcrysgro.2017.06.001 [24] Chen Y P,Liang H W,Xia X C,et al. Effect of growth pressure on the characteristics of β-Ga2O3 films grown on GaAs (100) substrates by MOCVD method[J]. Applied Surface Science,2015,325:258−261 doi: 10.1016/j.apsusc.2014.11.074 -


 首页
首页 登录
登录 注册
注册



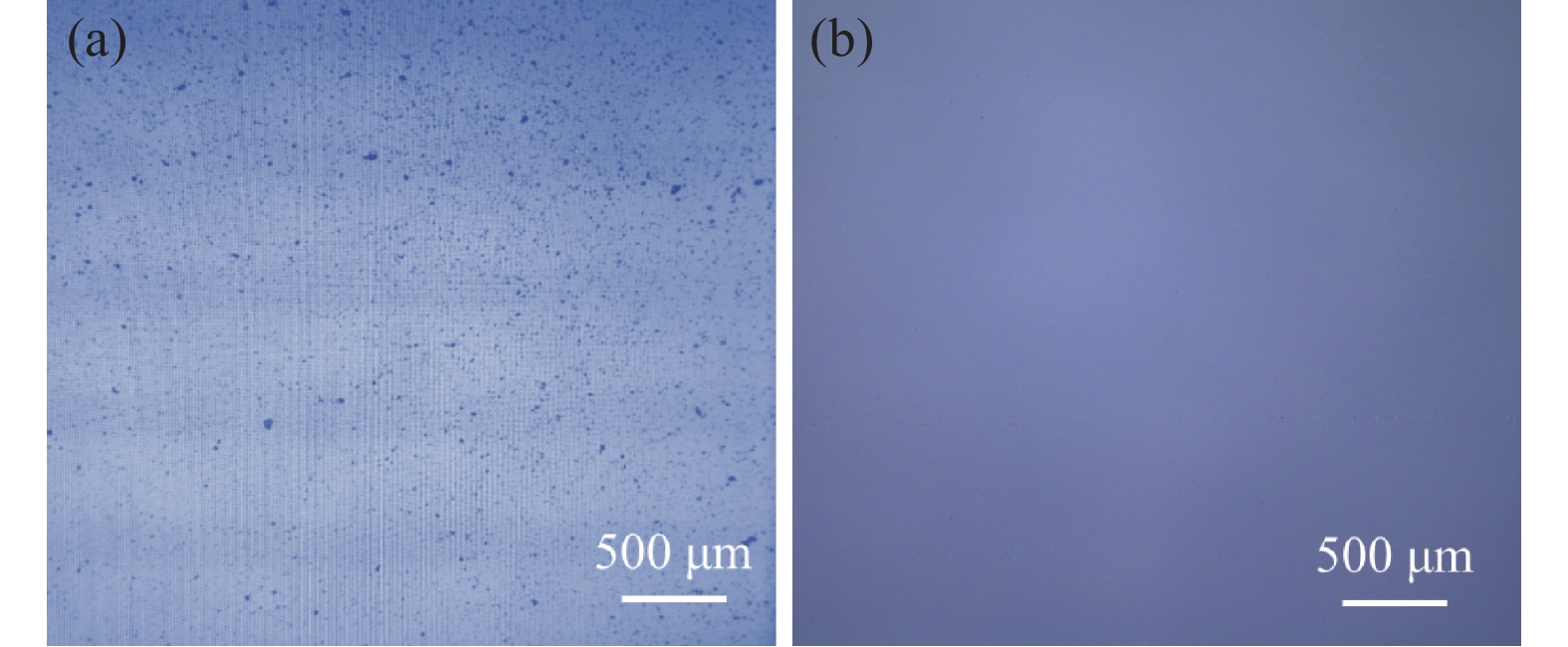
 下载:
下载: