-
本征非晶硅钝化薄膜能很好的钝化晶硅表面[1-2],松下公司利用在晶体硅与掺杂层之间插入一层本征氢化非晶硅(i-a-Si:H)制作的HIT太阳电池(Heterojunction with intrinsic thin layer)获得了良好的转换效率[3-4],该公司网站报道插入i-a-Si:H是太阳电池高转换效率三大核心技术之一[5]。i-a-Si:H的沉积方式主要有PECVD(等离子体增强化学气相沉积)和HWCVD(热丝化学气相沉积),相比较于HWCVD,PECVD由于是利用辉光放电等离子体使得组成薄膜气态物质发生化学反应,从而得到薄膜材料的一种沉积技术,通过反应气体放电沉积薄膜,很好的利用了非平衡等离子体的反应特点[6],因而应用更为广泛与成熟, Stree R A等[7]研究了PECVD法沉积i-a-Si:H薄膜的工艺及有关钝化机理。随着钝化材料研究的深入,人们发现除了本征氢化非晶硅(i-a-Si:H),本征氢化非晶氧化硅(i-a-SiOx:H)也能较好的钝化硅片表面,a-Si:H/c-Si中插入i-a-SiOx:H有利于提高太阳电池效率,而且i-a-SiOx:H具有PECVD技术低温沉积、带隙较宽致蓝光区吸收减小、工艺窗口较大方便制备等优点[6,8-10],钝化后的硅片少子寿命可达14.2 ms,但工艺与所使用制备仪器紧密相关,为在本实验室探索较高转换效率的a-Si:H/c-Si异质结太阳电池,本文在前期研究基础上,研究PECVD法制备i-a-SiOx:H薄膜钝化性能随沉积衬底温度的影响,采用微波光电导(MW-PCD)和射频光电导(RF-PCD)两种方法测试硅片少子寿命,光谱型椭偏仪检验薄膜样品的晶型。
-
本实验衬底材料为n型直拉单晶硅片(n-Cz-Si),晶向为(100),厚约180 μm,大小是40 mm×40 mm;硅片经激光切割机切割后,经RCA清洗法清洗[11-12],沉积设备为国产北京创世威科技有限公司生产的HW-PECVD-1E型设备;采用射频光电导(R F-PCE,仪器型号WCT-120)与微波光电导(MW-PCD,仪器型号WT-2000PV)测试硅片少子寿命,RF-PCD测试结果能直接反应钝化效果,MW-PCD测试结果则体现硅片整体钝化性能是否均匀,椭偏仪为匈牙利Semilab公司生产的GES5-E。除衬底温度外,气体其他工艺参数如下[13]:功率12 W,气压22 Pa,流量比SiH4:H2:CO2=3:15:0.6 mL/min,沉积时间10 min,衬底温度分别取值25℃(室温)、100℃、180℃、200℃、220℃、250℃。
-
图1为WCT-120法测出的室温(25℃)沉积i-a-SiOx:H后硅片少子寿命结果,本次实验共有6个硅片,图1(a)是所有样品少子寿命随注入浓度 的结果(MW-PCD测试法),图1(b)为注入浓度1×1015 cm−3硅片的少子寿命。
图1可知,不加热n-Cz-Si表面沉积i-a-SiOx:H作为钝化材料对硅片钝化效果不理想,这应该是室温(25℃)沉积i-a-SiOx:H不能较好的钝化硅片悬挂键,与25℃沉积氢化非晶硅i-a-Si:H钝化性能不优相似。从图1(a)还可以显著得知,少子寿命随注入浓度增加减小明显,这应该理解为硅片沉积i-a-SiOx:H后仍存在相当数量的空位和其他缺陷,注入浓度为1×1015 cm−3时,少子寿命在1~2 μs之间,说明室温沉积i-a-SiOx:H钝化n-Cz-Si效果不理想。
图2为椭偏仪测的室温条件下双面沉积i-a- SiOx:H膜后n-Cz-Si的介电常数实部与虚部。
图2中介电常数实部(ε1)与虚部(ε2)特征峰与非晶硅介电常数特征峰吻合度高,说明沉积的薄膜确属非晶相[14-15]。为获得较好钝化性能的i-a-SiOx:H膜,研究沉积衬底温度对i-a-SiOx:H钝化性能的影响,继续不同衬底温度沉积i-a-SiOx: H膜实验,测的少子寿命结果如图3所示,本批实验3个硅片。
图3为1号位置硅片不同衬底温度n-Cz-Si双面沉积i-a-SiOx:H膜后的少子寿命结果,少子寿命测试结果表明i-a-SiOx:H钝化性能与沉积衬底温度关系密切,温度为100℃以下时硅片少子寿命少于10 μs,钝化效果不太理想,这可理解为温度低对SiH4热分解不利,难于钝化悬挂键,文献[16-17]得知,SiH4热分解及反应过程,会产生硅原子和氢原子,分解出来的和H2中的氢原子会让硅片中悬挂键得到补偿,起到钝化硅片的作用。从图3还得知,硅片少子寿命随衬底温度升高,出现先增大然后减少的变化趋势,220℃时达最大为747 μs (注入浓度1×1015 cm−3)。3个硅片注入浓度均取为1×1015 cm−3,少子寿命结果如图4。3个硅片少子寿命随沉积温度变化趋势一致,最优温度在200℃~220℃(不同位置略有不同),说明本实验设备及气体沉积工艺参数条件下,PECVD法沉积i-a-SiOx:H衬底温度可设置为210℃,跟文献[18]研究结论基本一致。
图5为采用微波光电导(MW-PCD)测试法所得1号位置硅片少子寿命扫描结果。颜色深黑表示少子寿命高,红色表示少子寿命低,整块硅片少子寿命并不均匀,温度越高越明显,这可理解为硅片表面各处气流差异带来辉光放电不同,导致各处薄膜厚度及成分有所差别。为研究RF-PCD法与MW-PCD法测试结果表征钝化性能异同,表1列出了图5主要特征值,并与RF-PCD法测试结果比较。
表1 给出了MW-PCD法测的少子寿命主要特征值,硅片各处少子寿命不均匀,此处以平均值说明其钝化性能。从表1可知,MW-PCD法和RF-PCD法测试结果均可看出,少子寿命随衬底温度升高呈现先增加再减小的变化趋势,220℃为最大,但二者的数据并不一样,说明它们的测试原理有所不同,MW-PCD是瞬态方法,所用仪器型号Semilab WT采用200 ns波长904 nm的脉冲激光注入从而产生非平衡载流子,对硅片反射回来的微波功率随时间变化情况记录光电导衰减;而RF-PCD是非接触检测,仪器型号为WCT-120是通过硅片少子寿命选择瞬态测试或者准瞬态测试。沉积薄膜均匀性不够好,少子寿命分布不均匀,一般选取RF-PCD测试结果更为可靠,二者测试结果差别明显[19]。图6为1号位置硅片椭偏测试结果,结果表明:测的介电常数实部和虚部符合非晶硅特征峰,表明沉积的i-a-SiOx:H膜属非晶相,符合预期实验要求。
-
实验采用PCEVD法在n-Cz-Si表面沉积不同衬底下本征氢化非晶氧化硅(i-a-SiOx:H),i-a-SiOx:H膜钝化性能与衬底温度关系密切,室温沉积硅片钝化效果不理想,沉积i-a-SiOx:H后硅片少子寿命随衬底温度升高呈现先增加后减小,钝化效果先优再劣的变化趋势,室温(25℃)少子寿命最低,少子寿命最高、钝化效果最优温度为200℃~220℃(不同位置略有差异),说明衬底温度过高过低都对i-a-SiOx:H膜钝化性能不利。
衬底温度对氢化非晶氧化硅(i-a-SiOx:H)钝化 性能的影响研究
Effect of Substrate Temperature on Passivation Properties of Hydrogenated Amorphous Silicon Oxide (i-a-SiOx:H)
-
摘要: 本征氢化非晶氧化硅(i-a-SiOx:H)是a-Si:H/c-Si异质结太阳电池中重要的钝化材料之一。本文采用PECVD法研究不同沉积衬底温度下n-Cz-Si表面沉积i-a-SiOx:H的钝化性能,采用微波光电导(MW-PCD)和射频光电导(RF-PCD)两种方法测试硅片少子寿命,光谱型椭偏仪检验沉积薄膜的晶型。结果表明:(1)椭偏仪结果显示实验所沉积薄膜为所需非晶型;(2)MW-PCD与RF-PCD法测试均显示,n-Cz-Si双面室温(25℃)沉积i-a-SiOx:H后硅片少子寿命很低,随沉积衬底温度升高硅片少子寿命先增加后减少,25℃少子寿命最低,200℃~220℃(不同位置略有差别)少子寿命最高、钝化效果最优。
-
关键词:
- 衬底温度 /
- 少子寿命 /
- i-a-SiOx:H /
- 钝化性能 /
- 椭偏仪
Abstract: Intrinsic hydrogenated amorphous silicon oxide (i-a-SiOx:H) is one of the important passivation materials in a-Si: H/c-Si heterojunction solar cells. In this paper, the passivation properties of i-a-SiOx:H deposited on the surface of n-Cz-Si at different substrate temperatures were studied by PECVD. The minority carrier lifetime of silicon wafers was measured by microwave photo-conductivity (MW-PCD) and radio frequency photo-conductivity (RF-PCD). The crystal form of the deposited films was examined by spectroscopic ellipsometry. The results show that: (1) the ellipsometer results show that the deposited films are amorphous; (2) MW-PCD and RF-PCD tests show that the minority carrier lifetime of the silicon wafer is very low after i-a-SiOx:H deposited on both sides of n-Cz-Si at room temperature. With the increase of deposition substrate temperature, the minority carrier lifetime of the silicon wafer increases first and then decreases, and the passivation effect is optimal at 200℃~ 220℃.-
Key words:
- Substrate temperature /
- Minority carrier lifetime /
- i-a-SiOx:H /
- Passivation performance /
- Ellipsometer .
-

-
图 1 n-Cz-Si室温沉积i-a-SiOx:H膜后硅片少子寿命(MW-PCD测试法)。(a)少子寿命随注入浓度变化,(b)注入浓度1×10 15 cm−3 硅片少子寿命
Figure 1. Minority carrier lifetime of n-Cz-Si after deposition of i-a-SiOx: H film at room temperature. (a) Minority carrier lifetime changes, (b) lifetime of silicon wa- with injection concentration fer with 1×10 15 cm−3
图 3 不同衬底温度a-SiOx:H膜钝化后硅片少子寿命。(a)不同注入浓度硅片少子寿命,(b)注入浓度为1×1015 cm−3 时少子寿命
Figure 3. Minority carrier lifetime of silicon wafer after a-SiOx: H film passivation at different substrate temperatures. (a)Lifetime of silicon wafers with, (b)lifetime of injection different injection concentration concentration 1×1015 cm−3
表 1 MW-PCD法测试硅片少子寿命主要特征值(单位:μs)
Table 1. Main characteristic values of minority carrier lifetime of silicon wafer tested by MW-PCD method (μs)
温度/℃ 最小 最大 平均值 RF-PCD 25 2 4 3 2 100 3 9 7 6 180 15 419 192 423 200 19 92 250 634 220 22 1886 316 747 250 41 655 285 487 -
[1] Pankove J I,Tarng M l. Amorphous silicon as a passivation for crystalline silicon[J]. Appl PhyS Lett,1979,34:156−157 doi: 10.1063/1.90711 [2] Weitzel I,Primig R,Kempter K. Preparation of glow discharge amorphous silicon for passivation layers[J]. Thin Solid Films,1981,75:143−150 doi: 10.1016/0040-6090(81)90450-8 [3] Tanaka M,Okamaoto S,Sadaji T,et al. Development of HIT solar cells with more than 21% conversion effiency and commercialization of highest performance HIT modules[J]. Proceedings of 3rd World Conference on Photovoltaic Energy Conversion, Osaka, Japan,2003:955−958 [4] Mishima T,Taguchi M,Sakata H,et al. Development status of high-efficiency HIT solar cell[J]. Sol. Energy Mater. Sol. cells,2011,95:18−21 doi: 10.1016/j.solmat.2010.04.030 [5] 松下背接触HIT太阳能电池推动效率创纪录达25.6%. http://www.pv-tech.cn/news/back_contact_hit_solar_cell_from_panasonic_pushes_efficiency_ record_to_25.6. [6] 沈文忠, 李正平. 硅基异质结太阳电池物理与器件[M]. 北京: 科学出版社, 2014, 8. Shen Wenzhong, Li Zhengping. Physics and devices of silicon heterojunction solar cells[M]. Beijing: Science Press [7] Street R A. Hydrogenated amorphous silicon[M]. Cambridge: Cambridge University Press, 1991 [8] Muller T,Schwertheim S,Fahrner W R. Crystalline silicon surface passivation by high-frequency plasma-enhanced chemical-vapor-deposited nanocomposite silicon suboxides for solar cell application[J]. Journal of Applied Physics,2010,107:014504 doi: 10.1063/1.3264626 [9] Fujiwara H,Kaneko T,Kondo M. Application of hydrogenated amorphous silicon oxide layers to c-Si heterojunction solar cells[J]. Applied Physics Letters,2007,91(13):481 [10] Muller T,Schwertheim S,Scherff M,et al. High quality passsivation for heterojunction solar cells by hydrogenated amorphous silicon suboxide films[J]. Applied Physics Letters,2008,92(3):033504 doi: 10.1063/1.2837192 [11] Angermann H,Roeseler A,Rebien M,et al. Wet-chemical preparation and spectroscopic characterization of Si inter- faces[J]. Appl Surf Sci,2004,235:322−329 doi: 10.1016/j.apsusc.2004.05.105 [12] Hattori T. Ultraclean surface processing of silicon wafers [M]. Springer, Berlin, 1998 [13] 何玉平. 非晶硅/晶体硅异质结太阳电池的钝化材料与器件结构研究[D]. 南昌: 南昌大学, 2016. He Yuping. Studies of passivation materials and device structure of a-Si:H/c-Si heterojunction solar cells[D]. Nanchang: Nanchang University, 2016 [14] MorralA F,CabarrocasP R. Structure and hydrogen content of polymorphous silicon thin films studied by spectro- scopicellipsometry and nuclear measurements[J]. Physical Review B,2004,69:125307 doi: 10.1103/PhysRevB.69.125307 [15] Ouwens JD,Schrop R. Hydrogen microstructure in hydrogenated amorphous silicon[J]. Physical Review B,1996,54(24):17759 doi: 10.1103/PhysRevB.54.17759 [16] Akihisa Matsuda,Madoka Takai,Tomonori Nishimoto,et al. Control of plasma chemistry for preparing highly stali- lized amorphous silicon at high growth rate[J]. Solar Energy Materials& Solar Cells,2003,78:3−26 [17] He Yuping,Huang Haibin,Gong Hongyong,et al. Effect of SiH and SiH2 bonds in a-Si:H based coating on passivation of N-type Si wafer[J]. Chinese journal of vacuum science and technology,2015,35(8):970−974 (何玉平,黄海宾,龚洪勇,等. a-Si: H基薄膜中SiH及SiH2键构成对n型直拉单晶硅片钝化效果的影响研究[J]. 真空科学与技术学报,2015,35(8):970−974(in chinese) He Yuping, Huang Haibin, Gong Hongyong, et al. Effect of SiH and SiH2 bonds in a-Si:H based coating on passivation of N-type Si wafer[J]. Chinese journal of vacuum science and technology,, 2015, 35(8): 970-974 [18] A. B. Sproul. Dimensionless solution of the equation describing the effect of surface recombination of carrier de- cay in semiconductor[J]. J Appl Phys,1994,76:2851−2854 doi: 10.1063/1.357521 [19] 龚洪勇. 非晶硅/晶体硅异质结太阳电池的界面钝化层研究[D]. 南昌: 南昌大学, 2014 Gong Hongyong. A Study on the passivation layer in a-Si:H/c-Si heterojunction solar cells[D]. Nanchang: Nanchang University, 2014 -


 首页
首页 登录
登录 注册
注册



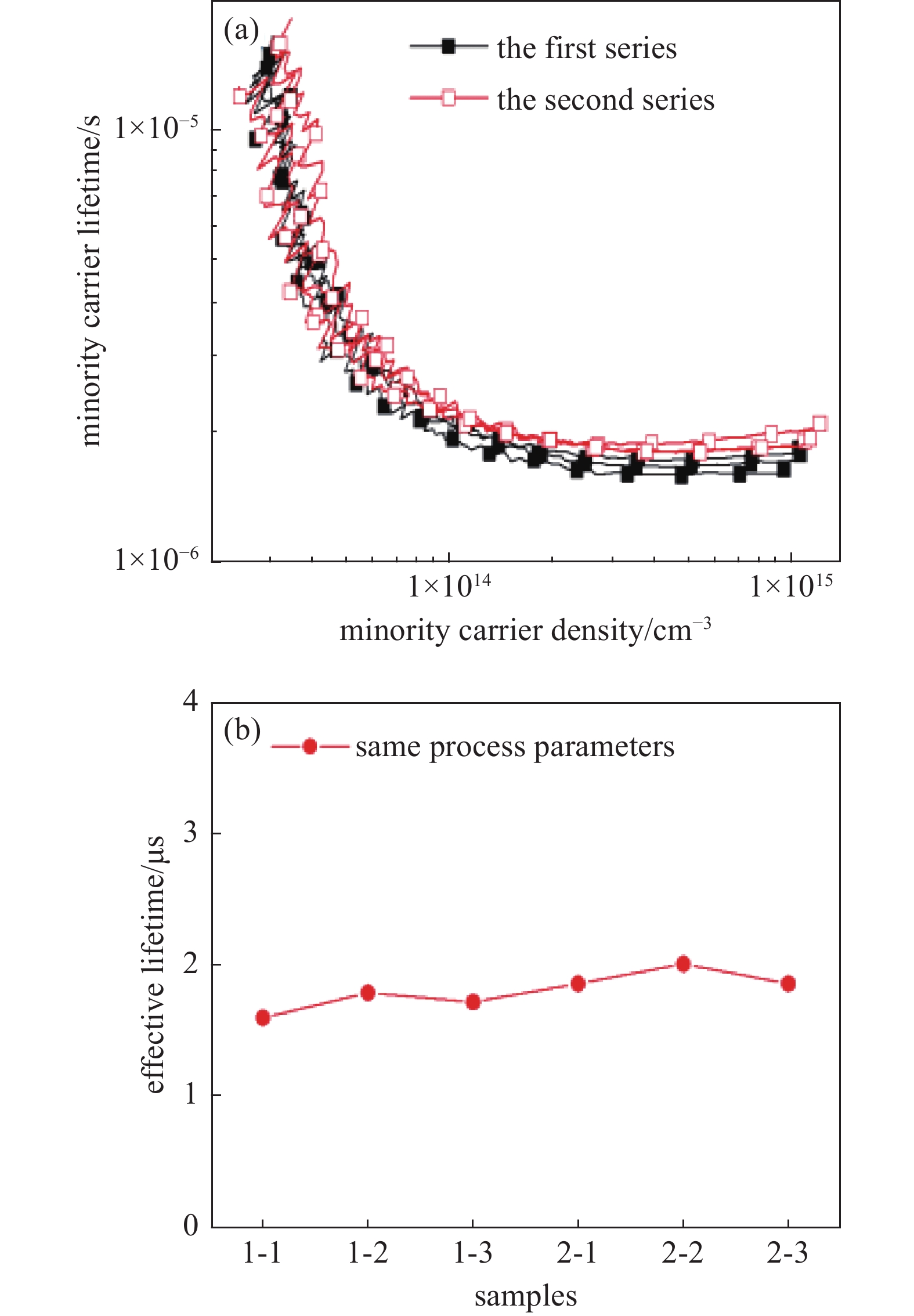
 下载:
下载: