-
功率器件是航天器电力电子系统的基本部件, 容易受到宇宙射线中带电粒子辐射的影响, 导致电子设备的电学性能退化并缩短航天器的使用寿命, 降低器件工作的稳定性和可靠性[1-4]. 随着航空航天领域的快速发展, 新一代航天器对体积、重量和系统能源转换效率等指标提出了更高的要求, 而碳化硅(SiC)作为第三代半导体材料相较于传统硅基器件, 能够提高电子设备工作效率、降低装置体积和重量、增加抗辐照性能. 因此, 在航天领域, SiC功率器件被寄予厚望[5-9]. 然而, 由于MOS器件对空间辐射的敏感性以及空间环境对电子器件可靠性的高要求, 有必要充分评估碳化硅金属-氧化物-半导体场效应晶体管(silicon carbide metal-oxide-semiconductor field-effect transistor, SiC MOSFET)在空间电子系统中的应用. 因此, 研究碳化硅基器件的辐照效应规律及其损伤机理是十分必要的. 2012年, Akturk等[10]在不同辐照温度下对SiC MOSFET进行了总剂量辐照实验, 结果表明, 该器件在超过100 krad(Si)的辐射条件下仍能正常工作, 但是出现电学性能退化, 表现为器件阈值电压降低, 驱动电流增大; 2016年, Popelka和Hazdra[11]研究了电子辐照对SiC MOSFET器件的影响, 他们发现在低剂量范围内(低于20 kGy), 器件阈值电压随着辐照剂量的增加而迅速降低. 而当剂量超过200 kGy时, 阈值电压恢复到原来的值, 这主要是由于辐照在低掺杂漂移区引入了深能级受主中心. 在2022年, Yu等[12]对比了三款SiC MOSFET器件的总剂量效应, 他们发现在高剂量率下, 这些器件都会产生负的阈值电压偏移, 性能退化主要是由氧化层中的正电荷引起的. 从上述研究中可以发现, 相关研究仅针对传统平面栅型碳化硅MOSFET研究了总剂量效应的影响, 而对于新一代具有诸如更小晶胞尺寸, 更低导通电阻和更大电流密度的双沟槽型碳化硅MOSFET(double-trench SiC MOSFET, SiC DTMOSFET)器件中总剂量效应的退化机理研究较少[7,13]. 因此, 有必要对SiC DTMOSFET的总剂量效应实验开展进一步的深入全面研究.
本文利用60Co-γ射线对SiC DTMOSFET器件开展了不同栅极偏置电压和不同辐照剂量的总剂量辐照实验, 通过低频噪声参数分析仪(FS-380PRO)测试器件在不同剂量和不同栅极偏置电压下辐照前后的电流噪声功率谱密度, 分析辐照剂量和栅极电压对SiC DTMOSFET器件缺陷产生的影响; 对器件辐照后的室温退火效应进行了研究. 结合TCAD工具, 进一步解释了氧化物陷阱电荷造成SiC DTMOSFET器件转移特性曲线负向漂移的原因.
-
实验样品选用的是Rohm公司生产的型号为SCT4060KR的第四代双沟槽型碳化硅场效应晶体管, 封装类型为TO-247-4L. 实验器件的单元结构如图1(a)所示, 其源漏击穿电压为1200 V, 额定电流为26 A, 导通电阻为62 mΩ. 电学性能通过Keysight半导体参数分析仪(B1500A)测试获得, 低频噪声通过动态信号参数分析仪(FS-Pro380)测试获得.
辐照实验在西北核技术研究所60Co-γ射线源上进行, 为了全面评价器件不同工作状态的损伤特征, 辐照过程选择了栅压正向偏置(VG = +5 V)、栅压零偏置(VG = 0 V)和栅压反向偏置(VG = –5 V)进行辐照, 研究栅极偏压对器件辐照退化的影响. 辐照实验在室温下进行, 剂量率为50 rad(Si)/s, 选择了3个剂量点: 50, 100和150 krad(Si).
为保证实验数据的可靠性, 辐照前器件的电学性能具有良好的一致性, 辐照后器件的电学参数测试和低频噪声测试均在1 h内完成. 当总剂量辐照实验完成后, 对辐照后的SiC DTMOSFET器件进行退火实验, 在辐照后24, 48和168 h测量其电学特性.
-
图2为SiC DTMOSFET器件在栅极零偏条件下辐照前后的转移特性曲线与累积剂量的关系, 实线为转移特性曲线, 虚线为跨导曲线. 从图2中的实验结果可知, 随着辐照剂量的增加, SiC DTMOSFET器件的转移特性曲线都有明显的负漂移, 说明器件的性能有不同程度的退化, 且退化程度与辐照剂量呈正相关. 当辐照剂量为150 krad(Si)时, 阈值电压偏移19%, 器件跨导(Gm)峰值高度变化不大, 但Gm位置负向漂移, 与阈值电压负向漂移变化一致.
在上述基础上, 为了研究栅极电场强度对SiC DTMOSFET器件辐照退化的影响, 开展了不同栅极电压偏置(VG = –5, 0, +5 V)下的总剂量辐照实验, 图3所示为SiC DTMOSFET器件在辐照剂量为150 krad(Si)时不同栅极偏置电压下辐照前后的转移特性曲线的关系. 由图3所示的结果来看, 辐照后, 器件的转移特性曲线都发生了明显的负向漂移, 阈值电压逐渐减小但辐照后曲线的斜率未发生明显变化. 当VG = 0 V时, 辐照对器件的影响最小, 而当VG = +5 V时, 辐照对器件的影响较为明显, 阈值电压的变化幅度可达82%, 远高于传统平面栅型碳化硅MOSFET在栅极偏置VG = +5 V, 辐照剂量为500 krad(Si)时阈值电压43%的变化幅度[14]. 这表明双沟槽型结构更容易受到总剂量辐射的影响, 这可能是由于沟槽氧化层质量较差. 从表1中可以看出, 不同栅极偏置电压和不同辐照剂量下SiC DTMOSFET器件的阈值电压变化量(ΔVth). 结果表明, 在总剂量辐照实验中, 栅极施加正向偏置电压是该器件的最恶劣偏置条件.
增强型MOSFET阈值电压Vth的数学模型[11]为
其中
$ {C_{{\text{OX}}}} $ 是单位面积的栅氧化层电容;$ {N_{{\text{ot}}}} $ 是氧化物陷阱电荷密度;$ {N_{{\text{it}}}} $ 是界面态陷阱电荷密度;$ {\varepsilon _{\text{s}}} $ 是SiC的介电常数;$ {N_{\text{A}}} $ 是P型衬底的有效掺杂浓度;$ {\phi _{{\text{Fp}}}} $ 是准费米势;$ {\varphi _{{\text{MS}}}} $ 是金属和半导体的功函数差;${k_{\text{B}}}$ 是玻尔兹曼常数;$T$ 是绝对温度;${n_{\text{i}}}$ 是碳化硅的本征载流子浓度;$ q $ 表示电荷量.根据(1)式和(2)式, 可以推断出60Co-γ辐照后器件性能退化的原因是辐照在器件栅氧化层中诱生出陷阱电荷. 当伽马射线入射到器件内部时, 能量沉积在栅极氧化层中, 如果沉积的能量大于材料的禁带宽度, 部分被束缚的电子会吸收入射粒子沉积的能量, 使其从价带跃迁到导带, 在沟槽氧化层中产生大量的电子-空穴对. 在外加电场的作用下, 由于电子和空穴在氧化物介质中迁移率的巨大差异(相差6个数量级), 因此在该过程中可以认为空穴固定在原位而电子被电场扫出氧化层. 而没有复合的空穴则会通过跃迁的方式向着SiC/SiO2界面处移动, 当空穴跃迁至SiC/SiO2界面靠近SiO2一侧时, 由于该位置存在大量空穴陷阱, 因此空穴被俘获而形成正的氧化物陷阱电荷[15-17]. 同时, 沟槽氧化物中的空穴跃迁产生带正电的氢离子或中性氢原子, 这些粒子运动到SiC和SiO2的界面处, 在那里发生作用形成界面态陷阱, 如图4所示[18].
氧化物陷阱电荷和界面态陷阱电荷共同决定了SiC DTMOSFET的阈值电压, 界面态陷阱电荷可使阈值电压正向漂移, 而氧化物陷阱电荷可使阈值电压负向漂移[19]. 本实验中, SiC DTMOSFET的阈值电压均为负向漂移, 表明器件中产生的氧化物陷阱电荷密度大于界面态陷阱电荷密度. 对于本次研究中的N沟道SiC DTMOSFET器件来说, 在对栅极施加正向偏置的辐照条件下, 栅极的氧化层内形成的电场方向是从多晶硅栅极指向沟道区域, 这种情况会导致因辐照而产生的电子和空穴对的复合概率降低, 那些未复合的电子会迅速移动至多晶硅栅极并被吸收. 与此相反, 空穴会缓慢地向沟道方向移动, 并在氧化层靠近碳化硅界面的位置积累, 形成较多的氧化物陷阱正电荷. 而在辐照过程中, 如果对栅极施加负向偏置, 则电场的方向相反, 从沟道指向多晶硅栅极. 此时, 电子在电场的推动下向沟道方向移动, 并在界面态的帮助下进入沟道, 剩余未复合的空穴向多晶硅栅极缓慢移动. 所以, 在氧化层中靠近SiC/SiO2界面附近形成的氧化层陷阱电荷减少, 导致阈值电压的漂移量相比栅极正偏下减小. 此外, 栅极存在偏压时由于电场的存在, 辐照而产生的电子和空穴对的复合概率降低, 电子在电场作用下被快速扫出氧化层, 未被复合的空穴在向SiC/SiO2界面跃迁过程中被俘获为正的氧化物陷阱电荷. 同时, 由表2可知, 在栅极偏置VG = +5, –5 V时, 其氧化物陷阱电荷密度明显高于VG = 0 V栅极偏置电压下的氧化物陷阱电荷密度. 所以, VG = +5, –5 V栅极偏置条件下的阈值电压退化比VG = 0 V栅极偏置条件下更加严重[20,21].
上文解释了总剂量效应会在器件栅氧化层内诱生出氧化物陷阱电荷以及界面态陷阱电荷, 从而造成器件电学性能退化. 因此, 为了深入地解释双沟槽SiC MOSFET器件中总剂量效应的物理机制, 本文利用中带电压法计算辐照在沟槽氧化层中产生的
$ {N_{{\text{ot}}}} $ 和$ {N_{{\text{it}}}} $ 的浓度. 阈值电压的漂移量可以用下式表示[2,5]:中带电压Vmg就是指当费米能级与禁带中心点重合时对应的栅极电压. 此时, 由于界面态呈现电中性, 不会引起阈值电压的变化. 因此, 氧化物陷阱电荷的变化量可以等效为辐照前后中带电压的变化量:
中带电流可由(5)式和(6)式计算得出[22,23], 然后在转移特性曲线的亚阈值区域找到中带电流Im所对应的栅压, 此时的栅压就是所求的Vmg.
式中,
$ L_{\text{B}} $ 为SiC中的德拜长度.氧化物陷阱电荷浓度和界面态陷阱电荷浓度可由下式计算得出:
表2为辐照剂量为150 krad(Si)时, 采用中带电压法分离得到不同栅极电压下SiC DTMOSFET的
$ {N_{{\text{ot}}}} $ 和$ {N_{{\text{it}}}} $ . -
通过低频噪声参数分析仪(FS-Pro380)测试器件在不同剂量和不同栅极偏置电压下辐照前后的电流噪声功率谱密度, 进一步分析辐照剂量和栅极电压对SiC DTMOSFET器件缺陷产生的影响. 1/f噪声理论认为, 1/f噪声是由SiC/SiO2界面缺陷的随机载流子俘获或释放引起的, 1/f噪声测试可以得到不同辐照剂量和栅极电压下缺陷密度的变化.
60Co-γ辐射前后SiC DTMOSFET器件在 Vg – Vth = 1 V时漏极电流噪声归一化功率谱密度SI/I 2与辐射剂量的关系图像如图5所示. 图5(a)给出了VG = 0 V时不同辐照剂量下的1/f噪声测试结果. 可见, 随着辐照剂量的增加, 噪声功率谱密度也随之增加, 表明辐照引起的缺陷密度增加. 辐照剂量为150 krad(Si)时, 不同栅极电压下的1/f噪声测试结果如图5(b)所示. 由图5(b)可以看出, 正向栅极电压下噪声功率谱密度最大, 所以正向栅极电压下辐照引起的缺陷密度最大, 这与3.1节的结果一致.
MOSFET器件的1/f噪声可以用载流子数波动模型来分析, 这是由于沟道中SiC/SiO2界面附近的缺陷对载流子的俘获和释放行为引起的, 归一化噪声功率谱密度模型如下[24]:
式中,
$ S_{\text{vbf}} $ 为输入参考噪声功率谱密度, 它只与器件的陷阱电荷密度、结构尺寸等参数有关;$ {G_{\text{M}}} $ 是器件的跨导.其中
$ \lambda $ 为隧穿衰减系数(对于SiO2为0.1 nm);$ W $ 和$ L $ 分别为栅极的宽度和长度;$ {N_{\text{t}}} $ 为界面附近的缺陷密度.通过(9)式和(10)式可以拟合和计算辐照前后器件内部的缺陷密度. 未经过辐照的器件缺陷密度为2.25×1012 cm–3·eV–1, 辐照剂量为150 krad(Si)时的缺陷密度为1.16×1014 cm–3·eV–1(VG = 0 V), 1.58 × 1014 cm–3·eV–1 (VG = –5 V), 8.75 × 1014 cm–3·eV–1 (VG = +5 V). 结果表明, 辐照在氧化层和沟道界面附近产生了缺陷, 且栅极施加偏置电压时会使得缺陷密度增大.
-
为了研究辐照后SiC MOSFET器件的退火效应, 在标准大气压强下的室温空气环境中进行退火过程. 对辐照剂量为150 krad(Si), 栅极偏压为VG = +5 V下的器件, 分别在24, 48和168 h后进行电学性能测试, 结果表明随退火时间的增加器件的阈值电压逐渐恢复, 如图6所示. 退火168 h后, 阈值电压恢复0.3 V, 阈值电压的恢复是因为辐照产生的浅能级氧化物陷阱电荷在室温下发生了退火, 而深能级氧化物陷阱电荷和界面陷阱电荷在室温难以恢复, 这也是器件损伤的主要因素.
-
根据图1(a)扫描电子显微镜(SEM)的分析结果, 利用TCAD仿真工具建立了SiC DTMOSFET的二维模型, 其栅极沟槽的深度和宽度为1 和0.5 μm, 源极沟槽深度和宽度为1.88和0.69 μm, 如图7所示. 利用TCAD对SiC DTMOSFET器件进行总剂量仿真时, 需要添加相对应的物理模型, 本研究中主要采用了迁移率模型、非完全电离模型、Auger和SRH复合模型以及缺陷模型. 通过这些模型, 我们对器件的电学特性及其在电离辐射影响下的微观物理机制进行了数值模拟, 获取模型内部电场分布情况, 进而分析辐照后器件电学参数变化的微观物理机制, 进一步证明上述实验所得出的辐照诱生的氧化物陷阱电荷和界面态陷阱电荷对器件造成损伤的结论. 在利用TCAD构建完成器件的二维模型后, 需要检验所构建模型的合理性, 对器件的直流特性进行验证, 利用TCAD中的Device模块输出模型的IDS-VGS和IDS-VDS曲线, 并与实验所用的SiC DTMOSFET器件的实际测试数据进行比较. 从图8展示的结果可以看出, 所构建器件模型的直流特性与实验器件的直流特性较为一致.
本文建立的SiC DTMOSFET器件的仿真模型是一种N沟道器件模型, 总剂量辐照效应中界面陷阱电荷的生成与氧化物陷阱电荷相比较为缓慢, 且SiC功率MOSFET具有较大的本征界面缺陷, 同时, 由表2可知, 在不同栅极偏压下, 总剂量效应在氧化层中诱生的氧化物陷阱电荷数量比界面态陷阱电荷高1—3个数量级, 所以氧化物陷阱电荷是导致其电学性能退化的主要原因, 界面陷阱电荷对器件的电学性能影响较小. 在仿真过程中, 为了更直观地反映氧化物陷阱电荷及其浓度对器件整体性能的影响, 我们遵循了单一变量原则, 在没有考虑其他缺陷的情况下, 默认器件模型只有本征界面缺陷. 因此, 在模拟氧化物陷阱电荷对器件的宏观电学参数的影响时, 只需在栅氧化层中引入一定浓度的氧化物固定电荷来说明氧化物陷阱电荷对器件阈值电压的影响即可.
图9为TCAD仿真时, 在SiC DTMOSFET器件模型的栅氧化层中引入不同浓度的氧化物固定电荷前后器件的转移特性曲线变化情况. 在模拟氧化物陷阱电荷对SiC DTMOSFET器件的电学性能造成的影响时, 向器件的栅氧化层中分别引入了2.63×1017, 5.13×1017和7.63×1017 cm–3浓度的氧化物固定电荷进行定性分析. 根据图9中展示的仿真结果可以看出, 随着器件模型氧化层中的氧化物固定电荷浓度越来越大, 器件转移特性曲线负向漂移的程度越来越大, 阈值电压的变化量也越来越大, 阈值电压的变化量如表3所列.
在建立的SiC DTMOSFET器件模型栅氧化层中引入氧化物固定电荷前后器件内部的电场强度变化情况如图10所示. 通过对比发现, 氧化层中引入氧化物固定电荷后, 器件栅氧化层中靠近沟道处的电场强度明显变大. 根据以上的微观物理现象结合器件宏观电学参数的变化情况, 说明在氧化层中引入一定浓度的氧化物固定电荷会造成栅极氧化层区域的电势增加, 从而导致器件P-基区不断地耗尽空穴, 形成一小块耗尽区域, 使得栅氧层的电场强度增大, 器件的阈值电压不断减小. 因此可以得出, 总剂量效应引入的氧化物陷阱电荷会使器件栅极氧化层电场强度急剧增加, 导致器件转移特性曲线负漂移, 器件的阈值电压减小, 这与前序实验所得结论一致.
-
本文利用60Co-γ射线对SiC DTMOSFET开展了不同栅极偏置电压条件下的总剂量效应辐照实验, 研究了器件在不同栅极电压偏置条件下辐照敏感特性的退化差异和恢复规律; 同时对器件辐照后的退火效应进行了研究, 为双沟槽型碳化硅器件在极端环境下的应用提供理论支撑. 实验结果表明: 电离辐照会导致SiC DTMOSFET器件造成损伤, 使得器件的电学性能下降, 且根据栅极电压偏置不同对其退化程度也有不同影响. 通过开展不同栅极电压偏置下器件的辐照实验发现, 在150 krad(Si)辐照剂量下, 栅压在+5和–5 V偏置下器件辐照后的阈值电压分别减小了3.28和2.36 V, 而在栅压为0 V偏置下器件辐照后的阈值电压仅减小了1.36 V, 说明栅压存在偏置会对器件造成更严重的损伤. 辐照后器件内部产生了氧化层陷阱电荷和界面态陷阱电荷, 这两种陷阱电荷的存在增加了器件辐照缺陷密度, 且氧化层陷阱电荷数量的增加导致器件阈值电压的负向漂移. 退火实验表明, 双沟槽型碳化硅场效应晶体管器件的电学性能在室温退火后可以部分恢复. 结合TCAD仿真模拟, 辐照诱生的氧化物陷阱电荷引入会造成栅氧化层中靠近沟道处的电场强度明显变大, 从而导致SiC DTMOSFET器件阈值电压减小. 本文的相关研究结果可为双沟槽型碳化硅场效应晶体管器件的辐射效应机理和抗辐射加固设计提供重要的参考.
双沟槽SiC MOSFET总剂量效应
Total ionizing dose effect of double-trench SiC MOSFET
-
摘要: 本文对第四代双沟槽型碳化硅场效应晶体管开展了不同栅极偏置电压下的60Co-γ辐照实验, 并在辐照后进行了室温退火实验. 实验结果表明, 辐照后器件的阈值电压负向漂移, 且在正向栅极偏压下电学性能退化尤为明显. 通过分析器件的1/f噪声特性发现, 在不同栅极偏置条件下辐照后器件的漏极电流噪声归一化功率谱密度升高了4—9个数量级, 这表明辐照后器件内部缺陷密度显著增加. 对辐照后器件进行了24, 48和168 h的室温退火实验, 退火后器件阈值电压有所升高, 表明器件的电学性能在室温下可以部分恢复, 主要因为辐照产生的浅氧化物陷阱电荷在室温下退火, 而深氧化物陷阱电荷和界面陷阱电荷在室温难以恢复. 结合TCAD仿真模拟进一步分析器件总剂量效应微观机制. 结果表明, 辐照在氧化层中诱生的大量氧化物陷阱电荷造成栅极氧化层中靠近沟道一侧的电场强度增大, 导致器件的阈值电压负向漂移, 影响器件性能.Abstract: In this work, the influence of 60Co-γ ray irradiation on double trench SiC metal–oxide–semiconductor field-effect transistors (MOSFETs) is investigated under different conditions. First, the effects of the total ionizing dose (TID) on the electrical performance of the device at different gate bias voltages are studied. The results indicate that at 150 krad(Si) irradiation dose, the threshold voltage of the device after being irradiated decreases by 3.28 and 2.36 V for gate voltages of +5 and –5 V bias, respectively, whereas the threshold voltage of the device after being irradiated decreases by only 1.36 V for a gate voltage of 0 V bias. The threshold voltage of the device after irradiation drifts in the negative direction, and the degradation of the electrical performance is especially obvious under the positive gate bias. This is attributed to the increase in the number of charges trapped in the oxide layer. At the same time, room temperature annealing experiments are performed on the irradiated devices for 24, 48, and 168 h. The shallow oxide trap charges generated by irradiation are annealed at room temperature, while the deep oxide trap charges and interface trap charges are difficult to recover at room temperature, resulting in an increase in the threshold voltage of the devices after being annealed, indicating that the electrical properties of the devices can be partially recovered after being annealed at room temperature. In order to characterize the effect of 60Co-γ ray irradiation on the interfacial state defect density of the devices, low frequency noise (1/f ) tests are performed at different doses and different gate bias voltages. The 1/f low frequency noise testing shows that under different bias voltages, the density of irradiation defects in the device increases due to the presence of induced oxide trap charges in the oxide layer of the device after being irradiated and the interfacial trap charges generated at the SiO2/SiC interface. This results in an increase of 4–9 orders of magnitude in the normalized power spectral density of the drain current noise of the irradiated device. To further ascertain the irradiation damage mechanism of the device, a numerical simulation is carried out using the TCAD simulation tool, and the results show that a large number of oxide trap charges induced by irradiation in the oxide layer cause an increase in the electric field strength in the gate oxide layer close to the trench side, which leads to a negative drift of the threshold voltage of the device and affects the performance of the device. The results of this work can provide important theoretical references for investigating the radiation effect mechanism and designing the anti radiation reinforcement of double trench SiC MOSFET devices.
-
Key words:
- double-trench /
- silicon carbide /
- low-frequency noise /
- total ionizing dose effect .
-

-
图 5 SiC DTMOSFET的低频噪声特性 (a) 在VG = 0 V辐照条件下SiC DTMOSFET的低频噪声特性随总剂量的变化趋势; (b) 剂量为150 krad(Si)辐照条件下SiC DTMOSFET的低频噪声特性随栅极偏压的变化趋势
Figure 5. Low frequency noise characteristics of SiC DTMOSFET: (a) The variation trend of low frequency noise characteristics of SiC DTMOSFET with total dose under VG = 0 V irradiation; (b) the variation trend of low-frequency noise characteristics of SiC DTMOSFET with gate bias under the irradiation dose of 150 krad(Si).
表 1 不同栅极偏置电压和辐照剂量下SiC DTMOSFET器件的阈值电压变化量
Table 1. The amount of threshold voltage variation for double-trench SiC MOSFET devices with different gate voltages and irradiation doses.
实验条件 VG = 0 V VG = –5 V VG = +5 V 50 krad(Si) –0.58 V –1.27 V –1.52 V 100 krad(Si) –1.07 V –1.54 V –2.15 V 150 krad(Si) –1.36 V –2.36 V –3.28 V 表 2 辐照剂量为150 krad(Si)时不同栅极偏压下的氧化物陷阱电荷和界面态陷阱电荷密度
Table 2. The oxide trap charge density and interface trap charge density at different voltages when the irradiation dose is 150 krad(Si).
实验条件 VG = 0 V VG = –5 V VG = +5 V Not/(1010 cm–2) 7.63 12.70 20.10 Nit/(108 cm–2) 28.90 5.75 133.00 表 3 辐照剂量为150 krad(Si)时栅极氧化层中引入不同氧化物固定电荷密度下器件阈值电压变化量
Table 3. The threshold voltage variation of the device with different oxide fixed charge concentrations introduced into the gate oxide layer at the irradiation dose of 150 krad(Si).
$N_{\text{ot}}$ /(1017 cm–3)2.63 5.13 7.63 $\Delta V_{\text{th}}$ /V–0.969 –1.902 –2.826 -
[1] Matsuda T, Yokoseki T, Mitomo S, Murata K, Makino T, Abe H, Takeyama A, Onoda S, Tanaka Y, Kandori M, Yoshie T, Hijikata Y, Ohshima T 2016 Mater. Sci. Forum 858 860 doi: 10.4028/www.scientific.net/MSF.858.860 [2] Murata K, Mitomo S, Matsuda T, Yokoseki T, Makino T, Onoda S, Takeyama A, Ohshima T, Okubo S, Tanaka Y, Kandori M, Yoshie T, Hijikata Y 2017 Phys. Status Solidi A 214 1600446 doi: 10.1002/pssa.201600446 [3] Ohshima T, Yoshikawa M, Itoh H, Aoki Y, Nashiyama I 1999 Mater. Sci. Eng., B 61–62 480 [4] Takeyama A, Makino T, Okubo S, Tanaka Y, Yoshie T, Hijikata Y, Ohshima T 2019 Materials 12 2741 doi: 10.3390/ma12172741 [5] Dimitrijev S, Jamet P 2003 Microelectron. Reliab. 43 225 doi: 10.1016/S0026-2714(02)00270-6 [6] Liu J, Lu J, Tian X, Chen H, Bai Y, Liu X 2020 Electron. Lett. 56 1273 doi: 10.1049/el.2020.1627 [7] Pappis D, Zacharias P 2017 2017 19th European Conference on Power Electronics and Applications (EPE’17 ECCE Europe) Warsaw, Poland, September 11–14, 2017 p2017-12-14 [8] Sato I, Tanaka T, Hori M, Yamada R, Toba A, Kubota H 2021 Electr. Eng. Jpn. 214 e23323 doi: 10.1002/eej.23323 [9] Winokur P S, Schwank J R, McWhorter P J, Dressendorfer P V, Turpin D C 1984 IEEE Trans. Nucl. Sci. 31 1453 doi: 10.1109/TNS.1984.4333529 [10] Akturk A, McGarrity J M, Potbhare S, Goldsman N 2012 IEEE Trans. Nucl. Sci. 59 3258 doi: 10.1109/TNS.2012.2223763 [11] Popelka S, Hazdra P 2016 Mater. Sci. Forum 858 856 doi: 10.4028/www.scientific.net/MSF.858.856 [12] Yu Q, Ali W, Cao S, Wang H, Lv H, Sun Y, Mo R, Wang Q, Mei B, Sun J, Zhang H, Tang M, Bai S, Zhang T, Bai Y, Zhang C 2022 IEEE Trans. Nucl. Sci. 69 1127 doi: 10.1109/TNS.2021.3135123 [13] Sampath M, Morisette D, Cooper J 2018 Mater. Sci. Forum 924 752 doi: 10.4028/www.scientific.net/MSF.924.752 [14] 顾朝桥, 郭红霞, 潘霄宇, 雷志峰, 张凤祁, 张鸿, 琚安安, 柳奕天 2021 物理学报 70 166101 doi: 10.7498/aps.70.20210515 Gu Z Q, Guo H X, Pan X Y, Lei Z F, Zhang F Q, Zhang H, Ju A A, Liu Y T 2021 Acta Phys. Sin. 70 166101 doi: 10.7498/aps.70.20210515 [15] 陈伟华, 杜磊, 庄奕琪, 包军林, 何亮, 张天福, 张雪 2009 物理学报 58 4090 doi: 10.7498/aps.58.4090 Chen W H, Du L, Zhuang Y Q, Bao J L, He L, Zhang T F, Zhang X 2009 Acta Phys. Sin. 58 4090 doi: 10.7498/aps.58.4090 [16] 刘张李, 胡志远, 张正选, 邵华, 宁冰旭, 毕大炜, 陈明, 邹世昌 2011 物理学报 60 116103 doi: 10.7498/aps.60.116103 Liu Z L, Hu Z Y, Zhang Z X, Shao H, Ning B X, Bi D W, Chen M, Zou S C 2011 Acta Phys. Sin. 60 116103 doi: 10.7498/aps.60.116103 [17] Oldham T R, McLean F B 2003 IEEE Trans. Nucl. Sci. 50 483 doi: 10.1109/TNS.2003.812927 [18] 孟洋 2024 硕士学位论文学位论文 (扬州: 扬州大学) Meng Y 2024 M. S. Thesis (Yangzhou: Yang Zhou University [19] 万欣 2017 博士学位论文学位论文 (北京: 清华大学) Wan X 2016 Ph. D. Dissertation (Beijing: Tsinghua University [20] Fleetwood D M, Winokur P S, Schwank J R 1988 IEEE Trans. Nucl. Sci. 35 1497 doi: 10.1109/23.25487 [21] Shaneyfelt M R, Schwank J R, Fleetwood D M, Winokur P S, Hughes K L, Sexton F W 1990 IEEE Trans. Nucl. Sci. 37 1632 doi: 10.1109/23.101171 [22] McWhorter P J, Winokur P S 1986 Appl. Phys. Lett. 48 133 doi: 10.1063/1.96974 [23] Mitomo S, Matsuda T, Murata K, Yokoseki T, Makino T, Takeyama A, Onoda S, Ohshima T, Okubo S, Tanaka Y, Kandori M, Yoshie T, Hijikata Y 2017 Phys. Status Solidi A 214 1600425 doi: 10.1002/pssa.201600425 [24] Scofield J H, Fleetwood D M 1991 IEEE Trans. Nucl. Sci. 38 1567 doi: 10.1109/23.124147 [25] Silvestri M, Uren M J, Killat N, Marcon D, Kuball M 2013 Appl. Phys. Lett. 103 043506 doi: 10.1063/1.4816424 [26] Wang J L, Chen Y Q, Feng J T, Xu X B, En Y F, Hou B, Gao R, Chen Y, Huang Y, Geng K W 2020 IEEE J. Electron Devices Soc. 8 145 doi: 10.1109/JEDS.2020.2971245 -


 首页
首页 登录
登录 注册
注册



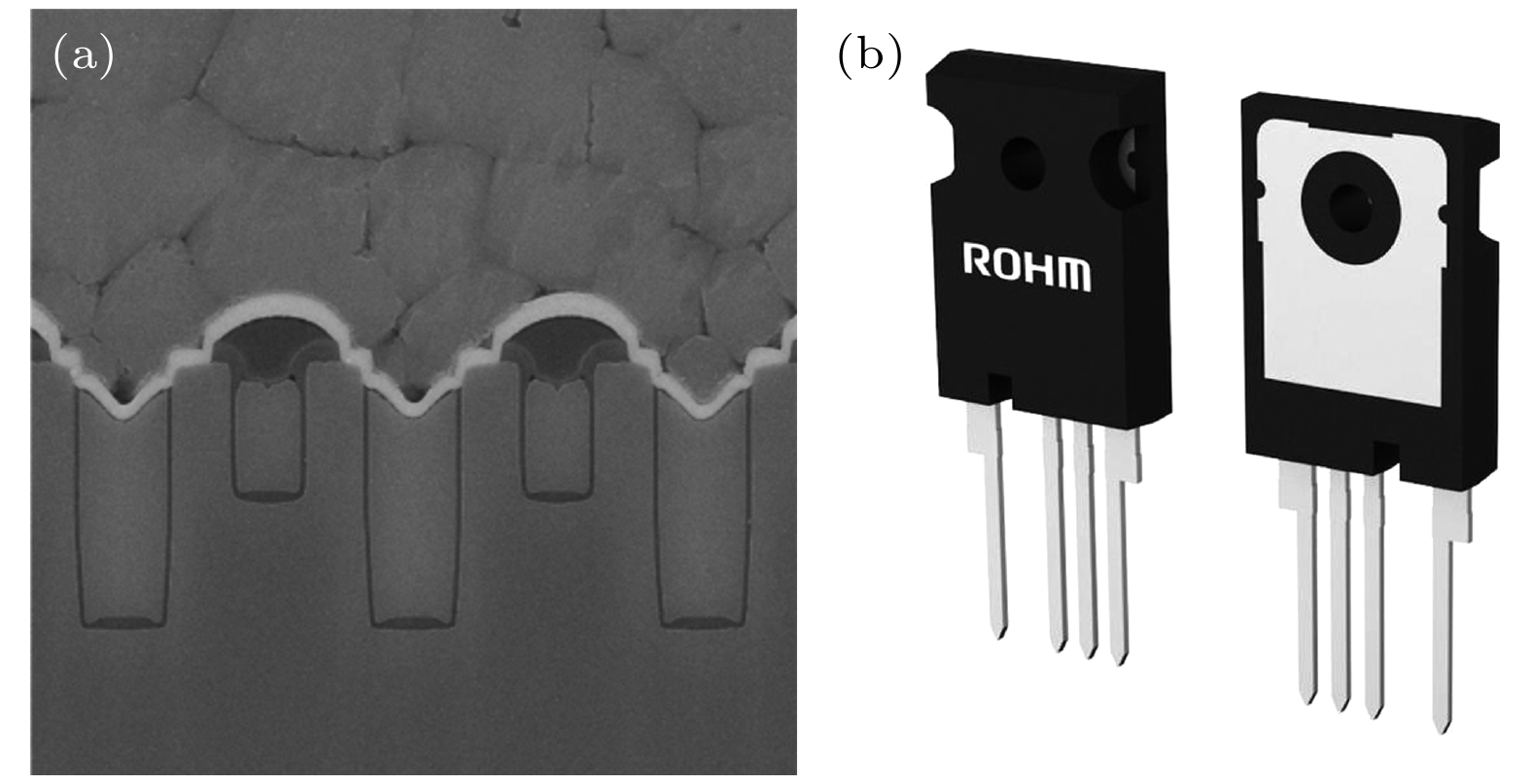
 下载:
下载: