-
石墨烯是一种由单层碳原子以sp2方式键合形成的二维蜂窝状晶格结构材料[1],具有很高的晶体质量和良好的电学、光学、热学、力学等物理和化学性质[2-5]。石墨烯的制备方法有许多种,其中等离子体增强化学气相沉积(PECVD)是一种先进的薄膜制备技术,它的原理是将电场或磁场加到气相反应过程中,利用形成的等离子体中的高能电子来激活反应气体分子,从而在较低的温度下促进化学反应的发生[6]。其中,射频等离子体增强化学气相沉积(RF-PECVD)结构简单,价格便宜,适用于多种材料的薄膜制备,它可以精确控制薄膜的成分和结构、提高反应速率以及增强薄膜的附着力和致密性[6]。在双频容性耦合等离子体,能够独立控制轰击到基片表面的能量,从而可以缓解薄膜生长时容易出现的不均匀性,减弱沉积过程中的充电效应[7]。Yuan等[8]对13.56 MHz和60 MHz双频电容放电等离子体的特性做出了系统性地研究。他们在较低的压力下实现离子通量和离子轰击能量的独立控制。Su等[9]利用RF-PECVD制备的石墨烯薄片(GE)来提高三元乙丙橡胶(EPDM)基弹性体的介电常数,并获得了较好的成效。Zhang等[10]利用RF-PECVD分析了石墨烯在不同类型基底上的鞘层电场分布、极化和生长状态,发现电场不仅可以帮助石墨烯生长,而且可以在一定程度上抑制石墨烯的生长。
生长薄膜的各个参数会对石墨烯薄膜的品质起到关键的作用[11-13],这些参数包括基底的种类、生长温度、生长时间、放电气压、射频功率和气体流量等[14-20]。通过深入了解各参数对石墨烯成膜过程的影响机制,能够更精准地调控和优化这些工艺参数,进而获得符合预期性能要求的石墨烯薄膜。Subrata等[21]研究了生长温度、放电功率和电极到基底的距离等工艺参数对三维石墨烯生长的影响,发现生长温度的升高有利于在垂直于基底的互连垂直网络中形成稳定的纳米结构,随着距离的增加,垂直片的数量密度减小,尺寸和片间距增大。Guo等[22]提出了PECVD和在催化剂层下生长石墨烯的组合技术,最终在700℃的生长温度下,在石英基底上获得直径为6.35 cm的无转移单层石墨烯膜,比传统的CVD生长石墨烯的温度低250℃。
为了探究石墨烯的生长机理及找到最理想的制备参数,本文选用镍箔作为基底,利用PECVD技术在镍箔上制备石墨烯薄膜,随后对薄膜的形貌和结构表征,分析研究高频功率、放电气压、生长时间、生长温度、气体流量比以及基底种类对石墨烯薄膜生长的影响。
-
制备石墨烯薄膜使用的RF-PECVD设备如图1所示,该系统主要由放电腔室(MPZ)、传送腔室(LL)、LL锁、温度控制器、冷却水循环系统、射频电源、匹配箱、以及气体控制系统,包括真空控制器、气体管线、质量流量控制器(MFCs)和压力控制器(可能和真空控制器是一个)。MPZ室和LL室采用304不锈钢材质。MPZ室是长和宽均为23 cm、高为22 cm的长方体。两个腔室的底面积相同,由中间的LL锁相连接。两个腔室底部均连接抽真空系统,另外,MPZ腔室由涡轮分子泵抽真空,本底气压由离子规测量。等离子体放电在MPZ腔室进行,其顶部安装了一个可拆卸的加热器。底部连接节流阀控制器,对流计,电容压力计和主要气体管线,腔室气压调节范围在0−2 Torr。射频电源包括高频电源和低频电源,其频率连续可调,范围在10 MHz ~ 100 MHz,功率范围0 W−300 W。在MPZ室内有二个平行放置的不锈钢正方形电极板,边长为15 cm,上极板可以在支架上移动,上下极板距离可调,范围是5 mm−50 mm,本文实验的极板间距固定在32 mm。腔室内部连接的气管为T型,质量流量控制器能够控制气体流入腔室的流量,并接入4通道供气体流入,其中甲烷通道最大流量为30 mL/min,氩气最大流量不超过100 mL/min。腔室侧面以及控制面板背面有观察等离子体的观测窗口。
在薄膜生长前要对基底进行预处理,防止污染样品、改善金属基底的表面形貌。实验选择厚度为250 μm的99.5%纯度镍箔作为基底,用细砂纸打磨后,将它浸泡在一定浓度的冰醋酸(CH3COOH:H2O=1:4) 30 min以上,再超声清洗20 min−30 min。最后将基底取出,在一定的氮气氛围下快速干燥后, 放入样品准备室内。
-
图2拉曼光谱显示在生长温度为600℃,生长时间为40 min,甲烷5 mL/min、氩气35 mL/min的条件下的样品结构信息。由图2(a)可以看到,高频功率为100 W时,2D峰几乎消失不见,可能是石墨烯薄膜的结构或者层数发生了变化。当高频功率为200 W和300 W的拉曼光谱显示了三个明显的峰值,分别位于1350 cm−1、1578 cm−1和2700 cm−1。当气压为3 Torr时,如图2(c)所示,石墨烯薄膜的三条特征峰变得更加尖锐,在100 W和200 W时,出现了D’峰、D+G峰和2D’峰,表明样品中存在结构缺陷。为了进一步优化制备石墨烯薄膜的放电参数,将气压提升到5 Torr,从图2(e)可以看出,拉曼光谱的三条石墨烯特征峰更为尖锐,通过计算,生长出2D峰半峰全宽如表1所示,在高频功率为300 W时,2D峰的半峰宽最小(33.6 cm−1),这意味着石墨烯的结晶质量较高,缺陷更少。G峰的峰位在1580 cm−1,但是由于石墨烯薄膜中存在不同类型和大小的晶格缺陷,导致G峰旁边也存在产生于石墨烯的谷内散射过程的D’峰(1619 cm−1),通过计算,ID/ID’的值保持在2.5到3.2之间,石墨烯样品中可能存在较多的边界状缺陷。
I2D/IG比值是石墨烯拉曼光谱分析薄膜质量中的一个关键参数,它可以用来评估石墨烯的石墨化程度以及层数,而D峰与G峰的强度比(ID/IG)常用来表征石墨烯中的缺陷密度和晶粒尺寸La[23]:
其中,λ1表示入射光的波长。晶粒尺寸与ID/IG的值成反比。
研究镍基底上形成的石墨烯的质量和层数与PECVD放电参数的函数关系,如图2所示。能够看到,无论气压为何值,ID/IG的值都随着高频功率的升高而降低,这意味着石墨烯薄膜的缺陷减少,然而,薄膜的缺陷密度随放电气压的升高变化较小。在气压1 Torr、高频功率100 W时,ID/IG最高,此时晶粒尺寸可估计为12.8 nm。气压为1 Torr和3 Torr时,如图2(b)和图2(d),I2D/IG的范围在0.45和0.90之间,这表示石墨烯的厚度在3到10层之间。当气压升到5 Torr时,高频功率大于200 W时,石墨烯薄膜的层数减小。这可以说明,较高的气压以及较大的高频功率有助于形成缺陷少,品质高的石墨烯薄膜。选用高频功率300 W、气压5 Torr作为下组实验的生长参数。
-
作者随后研究了不同生长时间与气体流量比对石墨烯薄膜质量的影响。图3(a)和图3(c)分别显示了在沉积时间20 min和40 min时,不同甲烷/氩气流量的生长石墨烯薄膜的拉曼光谱,依据2.1节的结论,将高频功率固定在300 W,放电气压固定在5 Torr,生长温度为600℃。在这5个光谱中可以清楚地看到D峰、G峰和2D峰。结果表明,在该固定范围内,生长时间以及气体流量比对石墨烯的合成影响较小。值得注意的是,在生长时间40 min、甲烷10 mL/min和氩气30 mL/min的条件下,2D峰相较于其他流量比的条件格外尖锐。图3(b)和图3(d)可以看到,生长时间为20 min时,随着甲烷含量的增加,ID/IG值增大,石墨烯薄膜的缺陷增加,I2D/IG值增大,石墨烯薄膜的厚度减小,这是因为生长石墨烯时,碳的析出量会随着冷却时间的延长而增多,最终导致薄膜片层尺寸减小,边缘缺陷增多。然而,生长时间为40 min时,随着甲烷含量的增加,ID/IG值先减小后增大,在甲烷流量10 mL/min时最低(0.65),I2D/IG值先增大后减小,在甲烷流量10 mL/min时最大(1.72),当甲烷浓度过高时,镍基底溶入并析出过多的碳原子,使得石墨烯厚度增加,缺陷增多。因此在生长时间40 min、CH4/Ar流量比为10:30的条件下,容易获得镍基底上更好质量的石墨烯薄膜。作者选用生长时间40 min,甲烷与氩气流量比为10:30的条件作为下组实验的生长参数。
-
随后在高频功率300 W、放电气压5 Torr、生长时间40 min、气体流量比(CH4:Ar=10:30)的优化生长下,研究了在不同生长温度(300℃、400℃、500℃、600℃)的条件下,在镍基底上生长的石墨烯薄膜的生长情况,其中600℃的样品为2.2节选用的对照组。如图4所示,生长温度对石墨烯薄膜的生长影响较大,生长温度为300℃的拉曼光谱没出现明显的石墨烯特征峰,生长温度为400℃和500℃的拉曼光谱显示了三个略为明显的峰值,且D峰、G峰和2D峰同时变宽,表明石墨烯样品中存在较多的缺陷,这些缺陷可能改变了石墨烯的电子能带结构和晶格振动特性,导致拉曼特征峰的变宽,或者薄膜受到外部应力或内部应变,应力和应变会影响碳原子间的键长和角度,从而改变拉曼散射的频率分布。图4(b)可以看到,生长温度小于600℃时,ID/IG和I2D/IG值都随着生长温度而略微增大,缺陷密度几乎不随生长温度的升高而变化。400℃条件的I2D/IG值接近于0,表明石墨烯薄膜层数较多且存在着较多的缺陷。可能是由于这些生长温度条件下提供的能量过低,导致碳原子的含量过少,刻蚀速率大于其沉积速率,因而无法生长出品质好的石墨烯。作者认为在本工作选定的温度范围内最好的生长温度是600℃。
-
为了进一步判断基底种类对石墨烯薄膜品质的影响,作者在高频功率300 W、放电气压5 Torr、生长时间40 min、气体流量比(CH4:Ar=10:30)、生长温度600℃条件,分别在镍基底和铜基底上制备石墨烯薄膜。结果表明,铜箔和镍箔在PECVD法制备石墨烯时表现出不同的生长特性,镍箔的溶碳能力(2.7%)大于铜箔的溶碳能力(0.04%),因此镍箔生长石墨烯的方式是“溶入−析出”式,而铜箔生长石墨烯主要以“表面吸附成核”的方式[24]。在考虑二者生长模式区别的条件下,图5(a)和图5(b)分别给出了在相同生长条件下(高频功率300 W、气压5 Torr、生长时间40 min、甲烷/氩气流量比为10:30以及生长温度600℃),铜和镍基底上生长石墨烯薄膜的拉曼光谱图和D、G、2D特征峰的强度比图。对这两幅图分析,发现铜基底在此条件下也可以生长品质较好的石墨烯薄膜。但是铜基薄膜的ID/IG值小于镍基薄膜的ID/IG值,表明铜基底生长的石墨烯薄膜品质更佳,铜基薄膜的I2D/IG值小于镍基薄膜的I2D/IG值,表明铜基底生长的石墨烯薄膜厚度更大。
作者对300 W、5 Torr、CH4:Ar=10:30 、40 min、600℃生长条件的两种基底上的样品进行了SEM和TEM表征。图6(a)是铜基底上样品的SEM照片,通过这些照片,可以看到薄膜表面均匀光滑且无杂质,这主要是归功于多个制备参数的共同作用,因此可以得出成功地制备出均匀地石墨烯薄膜的结论。图6中深色条纹是样品的晶畴边界,薄膜的成核位置通常产生在基底的杂质和缺陷等位置,而这些缺陷通常会改变晶体原有的对称方式,产生不同取向的晶态,形成晶畴,因此样品表面的晶界可以验证铜基底石墨烯生长过程为表面成核生长。图6(b)和表2是能谱分析,发现样品中只有碳和铜元素,这意味着该薄膜的成分是纯碳,且碳元素含量较高。图6(c)和图6(d)是该样品的SEM和TEM照片,TEM表征制样时选用了浓度为270 g/L的FeCl3·6H2O溶液对镍基底进行溶解,用去离子水清洗干净后,捞出样品并干燥。从图中可以看到样品表面光滑且均匀,而且呈现为薄的透明柔软片层,符合石墨烯的形貌特点,但同时存在较多褶皱、团聚和杂质。图6(e)展示的是镍基底生长石墨烯薄膜的EDS能谱分析,能够看到除基底的Ni以外没有其他元素的出现,表明该薄膜是由纯碳组成的。表3是该样品的含量分析,结果显示薄膜中碳元素含量较高。
-
本文利用了PECVD的化学气相沉积功能,研究了几个重要的制备工艺(包括高频功率、放电气压、气体流量比、生长时间、生长温度和基底种类)对镍基底上制备的石墨烯品质影响。研究发现,生长温度对石墨烯薄膜的合成影响较大,较低的生长温度无法生长出品质好的石墨烯薄膜。当高频功率较低时石墨烯的缺陷较多,薄膜的厚度随着高频功率的增加而减小。气压对石墨烯薄膜的生长影响较小,在3 Torr和5 Torr的条件下石墨烯样品中可能存在着较多的边界状缺陷。甲烷含量过多时,由于镍基底吸收并析出过多的碳原子,导致石墨烯薄膜的缺陷程度较大,薄膜偏厚。CH4:Ar流量比为10:30、生长时间为40 min时,能够生长出品质较好的石墨烯薄膜。因此,在本实验方案下,制备石墨烯薄膜的最优工艺参数为:高频功率300 W、气压5 Torr、生长时间40 min、CH4:Ar流量比为10:30以及生长温度600℃。相同条件下,镍基底上生长的石墨烯薄膜厚度更小,但是铜基底生长的石墨烯薄膜缺陷更少,品质更佳。
RF-PECVD生长参数对石墨烯薄膜品质的影响
Effect of RF-PECVD Growth Parameters on the Quality of Graphene Films
-
摘要: 对比不同工艺参数条件下生长的石墨烯薄膜的形貌和品质,分别研究了高频功率、放电气压、气体流量比、生长时间、生长温度以及基底种类对双频放电的RF-PECVD制备的石墨烯薄膜品质影响。实验结果表明,石墨烯的缺陷程度随着高频功率的增加而降低,但是薄膜的厚度随着高频功率的增加而减小。在3 Torr 及5 Torr的条件下,石墨烯薄膜存在着较多的边界状缺陷。甲烷/氩气流量比为10:30、生长时间为40 min时,能够生长出品质较好的石墨烯薄膜。生长温度对石墨烯薄膜的生长影响较大,在300℃时,镍基底表面无法生长出石墨烯薄膜,并且生长温度低于600℃时,都无法生长出品质较好的石墨烯薄膜。最后发现,相同的生长条件,在镍基底上生长的石墨烯薄膜厚度更小,但是铜基底生长的石墨烯薄膜缺陷更少,品质更好,这与薄膜在两种基底上不同的生长方式有关。
-
关键词:
- 射频等离子体增强化学气相沉积 /
- 双频放电 /
- 石墨烯薄膜
Abstract: The paper compares the morphology and quality of graphene films grown under different process conditions, and studies the effects of high-frequency power, discharge voltage, gas flow ratio, growth time, substrate temperature and substrate type on the quality of graphene films prepared by RF-PECVD in dual-frequency discharge. The experimental results show that the concentration of defects in graphene decreases with the increase of high-frequency power, but the thickness of the film decreases with the increase of high-frequency power. Under the conditions of 3 Torr and 5 Torr, graphene films may have more boundary defects. When the flow ratio of methane/argon is 10:30 and the growth time is 40 min, graphene films of good quality can be grown. The growth temperature has a great influence on the growth of graphene films, and at 300℃, graphene films cannot grow on the surface of nickel substrates, and when the growth temperature is lower than 600℃, graphene films with better quality cannot be grown. Finally, it is found that under the same growing conditions, the graphene film grown on the nickel substrate is less thick, but the graphene film grown on the copper substrate had fewer defects and better quality, which is related to the different growth modes of the film on the two substrates. -

-
图 2 在气压为(a)1 Torr(c)3 Torr(e)5 Torr,石墨烯薄膜随高频功率演化的拉曼光谱(左边);在气压为(b)1 Torr(d)3 Torr(f)5 Torr,ID/IG和I2D/IG随高频功率的变化图(右边)
Figure 2. Raman spectra of graphene films with high-frequency RF power at pressure (a) 1 Torr (c) 3 Torr (e) 5 Torr (left); ID/IG and I2D/IG with high-frequency RF power at pressure (b) 1 Torr (d) 3 Torr (f) 5 Torr (right)
图 6 石墨烯薄膜的SEM照片。(a)铜基底生长,(c)镍基底生长;石墨烯薄膜的EDS分析,(b)铜基底生长,(e)镍基底生长;石墨烯薄膜的TEM照片,(d)镍基底生长
Figure 6. SEM images of graphene films. (a) Grown on copper substrates, (c) grown on nickel substrates; EDS analysis of graphene films, (b) grown on copper substrates, (e) grown on nickel substrates, TEM images of graphene films, (d) grown on nickel substrates
表 1 气压5 Torr时,2D峰的半峰全宽
Table 1. At pressure of 5 Torr, the half width of the 2D peak
高频功率/W 100 200 300 2D峰半峰全宽 /(cm−1) 35.5 35.2 33.6 表 2 铜基底生长石墨烯薄膜能谱分析
Table 2. Spectroscopy analysis of graphene thin films grown on copper substrates
元素 Wt% At% C 5.68 27.23 Cu 94.32 72.77 表 3 镍基底生长石墨烯薄膜能谱分析
Table 3. Spectroscopy analysis of graphene thin films grown on nickel substrates
元素 Wt% At% C 6.52 26.94 Ni 93.48 73.06 -
[1] Novoselov K S, Jiang D, Schedin F, et al. Two-dimensional atomic crystals[J]. Proceedings of the National Academy of Sciences, 2005, 102(30): 10451−10453 doi: 10.1073/pnas.0502848102 [2] Compton O C, Nguyen S B T. Graphene oxide, highly reduced graphene oxide, and graphene: versatile building blocks for carbon-based materials[J]. Small, 2010, 6(6): 711−723 doi: 10.1002/smll.200901934 [3] Lin Y M, Dimitrakopoulos C, Jenkins K A, et al. 100-GHz transistors from Wafer-Scale Epitaxial Graphene[J]. Science, 2010, 327(5966): 662−662 doi: 10.1126/science.1184289 [4] Pop E, Varshney V, Roy A K. Thermal properties of graphene: Fundamentals and applications[J]. Mrs Bulletin, 2012, 37(12): 1273−1281 doi: 10.1557/mrs.2012.203 [5] Dimitrakakis G K, Tylianakis E, Froudakis G E. Pillared graphene: a new 3-D Network Nanostructure for Enhanced Hydrogen Storage[J]. Nano letters, 2008, 8(10): 3166−3170 doi: 10.1021/nl801417w [6] Abdullah M F, Nazim N J N B, Hussin M R M, et al. Modulated Ar/CH4 plasma by metal shield for enhancing the PECVD growth of vertical graphene[J]. International journal of nanoscience, 2022, 21(04): 2250023 doi: 10.1142/S0219581X22500235 [7] Jeong W, Kim S, Lee Y, et al. Contribution of ion energy and flux on high-aspect ratio SiO2 etching characteristics in a dual-frequency capacitively coupled Ar/C4F8 plasma: individual ion energy and flux controlled[J]. Materials, 2023, 16(10): 3820 doi: 10.3390/ma16103820 [8] Yuan Q H, Xin Y, Yin G Q, et al. Effect of low-frequency power on dual-frequency capacitively coupled plasmas[J]. Journal of Physics D Applied Physics, 2008, 41(20): 205209 doi: 10.1088/0022-3727/41/20/205209 [9] Su J, Li C. Effect of plasma-enhanced chemical vapor deposition (PECVD) graphene content on the properties of EPDM/graphene composites[J]. Journal of Materials Science: Materials in Electronics, 2021, 32(7): 9065−9073 doi: 10.1007/s10854-021-05575-5 [10] Zhang P B, Jiang X Y, Fang X H, et al. Si substrates playing two opposing roles in the process of preparing graphene by PECVD-ScienceDirect[J]. Applied Surface Science, 2020, 501: 144404 doi: 10.1016/j.apsusc.2019.144404 [11] Ghosh S, Ganesan K, Polaki S R, et al. Influence of substrate on nucleation and growth of vertical graphene nanosheets[J]. Applied Surface Science, 2015, 349: 576−581 [12] Wang J, Zhu M, Outlaw R A, et al. Synthesis of carbon nanosheets by inductively coupled radio-frequency plasma enhanced chemical vapor deposition[J]. Carbon, 2004, 42(14): 2867−2872 doi: 10.1016/j.carbon.2004.06.035 [13] Wassei J K, Mecklenburg M, Torres J A, et al. Chemical vapor deposition of graphene on copper from methane, ethane and propane: evidence for bilayer selectivity[J]. Small, 2012, 8(9): 1415−1422 doi: 10.1002/smll.201102276 [14] Cui L F, Chen J T, Yang B J, et al. RF-PECVD synthesis of carbon nanowalls and their field emission properties[J]. Applied Surface Science, 2015, 357(12): 1−7 [15] Kim S Y, Choi W S, Lee J H, et al. Substrate temperature effect on the growth of carbon nanowalls synthesized via microwave PECVD[J]. Materials Research Bulletin, 2014, 58(10): 112−116 [16] Terasawa T O, Saiki K. Growth of graphene on Cu by plasma enhanced chemical vapor deposition[J]. Carbon, 2012, 50(3): 869−874 doi: 10.1016/j.carbon.2011.09.047 [17] Krivchenko V, Shevnin P, Pilevsky A, et al. Influence of the growth temperature on structural and electron field emission properties of carbon nanowall/nanotube films synthesized by catalyst-free PECVD[J]. Journal of Materials Chemistry, 2012, 22(32): 16458−16464 doi: 10.1039/c2jm32263c [18] Kim H K, Mattevi C, Calvo M R, et al. Activation energy paths for graphene nucleation and growth on Cu[J]. Acs Nano, 2012, 6(4): 3614−3623 doi: 10.1021/nn3008965 [19] Regmi M, Chisholm M F, Eres G. The effect of growth parameters on the intrinsic properties of large-area single layer graphene grown by chemical vapor deposition on Cu[J]. Carbon, 2012, 50(1): 134−141 doi: 10.1016/j.carbon.2011.07.063 [20] Davami K, Shaygan M, Kheirabi N, et al. Synthesis and characterization of carbon nanowalls on different substrates by radio frequency plasma enhanced chemical vapor deposition[J]. Carbon, 2014, 72: 372−380 doi: 10.1016/j.carbon.2014.02.025 [21] Subrata G, Polaki S R, Niranjan K, et al. Process-specific mechanisms of vertically oriented graphene growth in plasmas[J]. Beilstein Journal of Nanotechnology, 2017, 8(1): 1658−1670 [22] Guo L C, Zhang Z Y, Sun H, et al. Direct formation of wafer-scale single-layer graphene films on the rough surface substrate by PECVD[J]. Carbon An International Journal Sponsored by the American Carbon Society, Carbon, 2018, 129: 456−461 [23] Cancado L G, Takai K, Enoki T, et al. General equation for the determination of the crystallite size La of nanographite by Raman spectroscopy[J]. Applied Physics Letters, 2006, 88(16): 163106 doi: 10.1063/1.2196057 [24] Lahiri J, Miller T S, Ross A J, et al. Graphene growth and stability at nickel surfaces[J]. New Journal of Physics, 2011, 13(2): 025001 doi: 10.1088/1367-2630/13/2/025001 -


 首页
首页 登录
登录 注册
注册



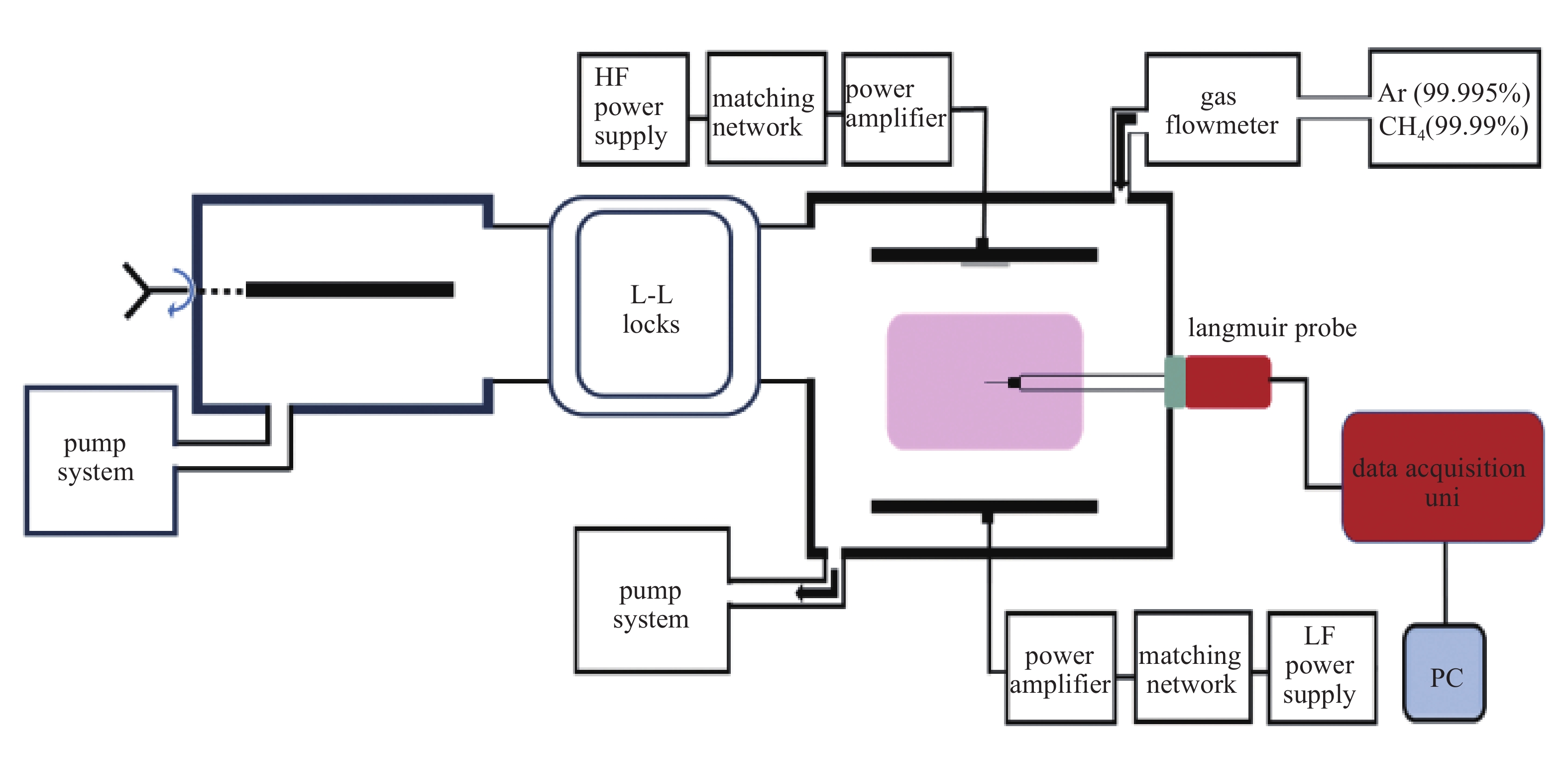
 下载:
下载: