-
GaN作为第三代半导体,是发光二极管(LED)、激光器件、深紫外光电子器件以及高电子迁移率器件(HEMT)制造的关键材料[1-2]。由于缺乏低成本的同质外延衬底,异质外延衬底材质的选择尤其重要。通常被用作衬底的材料有硅、蓝宝石、碳化硅等,其中蓝宝石衬底上生长GaN是最为成熟的技术之一[3]。为了降低GaN与蓝宝石晶格失配(13%)和热失配带来的位错,通常采用“二步法”外延生长。先将蓝宝石高温脱附处理获得纯净的表面,之后在较低的温度(大约600℃)下生长一层成核层,退火后再生长高温层[4]。尽管后期还发展出了图形衬底等技术,但GaN的位错密度依旧高达107−108 cm−2。其中刃型位错包含悬挂键会在GaN的带隙中引入位错能级,吸引导带中的电子形成负电中心并引起位错散射;而螺位错会导致载流子分布不均匀并进而影响复合效率[5]。这对于器件的电学和光学性能都有很大的负面影响。
成核层是制备高质量GaN的关键,成核岛的密度和大小对于生长至关重要[6-8]。研究者已使用多种办法来优化成核层的生长。其中,多步成核法主要依靠多轮交替的低温淀积和退火,来获得成核岛体积比较大的成核层[9-10]。控制反应室压力和气相源Ⅴ/Ⅲ比也是一个重要的办法,因为反应室的压力
和Ⅴ/Ⅲ比可以改变纵向生长和横向合并的速率比[11]。根据气相固相转换理论,低温淀积气相反应时首先在表面形成成核中心[12-13]。因此,在气相反应长出成核层前,反应源首先会在衬底上形成一些成核点,然后这些成核点逐渐长大并形成小岛。成核前衬底表面的情况对于形成最初的成核点有直接影响,可以影响成核位点分布、成核密度等。但迄今为止缺乏相关系统研究。由于衬底表面的微弱差别难以表征,因此相同工艺下制造出的外延片晶体质量往往依赖于随机的初始表面条件。本文提出了一种新的表面初始状态人为可控的生长工艺,在“二步法”生长成核层之前先对衬底表面进行一定的工艺处理,使得衬底表面初始条件人为可控并且可以形成初始的成核点。初始的成核点有利于成核,它能够明显改变成核岛的生长与合并,控制初始成核点成为一种生长控制的方法。理论上,成核岛之间的空间过小不利于诱导位错的湮灭,成核岛的高度过高也不利于合并。此外,岛的晶向倾斜度过大也会影响外延生长后的晶体质量[14-16]。Liyuan Peng等的研究显示,通过在反应室中高温预通入微量源可以显著改善外延片的特性,并在调整优化反应室压力、Ⅴ/Ⅲ以及温度等参数后使得GaN外延片的(002)面X射线衍射(XRD)峰半高宽降低到了130 arcsec[17]。然而其研究内容仅涉及实验上优化预通源参数对GaN生长的影响,缺乏理论机理上的研究。本文立足于生长低温层时预成核工艺对初始成核位点的影响来探究其对外延高质量GaN的理论机理。为此本文研究从表面预成核到低温层生长最后到退火的这段过程,设置对照组来探究这种工艺的机制。
-
采用Aixtron公司的MOCVD设备在蓝宝石衬底上生长制备GaN成核层。首先将衬底置入反应室中,在高温(
1260 ℃)条件下通入H2处理蓝宝石衬底。本实验中为了探究蓝宝石衬底表面高温处理工艺对GaN低温成核的影响,四组样品中蓝宝石衬底全部在高温H2环境中脱附200 s,之后分别对衬底进行了不同的表面预处理。未做任何处理的样品记作样品A;预通入Ga源的样品记为样品B;预通入Ga源和N源的样品记为C;预通入Al源和N源的样品记为D。之后降低反应室温度至630℃生长低温GaN成核层,成核时间为250 s,TMGa(Ga源)和NH3(N源)分别为1000 和75 mL/min(标准状态)。再经过线性升温至1135 ℃并保持360 s的高温退火。预处理中所用金属源TMGa或TMAl流量均为10 mL/min,N源流量为2000 mL/min,通源时间皆为5 s。表1列出了各样品对应的高温预处理工艺。 -
光学原位反射谱是MOCVD外延过程中实时监控生长状态的一种重要工具。本实验重点关注初始成核阶段的反射率变化。图1为四组样品在初始成核阶段的原位反射谱。四组样品的低温GaN成核在T0开始,大约历经30 s反射率降低到最低点。图1中可以看出,在低温成核层生长过程中不同样品到最低点的反射率降幅差别很大。假设以一个相对参考量ΔR,A样品反射率降幅较小为6ΔR,B样品降幅明显为28ΔR,C样品降幅几乎为0ΔR,D组降幅最大为67ΔR。如图2可以解释反射率下降的原因。图2(a)点为高温预成核之后,表面存在一些预成核点。图2(b)点处表面低温成核形成GaN小岛,GaN成核小岛的出现提高粗糙度并降低表面的光反射率。随着外延的进行,由于GaN小岛进一步横向扩展并发生合并,表面逐渐变得平整。此外由于平整的GaN反射率也比衬底蓝宝石高。综合几个因素图2(b)点以后表面反射率又重新回升。图2中右侧反射率从图2(a)点到图2(b)点降幅可以反映出成核小岛生长初期的高度与密度等信息。当存在少量小岛时,小岛的高度越高体积越大,反射率降幅越大。
在气相反应中,预成核点周围处在一个相对于裸露衬底更加稳定的位置中,有利于新生成的GaN晶粒集中迁移至此并稳定成核。因此宏观整体上表现出低温成核时可以在预成核点处形成更大的小岛。如图1中B、D样品所示,这些较大的小岛加剧降低反射率。A组由于未进行预成核处理,表面缺少预成核点,气相反应生成的新晶粒难以凝聚在某一个稳定成核点周围逐渐长大,导致成核分布混乱最终小岛的密度很大但体积较小,最终反射率的降幅较小。样品B缺乏N源无法成核,但TMGa会在衬底表面裂解成少量的Ga滴。这些Ga滴在高温阶段以及降温阶段中部分被蒸发。剩余的Ga滴在低温生长成核层时,气相源可在其周围优先长成核点,导致衬底表面粗糙。这个过程也会带来反射率相对于成核前的降低。样品C表面反射率同样品B、D不同但与A类似,降幅几乎为0ΔR,这个现象同Liyuan Peng等的研究结果相符合[17]。由于Ga原子在蓝宝石上的迁移势垒明显小于Al原子且GaN不耐高温(
1260 ℃),推测GaN预成核点在衬底上分布很均匀且受热分解后成核点的大小比B、D样品小,这导致表面粗糙度变化很小,最终其反射率下降非常微弱几乎为0ΔR。另一个原因是同等粗糙度下GaN的反射率比裸片蓝宝石高。当衬底上被淀积了一层GaN以后,GaN较高的反射率抵消了粗糙度上升给表面带来的反射率降低,因此总体而言样品反射率保持不变。样品D使用AlN预成核,由于在蓝宝石(001面)上Al原子相邻位置的扩散势垒很高,高扩散势垒使得即使温度高达1200 ℃下Al原子也难以发生扩散[18]。在蓝宝石衬底上Al原子的扩散长度远小于Ga原子的扩散长度,这导致Al原子倾向于停留在原地聚集更容易成岛[19]。最终AlN成核点在样品表面的分布很不均匀[20]。此外由于AlN晶粒在高温(此时温度为:1260 ℃)的稳定性要远高于GaN[21],经过高温D组可以留下较多较大的成核点,其预成核的效果更加显著。所以在低温GaN层生长时,随着成核岛逐渐长大,表面粗糙度变得非常高,造成了图1中D样品反射率降幅最大。综合以上的分析,可以做出总结:反射率在成核初期的降低幅度同GaN小岛的体积与高度直接相关。预成核点大小和稳定性决定了成核初期GaN小岛的大小,在这个初期阶段,小岛越大反射谱的降幅越大。这与本文随后的原子显微镜扫描结果相印证。
-
为了进一步分析,利用原子力显微镜(AFM)对退火后的成核岛形貌特征进行了表征。图3是所有样品表面10 um×10 um的AFM扫描图像。很明显,样品A和样品C表面的三维结构分布均匀。样品B和样品D表面具有较大的三维结构,并且分布不均匀。为了进一步比较GaN小岛的大小,我们使用AFM的三维模式计算出表面成核岛晶粒尺寸。具体方法为选取一定数目的成核岛,除去少数可能对结果影响大的极值后统计得到均值。发现四组样品GaN岛的纵向高度大体都处在70 nm−80 nm这个区间,这可能是当纵向生长使得高度达到一定程度的时候横向生长开始增强。但GaN岛的横向尺寸显示了不同,A、B、C为500−550 nm而D组为700−750 nm。这可能与D组稳定的预成核点有利于吸引其周围晶粒迁移有关。根据成核理论,成核往往优先在台阶、缺陷处[22-23]。无预成核的样品A表面缺少高温成核点,因此低温成核时虽然分布均匀,但是成核的杂乱导致成核稳定性较差。样品B低温成核倾向于在Ga聚集处,Ga原子富集的地区吸引N原子形成较大的核最后逐渐长大,这导致低温成核密度较小,并且低温层表面出现分布不均匀的较大的三维结构。样品C高温下形成GaN预成核点,分布均匀,经过生长低温层,表面形貌比较均匀。样品C的GaN岛密度小于样品A,这是因为样品C的稳定成核点吸引其周围的晶粒迁移到此,导致成核点长大并同时降低了成核密度。样品D的AlN预成核的温度(
1260 ℃),相对AlN单晶生长温度需求的温度(一般1300 ℃以上)要低。Al原子的表面扩散能力比较差,因此成核点的分布很难做到均匀,从而导致低温层表面出现分布不均匀的较大的三维结构,导致样品D的成核岛数量最少且体积最大。 -
为了进一步表征和分析,对所有样品进行了XRD联动扫描(2θ-ω模式)测试。根据晶体衍射理论,样品中存在的倾斜晶体径向分布角度越大,XRD联动扫描衍射峰的半高宽越大。图4是所有样品的XRD联动扫描(2θ角范围:32°~40°)结果。可以看出没有在蓝宝石衬底表面进行预处理的样品(sample A)衍射峰最宽、峰值最低,而经过高温预成核处理的样品衍射峰变窄、峰值变高。另在衍射仪的ω模式下测试摇摆曲线。表2列出了已测试过所有样品的XRD(002)衍射峰半高宽。(002)半高宽由未经任何处理的
1636 arcsec降到B、C、D样品分别为1117 arcsec、1088 arcsec、1187 arcsec。低温成核结晶质量得到很大的提升。样品B、C、D三组的成核岛密度差距很大但衍射峰半高宽差别很小,说明样品的晶体质量同成核岛密度无关。分析成核的演变规律,我们认为这种晶体质量的显著提升源于预成核点改变了衬底表面的初始条件。预成核点的存在可对后续的晶体质量造成巨大影响。根据一些学者总结过的外延成核的演变规律,在低温成核阶段中GaN几乎不逞现出晶体状态,此时低温层存在大量的倾斜GaN小岛。之后的退火阶段中,立方GaN(cubic-GaN)分解逐渐重结晶转变为六方GaN(hexagonal-GaN)。由于分解从GaN小岛的边缘开始逐渐向内部蔓延,我们推测处在GaN小岛内部中心位置的面缺陷仍然存在。 这些残存的晶向倾斜部分仍会引导接下来的生长并容易造成GaN内部的堆垛层错,并进而降低外延晶体质量[24]。当高温预成核后,人为淀积的初始预成核点有很好的晶体质量,其晶向与蓝宝石衬底匹配度非常高[25],在预成核点处生长有助于解决GaN小岛的面缺陷问题。可以使用“理想晶体柱”模型来描述这一问题[25]。如图5(a)图所示,直接生长低温成核层时,由于成核的随机性大和结晶晶向分布杂乱,存在大量的初始倾斜的“晶体柱”[24-26]。而在高温预成核的过程中由于热稳定性的差别,部分与蓝宝石(001)晶向不匹配的“晶体柱”由于稳定性差开始出现分解并重结晶成晶体质量较好的GaN, 从而改善了这些“晶体柱”的取向,最终获得了晶向较规整并与蓝宝石(001)晶向匹配的初始“晶体柱”[27-28],如图5(b)图所示。这些与蓝宝石晶向匹配的初始“晶体柱”在外延过程中有利于均匀控制淀积生长的方向,减小堆垛层错带来的面缺陷。
-
本文研究了蓝宝石衬底高温预成核对低温层生长的影响,发现高温预处理工艺可以降低成核岛的密度并且提高成核的晶体质量。原位反射谱显示初始表面存在的预成核点能增大成核过程表面粗糙度,在低温成核阶段这些成核点非常有利于吸引其周围的新生成的GaN晶粒凝聚,导致成核主要发生在预成核点处。使用AFM观察表面形貌显示预成核可以减小成核岛密度并增大体积。各组预成核样品之间的横向对比由预通源的不同造成。Ga原子在蓝宝石上的迁移势垒明显小于Al原子,这导致GaN成核点比AlN成核点分布更加均匀。此外GaN预成核样品中由于热分解导致成核点体积大大减小,这导致其成核岛密度大且体积小。反之AlN预成核样品成核点稳定性强且分布最不均匀导致成核岛密度最小且体积最大。而使用TMGa预处理的成核岛密度、体积在前两者之间。XRD显示预成核对于改善成核层的晶体质量有显著作用,使得(002)面衍射峰半高宽从
1636 arcsec降低到了1100 arcsec左右。XRD显示晶体质量的显著提升可以归因于高温预成核处理能有效改善低温GaN成核岛晶向分布杂乱的问题。但使用TMGa预处理的样品由于缺少N源无法高温成核所以仍需进一步探究其机理。本工作结果表明表面高温预成核处理工艺可使得初始成核变得可控,有利于控制成核的密度和外延晶向,这将有利于诱导位错的大角度转弯湮灭,从而做进一步探究。
预成核对蓝宝石衬底上生长氮化镓低温层的影响
Influence of Pre-Nucleation on Growth of GaN Low Temperature Layer on Sapphire Substrate
-
摘要: 金属有机物化学气相沉积(MOCVD)技术以气相源的热分解反应作为基础,其适合规模化生产,是现今生长半导体材料的主要制备方式。在MOCVD生长GaN的过程中,衬底表面初始条件直接影响到材料成核与生长,因此对于外延生长非常关键。本论文研究了GaN外延生长过程中蓝宝石衬底的表面预成核工艺对GaN低温成核的影响。通过对比未处理样品和高温预通TMGa、高温预通TMGa和NH3预成核以及高温预通TMAl和NH3预成核的样品上生长的低温层退火后的形貌,我们发现高温预成核形成的成核点有利于吸引其周围气相源并入,并降低成核岛的密度。结合光学实时反射率监测气相沉积中晶粒的成核过程,进一步横向比较可发现由于高温时AlN更稳定,预成核的效果更好,对退火以后GaN小岛形貌影响更加显著。X射线衍射表征成核层的晶体质量,发现预成核工艺可将退火后成核层的(002)衍射峰半高宽从
1636 arcsec降低到最低1088 arcsec。通过对比分析,我们认为高温预成核工艺的优点可能来源于其可以改善成核初期小岛的晶向。这些研究为进一步提高GaN外延质量提供了新的工艺思路。Abstract: Metal-organic chemical vapor deposition (MOCVD) technology is based on the thermal decomposition of gas source, which is suitable for large-scale production and is the main preparation method for growing semiconductor materials. In the process of GaN growth by MOCVD, the initial conditions on the substrate surface directly affect the nucleation and growth of the material, so it is critical for epitaxial growth. In this paper, the effect of sapphire substrate surface prenucleation on GaN nucleation at low temperature during GaN epitaxial growth was studied. By comparing the annealed morphology of the low-temperature layer grown on untreated samples and samples with high temperature prenucleation of TMGa and NH3, and samples with high temperature prenucleation of TMAl and NH3, we found that the nucleation point formed by high temperature prenucleation is conducive to attracting the surrounding gas source into the site and reducing the density of the nucleation island. Combined with optical real-time reflectance monitoring the nucleation process of grains in vapor deposition, a further lateral comparison shows that AlN is more stable at high temperature, and the prenucleation effect is better, which has a more significant impact on the morphology of GaN islets after annealing. The crystal quality of the nucleated layer was characterized by X-ray diffraction, and it was found that the (002) half-height width of the diffraction peak of the annealed nucleated layer could be reduced from1636 arcsec to1088 arcsec. Through comparative analysis, we believe that the advantages of high temperature prenucleation process may come from its ability to improve the crystalline orientation of small islands at the early stage of nucleation. These studies provide new process ideas for further improving the epitaxial quality of GaN.-
Key words:
- GaN nucleation /
- High temperature surface pre-nucleation /
- AlN nucleation /
- Nucleation island /
- MOCVD .
-

-
表 1 各样品高温预处理条件
Table 1. High temperature pretreatment conditions for each sample
Sample Pretreatment Time A None None B TMGa
5 sC TMGa+NH3 D TMAl+NH3 表 2 四组样品的XRD(002)衍射峰半高宽
Table 2. XRD (002) peak width at half maximum of four groups of samples
Sample A B C D FWHM(002) arcsec 1636 1117 1088 1187 -
[1] A. Ponce, D. P. Bour, Nitride-based semiconductors for blue and green lightemitting devices, Nature 386 (1997) 351–359. [2] Ambacher O. REVIEW ARTICLE: Growth and applications of group III-Nitrides[J]. Journal of Physics D Applied Physics,1998,31(20):2653−2710 doi: 10.1088/0022-3727/31/20/001 [3] Kozawa T,Kachi T,Kano H,et al. Thermal stress in GaN epitaxial layers grown on sapphire substrates[J]. Journal of Applied Physics,1995,77(9):4389−4392 doi: 10.1063/1.359465 [4] Grandjean N,Massies J,Leroux M. Nitridation of sapphire effect on the optical properties of GaN epitaxial overlayers[J]. Applied Physics Letters,1996,69(14):2071−2073 doi: 10.1063/1.116883 [5] You J H,Johnson H T. Effect of dislocations on electrical and optical properties in GaAs and GaN[J]. Solid State Physics,2009,61:143−261 doi: 10.1016/S0081-1947(09)00003-4 [6] Koleske D D,Coltrin M E,Cross K C,et al. Understanding GaN nucleation layer evolution on sapphire[J]. Journal of crystal growth,2004,273(1-2):86−99 doi: 10.1016/j.jcrysgro.2004.08.126 [7] Luo W,Li L,Li Z,et al. Influence of the nucleation layer annealing atmosphere on the resistivity of GaN grown by metalorganic chemical vapor deposition[J]. Journal of Alloys and Compounds,2015,633:494−498 doi: 10.1016/j.jallcom.2015.01.237 [8] Koleske D D,Coltrin M E,Allerman A A,et al. In situ measurements of GaN nucleation layer decompostion[J]. Applied Physics Letters,2003,82(8):1170−1172 doi: 10.1063/1.1555264 [9] Koleske D D,Coltrin M E,Lee S R,et al. Understanding GaN nucleation layer evolution on sapphire and its impact on GaN dislocation density//solid state lighting and solar energy technologies[J]. SPIE,2008,6841:109−120 [10] Kobayashi J T,Kobayashi N P,Dapkus P D,et al. Initial stages of MOCVD growth of gallium nitride using a multi-step growth approach[J]. MRS Online Proceedings Library (OPL),1997,468:187−191 doi: 10.1557/PROC-468-187 [11] Wang J X,Wang L S,Yang S Y,et al. Effects of V/III ratio on a-plane GaN epilayers with an InGaN interlayer[J]. Chinese Physics B,2013,23(2):026801 [12] Lang T,Odnoblyudov M,Bougrov V,et al. MOCVD growth of GaN islands by multistep nucleation layer technique[J]. Journal of Crystal Growth,2005,277(1-4):64−71 doi: 10.1016/j.jcrysgro.2005.01.055 [13] Yong S W,Lee J,Kim C S,et al. Computational study of adsorption, diffusion, and dissociation of precursor species on the GaN (0 0 0 1) surface during GaN MOCVD[J]. Surface Science,2009,603(4):L31−L34 doi: 10.1016/j.susc.2009.01.008 [14] Contreras O,Ponce F A,Christen J,et al. Dislocation annihilation by silicon delta-doping in GaN epitaxy on Si[J]. Applied Physics Letters,2002,81(25):4712−4714 doi: 10.1063/1.1529309 [15] Peng R,Meng X,Xu S,et al. Study on dislocation annihilation mechanism of the high-quality GaN grown on sputtered AlN/PSS and its application in green light-emitting diodes[J]. IEEE Transactions on Electron Devices,2019,66(5):2243−2248 doi: 10.1109/TED.2019.2904110 [16] Mathis S K,Romanov A E,Chen L F. Modeling of threading dislocation reduction in growing GaN layers[J]. Journal of Crystal Growth,2001,231(3):371−390 doi: 10.1016/S0022-0248(01)01468-3 [17] Peng L,Liu S,Yang J,et al. The influence of residual GaN on two-step-grown GaN on sapphire[J]. Materials Science in Semiconductor Processing,2021,135(2):105903 [18] Chang H,Chen Z,Li W,et al. Graphene-assisted quasi-van der waals epitaxy of AlN film for ultraviolet light emitting diodes on nano-patterned sapphire substrate[J]. Applied Physics Letters,2019,114(9):091107 doi: 10.1063/1.5081112 [19] Sun,Xiaojuan,Li,et al. In situ observation of two-step growth of AlN on sapphire using high-temperature metal–organic chemical vapour deposition.[J]. Crystengcomm,2013,15(30):6066−6073 doi: 10.1039/c3ce40755a [20] Lorenz K,Gonsalves M,Kim W,et al. Comparative study of GaN and AlN nucleation layers and their role in growth of GaN on sapphire by metalorganic chemical vapor deposition[J]. Applied Physics Letters,2000,77(21):3391−3393 doi: 10.1063/1.1328091 [21] Sarney W L,Salamanca-Riba L,Hossain T,et al. TEM study of bulk AlN growth by physical vapor transport[J]. MRS Online Proceedings Library (OPL),1999:595 [22] Gian W,Skowronski M,Rohrer G S. Structural defects and their relationship to nucleation of GaN thin films[J]. Mrs Online Proceedings Library Archive,1996:423−475 [23] Kumaresan V,Largeau L,Madouri A,et al. Epitaxy of GaN nanowires on graphene[J]. Nano Letters,2016:4895−4902 [24] Lang T,Odnoblyudov M,Bougrov V,et al. Morphology optimization of MOCVD-grown GaN nucleation layers by the multistep technique[J]. Journal of Crystal Growth,2006,292(1):26−32 doi: 10.1016/j.jcrysgro.2006.04.095 [25] Shang L,Xu B,Ma S,et al. The surface morphology evolution of GaN nucleation layer during annealing and its influence on the crystal quality of GaN films[J]. Coatings,2021,11(2):188 doi: 10.3390/coatings11020188 [26] Morita D,Fujioka A,Mukai T,et al. Dislocation reduction mechanism in low-nucleation-density GaN growth using AlN templates[J]. Japanese Journal of Applied Physics,2007,46(5A):2895−2900 doi: 10.1143/JJAP.46.2895 [27] Kushvaha S S,Kumar M S,Maurya K K,et al. Highly c-axis oriented growth of GaN film on sapphire (0001) by laser molecular beam epitaxy using HVPE grown GaN bulk target[J]. AIP Advances,2013,3(9):092109 doi: 10.1063/1.4821276 [28] Akasaki I,Amano H,Koide Y,et al. Effects of ain buffer layer on crystallographic structure and on electrical and optical properties of GaN and Ga1-xAlxN (0 < x ≦ 0.4) films grown on sapphire substrate by MOVPE[J]. Journal of Crystal Growth,1989,98(1-2):209−219 doi: 10.1016/0022-0248(89)90200-5 -


 首页
首页 登录
登录 注册
注册



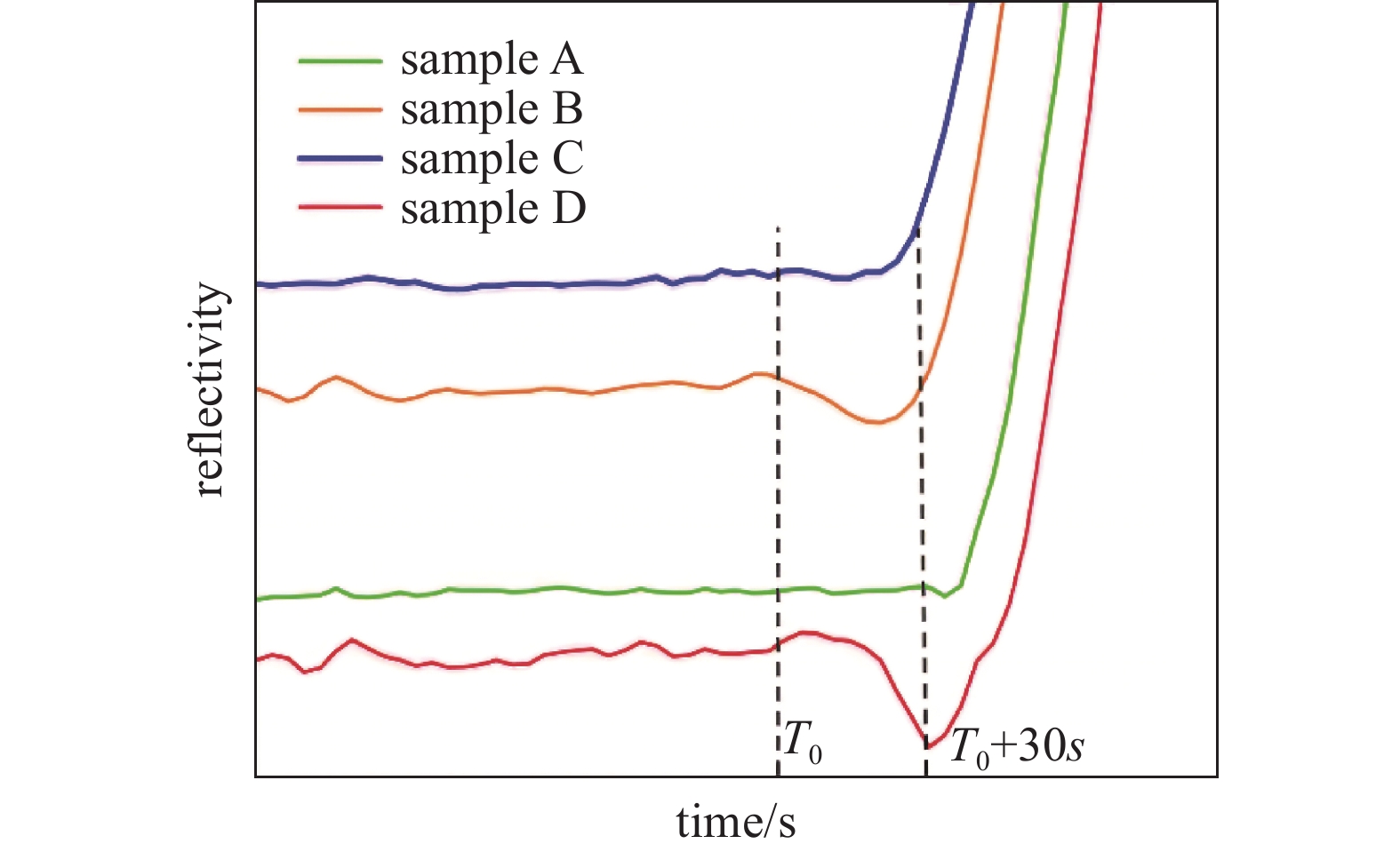
 下载:
下载: