-
PET具有优良的耐化学性、重量轻、不易破碎、携带方便等特点,使用过后仍可以回收再造,是一种经济便捷、可循环使用的包装材料,常用于食品、饮料和药品包装[1-2]。与此同时,包装材料需要具有较好的气体阻隔性能,以保证包装内产品不会发生变质,PET材料虽有一定的阻隔性能,仍不足以满足特殊食品、药物等产品储存的阻隔要求[3]。为了改善PET材料阻隔性,拓宽PET材料在包装领域的应用范围,国内外学者开展了大量有关PET阻隔改性研究。目前报道的阻隔改性方法主要有表面蒸镀、共混改性、多层复合薄膜改性、纳米材料改性以及表面涂层改性等[4]。
利用等离子体化学气相沉积技术(PECVD)在PET包装材料表面沉积一层或多层高阻隔薄膜,可有效地提高气体阻隔性能,该方法效率高、成本低,被认为是表面涂布改性的良好解决方案[5-6]。李景等[7]利用偏压/射频耦合PECVD在PET筒内壁沉积DLC薄膜,O2阻隔率可提高80倍,但沉积速率相对较低。董茂进等[8]利用卷对卷中频PECVD系统在PET基表面沉积SiOxCyHz薄膜,其水蒸气透过率可低于1×10−2 g·m−2·d。JEONG C H等[9]采用传统的射频平面电感耦合(ICP)等离子体驱动模式在聚合物基底沉积SiO2作为扩散屏障,使得PET水蒸气透过率从54.1 g·m−2·d降低至0.3 g·m−2·d。Bahroun K等[10]采用PECVD工艺在PET基底表面无机阻隔层(SiOx)和有机中间层(SiOCH)的双层阻隔结构,双层结构分别采用脉冲微波(MW)和电容耦合(CCP)等离子体驱动模式,发现涂敷改性后的PET薄膜O2透过率从68.51 mL·m−2·d降低至约1.43 mL·m−2·d,同时发现SiOCH有机中间层表面形貌对SiOx无机阻隔层阻隔性发挥有较大影响。Nakaya M等[11]通过CCP-PECVD技术在PET包装瓶内涂覆DLC薄膜,研究电源频率对薄膜沉积和性能的影响,发现同等条件下较低的电源频率激发高电子密度和离子冲击,使DLC结构更为致密,从而获得较高的气体阻隔性能。Dangnan F等[12]通过微波PECVD技术在聚合物表面涂覆DLC薄膜,成功将聚合物水蒸气阻隔率改善了约70%,同时还发现氮(N)元素的掺杂显著影响薄膜性能。Alizadeh P等[13]通过脉冲微波PECVD技术在PET表面沉积SiOx和SiOCH涂层,发现单体比例是影响薄膜沉积速率的重要影响因素,SiOx涂层阻隔性能明显优于SiOCH涂层。
以往的研究证实PECVD技术在聚合物基底表面沉积SiOx或DLC薄膜可明显改善阻隔性能,同时等离子体驱动电源频率、反应单体比例等参数对薄膜沉积和性能有明显影响,但对阻隔薄膜沉积和性能比较研究较少。微波驱动的等离子体源,可产生高密度等离子体,有利于薄膜高速沉积,有利于未来的工业生产效率[14-15]。本文以12.5 μm厚的PET薄膜为基底,通过微波PECVD技术在其表面沉积一定厚度的SiOx和DLC薄膜,在一定制备工艺下,当反应单体比例调节至合适参数,PET复合薄膜氧气透过率可由空白PET薄膜的130 mL·m−2·d降低至0.58 mL·m−2·d,该研究发现可为高阻隔PET复合薄膜制备技术的开发提供有益参考,也为实现高阻隔PET材料工业化规模的生产,提供更多可能的技术路线。
-
本文采用的微波PECVD沉积设备由微波传输系统、真空抽取装置、进气系统及循环冷却装置构成,图1为微波PECVD沉积设备示意图。其中,微波传输系统由微波源和传输天线组成,微波源(德国MUEGGE公司)的工作频率为2.45 GHz,由矩形波导管传播,经模式转换器后转变为圆波导,在谐振腔内激发气体放电产生等离子体,传输天线为圆柱状,由直径为Φ12 mm的铜管和二个同心但不同直径的石英管(铜管内直径Φ6 mm,铜管外直径Φ13 mm)组成。真空系统包含机械泵(上海慕泓真空设备有限公司)和真空计(北京泰科诺科技有限公司)。进气系统包含进气管道(内石英管)及流量控制模块(美国MKS公司)。循环冷却装置为冷风式工业冷水机(北京九州同城科技有限公司),水温控制的范围是16℃−24℃。
-
微波PECVD薄膜沉积工艺包括“清洁试验空间−试样准备−沉积−取样”几个步骤,按具体如下流程进行:
(1)清洁。用细砂纸清理沉积腔室和石英天线后,再用酒精进行擦净,避免杂质干扰。
(2)试样准备。准备大小合适的PET(厚度12.5 µm)薄膜样品,用无纺布擦净。
(3)预处理及薄膜沉积。将反应腔室抽真空至本底气压(4.0 Pa),Ar(纯度99.999%)放电预处理10 s。气压稳定后,按表1所示参数,分别通入反应单体待气压稳定后,开始薄膜沉积并观察放电稳定性,记录实验过程各项参数,直至沉积结束。其中,用于SiOx薄膜沉积的反应单体为硅源HMDSO(纯度99.999%)和O2(纯度99.9999%),DLC薄膜沉积的单体为碳源C2H2(纯度99.999%)和放电Ar(纯度99.999%)。
(4)取样。封装好样品,以备后续测试使用。
-
采用Thermo SCIENTIFIC傅里叶变换红外光谱仪(FTIR)对SiOx薄膜进行结构分析,测试样品基底为透明溴化钾(KBr)压片,测试波数范围是4000~400 cm−1,分辨率为±4 cm−1;
X射线光电子能谱(XPS)测试使用AXIS Ultra设备(英国Kratos 公司),使用带单色器铝靶X 射线源,功率225 W,为避免污染,所有样品均采用Ar离子对样品表面剥离处理。
薄膜微观形貌采用美国Veeco DI INNOVA系列原子力显微镜(AFM)表征。薄膜样品沉积基底为单晶硅(Si)片,测试在大气环境中开展,采用轻敲模式,探针弹性模量为300 kHz,扫描速率为1024 μm/s,扫描频率为1 Hz,扫描区域为2 μm×2 μm。
薄膜厚度采用Veeco dektak150表面轮廓仪进行测量。薄膜样品沉积基底为贴附有聚酰亚胺胶带的载玻片(帆船牌,厚度1 mm−2 mm,面积25.4×76.2 mm),每个样品的扫描长度为1000 µm,扫描时间是20 s,测量厚度的最大范围为65.5 μm。选取沿样品径向分布的三个固定位置,取平均值作为样品薄膜的厚度测量结果;
通过MOCON氧气透过仪测试薄膜氧气透过率。测量时,测试腔内将待测薄膜分为上下两个密封空间,分别通入纯度为99.999%的氮气(N2)和99.9%的氧气(O2),通过传感器探测N2中O2的含量,由此判断薄膜的透氧性能。测试样品面积50 cm2,温度23℃,相对湿度0%。
-
为研究不同单体比例下沉积的薄膜结构有何异同,首先利用傅里叶红外光谱(FTIR)分别对DLC薄膜和SiOx薄膜进行结构分析。图2(a)是不同单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)制备的DLC薄膜对应的FTIR图。图谱显示在1100 cm−1波数左右观察到对应直链C-C键和(CH3)2CHR伸缩振动特征峰,在2800~3100 cm−1波数范围内,观察到对应CHx基团伸缩振动特征峰。对2800~3100 cm−1波数范围内的特征峰进行分峰拟合分析,结果如图2(b)、图2(c)和表2所示,表明实验沉积的DLC薄膜中碳(C)、氢(H)元素键合主要是以sp2,sp3杂化的形式存在,放电气体Ar比例较高时,DLC薄膜中sp3杂化的含量也增加,由于Ar放电可辅助C2H2电离或离解,反应单体活性增强,使薄膜中sp3含量有所增加。图3(a)是不同单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)制备的SiOx薄膜所对应的FTIR谱图。图谱显示当单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为1:2时,可以观察到1260 cm−1处的SiCH3的对称伸缩振动峰,单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为2:1时,1260 cm−1处的吸收峰几乎消失,这是由于反应气体中O2含量增加,HMDSO单体裂解产生的C、H基团氧化程度提高,薄膜中C、H元素含量减少,O元素含量增加,制备的SiOx薄膜纯度提高。此外,观察图中1034 cm−1处的Si-O-Si特征峰,单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)增加,Si-O-Si特征峰向高波数方向偏移,这与SiOx薄膜中的结构组分发生变化有关,当薄膜中的主要成分由非对称结构向较为对称的结构转变时,Si-O-Si特征峰的位置会发生偏移。有研究提出SiOx存在三种不同结构:在1135 cm−1处的波峰归因于较大角度的Si-O-Si键的伸缩振动,代表笼状结构的SiOx;在1063 cm−1处的波峰归因于较小角度的Si-O-Si键的伸缩振动,代表网状结构的SiOx;在1023 cm−1处的波峰归因于更小角度的Si-O-Si 键的伸缩振动,代表线性或环状结构的SiOx[16]。依据此研究,对950 cm−1~1250 cm−1范围内的Si-O-Si特征峰进行分峰拟合分析,结果如图3(b)、图3(c)和表3所示,结果表明反应气体中氧气含量的增加,网状结构和笼状结构的成分有所增加,而线性结构的成分相对较少,说明薄膜由线性结构转向网状SiOx结构。为进一步分析薄膜的元素组成和键合方式,分别对DLC和SiOx薄膜样品进行XPS分析测试,所有测试样品均采用Ar离子对样品表面进行剥离处理。图4(a)是C2H2和Ar比例为6:1时制备的DLC薄膜XPS图谱,结果显示薄膜主要元素成分为C元素(含量为98.96%),另还有极少量的O、Si杂质元素。285 eV附近出现的特征峰为C1s,研究表明该位置特征峰主要包含284.8 eV峰位对应sp2杂化形式的C元素,285.3 eV峰位对应sp3杂化形式的C元素以及287.5 eV对应的C、O元素键合相关的结构[17-18]。对C1s进行分峰拟合分析,发现DLC薄膜中的C元素主要是以C=C键和C-C(H)键的形式存在(图4(b)),其中sp3杂化C-C(H)键对应的波峰面积百分比为47.8%,与FTIR分析结果相符。图5(a)是O2和HMDSO比例为2:1时制备的SiOx薄膜XPS图谱,结果表明薄膜主要元素成分为Si和O元素(含量分别为29%和69.8%)以及含量极少的C元素(1.2%),已有研究表明103 eV附近的Si2p特征峰一般含有100.3 eV对应 的SiC、101.3 eV对应的SiOxCy、102.8 eV对应的SiOx以及103.5 eV对应的SiO2[19-20]。对Si2p进行分峰拟合分析,发现SiOx薄膜中的Si元素主要是以SiOxCy和SiOx结构形式存在(图5(b)),对应的波峰面积百分比分别73.2%和26.8%。
-
图6(a)和图6(b)分别是单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为1:1和6:1时制备的DLC薄膜AFM图,图7(a)和图7(b)分别是单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为1:2和2:1时制备的SiOx薄膜AFM图。由图4可知,对DLC薄膜沉积而言,单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为1:1时,薄膜颗粒相对较大,颗粒间间隙明显,薄膜的致密性和平整度欠佳,不利于薄膜的阻隔性能,随着单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)中C2H2含量增加,DLC薄膜变得更加致密,薄膜表面也趋于平整,光滑致密的薄膜有利于发挥阻隔气体的作用。同样地,图7也揭示了SiOx薄膜微观形貌与制备工艺中的单体比例($ \mathit{\mathrm{\mathit{V}}}_{\mathrm{O}_2} $ :VHMDSO)有关,O2浓度较高时,薄膜颗粒较大,大的球形颗粒间存在孔隙,会引起一些小分子的透过,影响薄膜的阻隔性发挥。 -
在实际工业生产中,薄膜的沉积速率关系着生产效率,本文也对沉积速率进行比较研究,对应工艺参数下的沉积速率和氧气透过率如表4所示。结果表明,利用微波PECVD技术在PET薄膜表面沉积一定厚度的阻隔薄膜,可明显改善其氧气阻隔性能,DLC/PET和SiOx/PET复合薄膜阻隔性均与单体比例有关,DLC薄膜的沉积速率相对较快。在本文实验条件下,当单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为6:1时,DLC/PET复合薄膜的氧气透过率可由空白PET薄膜的130 mL·m−2·d降低至0.58 mL·m−2·d,阻隔改性作用远远好于单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为1:1时,这与不同单体比例下制备的DLC薄膜结构和表面颗粒的致密性差异有关,单体中混入少量Ar,可辅助反应单体C2H2离解,增强反应活性,有利于形成稳定的薄膜结构和致密的表面形貌,但当Ar含量过高时,由于其刻蚀作用,对形成薄膜的致密性产生影响,一定程度上影响其气体阻隔性。对SiOx/PET复合薄膜而言,反应单体中氧气浓度的不同也会影响薄膜阻隔性能,单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为2:1时,SiOx/PET复合薄膜氧气透过率达到3.69 mL·m−2·d,而当氧气浓度较低时,阻隔性改善欠佳,该结果与前文薄膜结构和表面形貌分析结果相符,O2含量较高时,沉积的SiOx薄膜向网状和笼状结构含量升高,使得薄膜的气体阻隔性有所改善。 -
本文通过微波PECVD技术制备高阻隔DLC/PET和SiOx/PET复合薄膜,比较不同单体比例下两种复合薄膜的结构形态和阻隔性表现,可得出以下结论:
(1)DLC/PET复合薄膜的氧气透过率可低至0.58 mL·m−2·d,远远低于空白PET薄膜的130 mL·m−2·d 。C2H2和Ar混合气体制备DLC/PET复合薄膜,少量Ar有利于反应气体C2H2离化,增强反应活性,DLC薄膜致密、平整,Ar含量增加,其刻蚀作用影响薄膜致密性,不利于阻隔性发挥。
(2)通过在PET 表面沉积SiOx薄膜也可改善其阻隔性,氧气透过率可达3.69 mL·m−2·d。反应单体中O2浓度较高时,薄膜内部结构趋于更稳定的网状和笼状结构,更有利于 SiOx薄膜的阻隔性能。
(3)本文工艺条件下SiOx/PET和DLC/PET两种复合薄膜比较而言,DLC薄膜沉积速率更具优势,一定工艺条件下DLC/PET复合薄膜阻隔性表现也更为突出,这对未来工业化应用的生产效率尤为重要。
(4)本文提出的微波PECVD技术高阻隔复合膜制备方法,工艺流程简单、制造成本较低,在高阻隔包装材料领域具有较大的潜在应用优势,可为高阻隔PET基包装材料的生产开发提供技术路线参考。
微波PECVD技术制备高阻隔PET复合薄膜研究
Preparation of High Barrier PET Composite Thin Films by Microwave PECVD Technology
-
摘要: 文章通过在聚对苯二甲酸乙二醇酯(PET)基底表面沉积一定厚度的高阻隔薄膜,改善PET材料阻隔性能。采用微波等离子体化学气相沉积(PECVD)技术在PET基底上沉积氧化硅(SiOx)和类金刚石(DLC)阻隔薄膜,研究不同单体比例制备的薄膜结构、微观形貌和阻隔性能有何异同。结果表明单体比例的不同,显著影响SiOx和DLC薄膜的结构、微观形貌和阻隔性能。一定工艺条件下,SiOx和DLC薄膜均能充分发挥各自的阻隔作用,降低PET材料的氧气(O2)透过率。采用乙炔(C2H2)和氩气(Ar)混合气体制备DLC薄膜,少量Ar有利于反应单体离解,同时对薄膜表面刻蚀作用较弱,薄膜沉积速度快,表面颗粒致密,可有效阻挡气体渗透,制得的DLC/PET复合膜的氧气透过率可低至0.58 mL·m−2·d,远低于未表面涂布改性PET薄膜的130 mL·m−2·d。以六甲基二硅氧烷(HMDSO)和氧气(O2)为反应单体制备SiOx薄膜,O2比例较高时,薄膜中的硅(Si)、氧(O)元素的键合趋于网状结构和笼状结构,增加了气体的扩散难度,所制备的SiOx/PET复合膜氧气透过率可低至3.69 mL·m−2·d。研究提出的利用微波PECVD技术在PET基底上沉积阻隔性SiOx或DLC阻隔薄膜,可为高阻隔PET复合薄膜的生产工艺提供有益的参考。
-
关键词:
- 微波等离子体增强化学气相沉积 /
- 阻隔性能 /
- 氧化硅 /
- 类金刚石 /
- 聚对苯二甲酸乙二醇酯
Abstract: In this paper, a high barrier film of a certain thickness was deposited on the surface of the PET substrate to improve the barrier performance of PET films. The microwave PECVD technology was used to deposit SiOx and DLC barrier films on PET substrates. The differences in structure, microstructure, and barrier properties of deposited films with different monomer ratios were studied, and the barrier properties of SiOx/PET and DLC/PET composite films were compared. The results indicate that the different monomer ratios significantly affect the structure, microstructure, and barrier properties of SiOx and DLC films. Under certain process conditions, both SiOx and DLC films can fully exert their respective barrier effects, reducing the oxygen (O2) transmittance of PET materials. DLC thin films were prepared using a mixture of acetylene (C2H2) and argon (Ar) gas. A small amount of Ar was beneficial for the dissociation of reactive monomers, while the etching effect on the surface of the film was weak. The film deposition speed was fast, and the surface particles were dense, which could effectively block gas permeation. The oxygen gas permeability of the DLC/PET composite film prepared can be as low as 0.58 mL·m−2·d, far lower than the 130 mL·m−2·d of unmodified PET film. SiOx thin films were prepared using hexamethyldisiloxane (HMDSO) and oxygen (O2) as reaction monomers. When the O2 ratio was high, the bonding of silicon (Si) and oxygen (O) elements in the films tended towards a mesh-like and cage-like structure, increasing the difficulty of gas diffusion. The oxygen transmittance of the SiOx/PET composite film prepared can be as low as 3.69 mL·m−2·d. This study proposes the application of microwave PECVD technology to deposit barrier SiOx and DLC barrier films on PET substrates, providing useful references for the production process of high barrier PET composite films. -

-
图 2 不同单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)制备的DLC薄膜FTIR分析。(a)不同单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)制备的DLC薄膜FTIR图谱,(b)单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为1:1时的分峰拟合分析,(c)单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为6:1时的分峰拟合分析Figure 2. FTIR analysis of DLC films prepared with different monomer ratios (
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr). (a) FTIR spectra of DLC films prepared with different monomer ratios ($ \mathit{\mathrm{\mathit{V}}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr), (b) Peak fitting analysis when the monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr) was 1:1, (c) Peak fitting analysis when the monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr) was 6:1图 3 不同单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)制备的SiOx薄膜FTIR分析。(a)不同单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO制备的SiOx薄膜FTIR图谱,(b)单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为1:2时的分峰拟合分析,(c)单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为2:1时的分峰拟合分析Figure 3. FTIR analysis of SiOx films prepared with different monomer ratios (
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO). (a) FTIR spectra of SiOx films prepared with different monomer ratios ($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO), (b) Peak fitting analysis when the monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO) was 1:2, (c) Peak fitting analysis when the monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO) was 2:1图 4 单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为6:1时制备的DLC薄膜XPS图谱。(a)DLC薄膜XPS图谱,(b)C1s特征峰分峰拟合分析Figure 4. XPS spectra of DLC films prepared at a monomer ratio of 6:1 (
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr). (a) XPS spectra of DLC films, (b) Peak fitting analysis of C1s characteristic peaks图 5 单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为2:1时制备的SiOx薄膜XPS图谱。(a)SiOx薄膜XPS图谱,(b)Si2p特征峰分峰拟合分析Figure 5. XPS spectra of SiOx films prepared at a monomer ratio(
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO) of 6:1. (a) XPS spectra of SiOx films, (b) Peak fitting analysis of Si2p characteristic peaks图 6 不同单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)制备的DLC薄膜AFM图(基底为Si片)。(a)单体比例($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为1:1时的DLC薄膜AFM图,(b)单体比例($ \mathit{\mathit{\mathrm{\mathit{V}}}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr)为6:1时的DLC薄膜AFM图Figure 6. AFM images of DLC films prepared with different monomer ratios (
$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr) (On the surface of monocrystalline silicon). (a) AFM image of DLC films prepared at a monomer ratio ($ \mathit{\mathit{\mathrm{\mathit{V}}}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr) of 1:1, (b) AFM image of DLC films prepared at a monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr) of 6:1图 7 不同单体比例(
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)制备的SiOx薄膜AFM图(基底为Si片)。(a)单体比例($ \mathit{\mathrm{\mathit{V}}}_{\mathrm{O}_2} $ :VHMDSO)为2:1时的SiOx薄膜AFM图,(b)单体比例($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO)为1:2时的SiOx薄膜AFM图Figure 7. AFM images of SiOx films prepared with different monomer ratios (
$ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO) (On the surface of monocrystalline silicon). (a) AFM image of SiOx films prepared at a monomer ratio ($ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO) of 2:1, (b) AFM image of SiOx films prepared at a monomer ratio ($ \mathit{\mathrm{\mathit{V}}}_{\mathrm{O}_2} $ :VHMDSO) of 1:2表 1 预处理及薄膜沉积工艺参数
Table 1. Pretreatment and thin film deposition process parameters
工艺 参数 数值 预处理 连续微波功率 400 处理时间 10 s 薄膜沉积 脉冲微波功率 1500 w 占空比(ton:toff) 4:40 ms 单体 $ \mathit{\mathrm{\mathit{V}}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr1:1,1:6 $ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO1:2,2:1 气体压强 20 Pa 表 2 CHx特征峰分峰拟合结果
Table 2. CHx characteristic peak sub peak fitting results
单体比例 sp3CH2
A1(2855 cm−1)sp3CH3
A2(2875 cm−1)sp3CH2
A3(2925 cm−1)sp2CH
A4(2960 cm−1)sp2CH2
A5(2990 cm−1)$ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr =1:10.1 0.24 0.3 0.225 0.135 $ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr =6:10.2 0 0.28 0.52 0 表 3 Si-O-Si特征峰谱分峰拟合结果
Table 3. Si-O-Si characteristic peak spectrum fitting results
单体比例 线性结构A1(1023 cm−1) 网状结构A2(1063 cm−1) 笼状结构A3(1135 cm−1) $ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO=1:20.33 0.37 0.30 $ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO=2:10.15 0.51 0.34 表 4 薄膜沉积速率和阻隔性能
Table 4. Film deposition rate and barrier performance
试样 单体比例 沉积速率/nm·min−1 沉积膜厚/nm 氧气透过率/mL·m−2·d 纯PET(厚度12.5 μm) − − − 130 DLC/PET复合薄膜 $ \mathrm{\mathit{V}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr =1:142.7 200 102 SiOx/PET复合薄膜 $ \mathit{\mathrm{\mathit{V}}}_{\mathrm{C}_2\mathrm{H}_2} $ :VAr =6:161.77 185 0.58 $ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO=1:230.46 61 98 $ \mathrm{\mathit{V}}_{\mathrm{O}_2} $ :VHMDSO=2:18.08 69 3.69 -
[1] 吴东雷, 章丽丽, 许亮, 等. PET阻隔容器氧气透过性能测试及在啤酒包装领域的应用[J]. 包装与食品机械,2017,35(03):62−64 (in Chinese) doi: 10.3969/j.issn.1005-1295.2017.03.014 Wu D L, Zhang L L, Xu L, et al. Oxygen gas transmission test method of high-barrier PET plastic vessels and its application in beer packaging[J]. Packaging and Food Machinery,2017,35(03):62−64 doi: 10.3969/j.issn.1005-1295.2017.03.014 [2] 石朴, 许娜, 邓立生, 等. 基于CFD的汽化过氧化氢PET瓶坯灭菌过程流场分析[J]. 包装与食品机械,2023,41(02):48−52 (in Chinese) doi: 10.3969/j.issn.1005-1295.2023.02.008 Shi P, Xu N, Deng L S, et al. Flow field analysis of vaporized hydrogen peroxide PET bottle preform sterilization process based on CFD[J]. Packaging and Food Machinery,2023,41(02):48−52 doi: 10.3969/j.issn.1005-1295.2023.02.008 [3] 虞建中, 印雄飞, 徐雯, 等. PET瓶装碳酸饮料货架期影响因素研究[J]. 包装工程,2016,37(11):78−82 (in Chinese) Yu J Z, Yin X F, Xu W, et al. Influencing factors for the shelf-life of carbonated soft drink packaged with PET bottles[J]. Packaging Engineering,2016,37(11):78−82 [4] 冯树铭. PET薄膜的性能及其改性[J]. 聚酯工业,2009,22(01):15−18 (in Chinese) Feng S M. Performance and modification of PET film[J]. Polyester Industry,2009,22(01):15−18 [5] 刘忠伟, 杨丽珍, 桑利军, 等. 等离子体技术制备高阻隔薄膜作用方式和应用现状(一)[J]. 真空与低温,2023,29(4):315−326 (in Chinese) doi: 10.3969/j.issn.1006-7086.2023.04.001 Liu Z W, Yang L Z, Sang L J, et al. Research progress in preparation of barrier film by plasma technology(Ⅰ)[J]. Vacuum and Cryogenics,2023,29(4):315−326 doi: 10.3969/j.issn.1006-7086.2023.04.001 [6] 吴常良, 李茜茜, 李丽, 等. 超高阻隔膜制备工艺现状及市场发展[J]. 真空科学与技术学报,2014,34(05):543−548 (in Chinese) Wu C L, Li X Q, Li L, et al. Synthesis technologies and economic impact of ultra-high barrier thin films[J]. Chinese Journal of Vacuum Science and Technology,2014,34(05):543−548 [7] 李景, 田雷, 田修波, 等. 射频功率对筒状聚酯内壁类金刚石薄膜结构与性能的影响研究[J]. 真空科学与技术学报,2010,30(3):311−315 (in Chinese) doi: 10.3969/j.issn.1672-7126.2010.03.20 Li J, Tian L, Tian X B, et al. Growth and properties of diamond-like carbon films on inner walls of polythylene terephthalate tube[J]. Chinese Journal of Vacuum Science and Technology,2010,30(3):311−315 doi: 10.3969/j.issn.1672-7126.2010.03.20 [8] 董茂进, 冯煜东, 韩仙虎, 等. 基于PECVD方法制备的透明硅氧烷(SiOxCyHz)阻隔薄膜特性研究[J]. 真空科学与技术学报, 2022, 42(2): 99-103 (in Chinese) Dong M J, Feng Y D, Han X H, et al. Properties of transparent SiOxCyHz barrier film prepared by PECVD[J]. Chinese Journal of Vacuum Science and Technology, 2022, 42(2): 99−103 [9] Jeong C H, Lee J H, Lim J T, et al. Deposition of SiO2 by plasma enhanced chemical vapor deposition as the diffusion barrier to polymer substrates[J]. Japanese Journal of Applied Physics,2005,47(2):1022−1026 [10] Bahroun K, Behm H, Mitschker F, et al. Influence of layer type and order on barrier properties of multilayer PECVD barrier coatings[J]. Journal of Physics D: Applied Physics,2013,47:015201 [11] Nakaya M, Shimizu M, Uedono A. Impact of the difference in power frequency on diamond-like carbon thin film coating over 3-dimensional objects[J]. Thin Solid Films,2014,564:45−50 doi: 10.1016/j.tsf.2014.05.066 [12] Dangnan F, Espejo C, Liskiewicz T, et al. Water barrier performance of additively manufactured polymers coated with diamond-like carbon films[J]. Diamond and Related Materials,2021,119:108541 doi: 10.1016/j.diamond.2021.108541 [13] Alizadeh P, Franke J, Rainer D, Stretch-tolerant PECVD gas barrier coatings for sustainable flexible packaging[J]. Plasma. Process. Polym. 2024, e2400018 [14] Plujat B, Glénat H, Bousquet A, et al. SiCN: H thin films deposited by MW-PECVD with liquid organosilicon precursor: Gas ratio influence versus properties of the deposits[J]. Plasma Processes and Polymers,2010,17:e1900138 [15] Taylor A, Baluchová S, Fekete L, et al. Growth and comparison of high-quality MW PECVD grown B doped diamond layers on {118}, {115} and {113} single crystal diamond substrates[J]. Diamond and Related Materials,2022,123:108815 doi: 10.1016/j.diamond.2021.108815 [16] 贝荣华, 黄崇杏, 陈强, 等. SiOx/PET复合薄膜的力学性能及阻隔性能[J]. 包装工程,2017,38(19):57−62 (in Chinese) Bei R H, Huang C X, Chen Q, et al. Mechanical properties and barrier properties of SiOx/PET composite films[J]. Packaging Engineering,2017,38(19):57−62 [17] Ahmed M H, Byrne J A, McLaughlin J A D, et al. Comparison between FTIR and XPS characterization of amino acid glycine adsorption onto diamond-like carbon (DLC) and silicon doped DLC[J]. Applied Surface Science,2013,273:507−514 doi: 10.1016/j.apsusc.2013.02.070 [18] Srisang C, Asanithi P, Siangchaew K, et al. Characterization of SiC in DLC/a-Si films prepared by pulsed filtered cathodic arc using Raman spectroscopy and XPS[J]. Applied Surface Science,2012,258:5605−5609 doi: 10.1016/j.apsusc.2012.02.036 [19] Zajı́čková L, Veltruská K, Tsud N, et al. XPS and ellipsometric study of DLC/silicon interface, Vacuum, 2001, 61: 269−273 [20] Zhang D, Li S Y, Zuo X, et al. Structural and mechanism study on enhanced thermal stability of hydrogenated diamond-like carbon films doped with Si/O[J]. Diamond and Related Materials,2020,108:107923 doi: 10.1016/j.diamond.2020.107923 -


 首页
首页 登录
登录 注册
注册



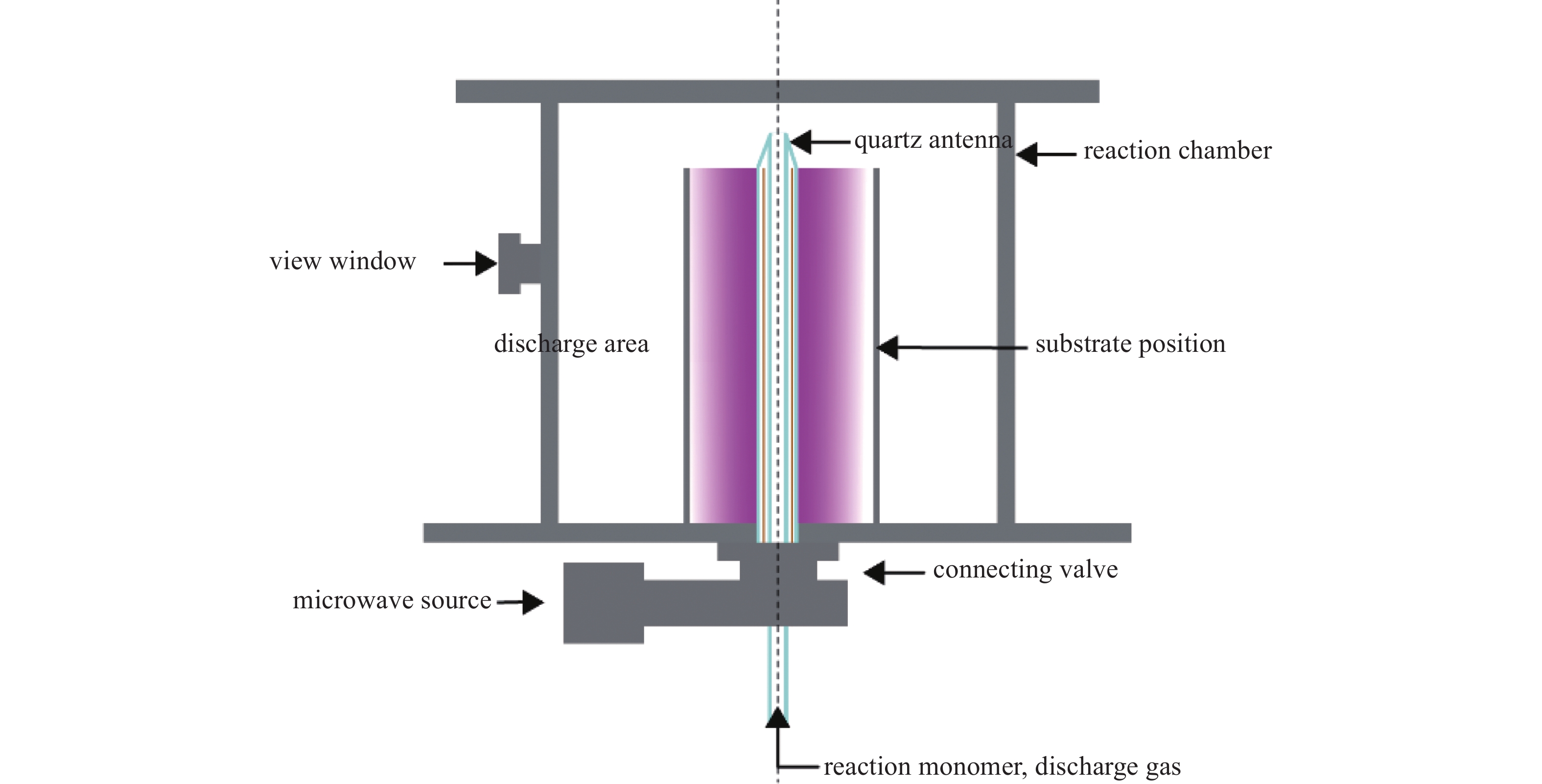
 下载:
下载: