-
随着功率器件电压等级的提升, 器件耐压与功耗之间的矛盾越来越突出. 作为晶闸管类器件, 集成门极换流晶闸管(IGCT)导通时的双侧载流子注入使其具有较低的导通压降, 同时, “硬驱动”技术的采用大大增加了器件的开关速度和安全工作区. 近些年, 随着国内对IGCT芯片制造与驱动技术关键问题的攻克, IGCT正在电力系统的某些领域逐渐替代传统的晶闸管, 比如高压直流输电与风力发电的直流断路器、静止同步补偿器, 以及多电平转换器等[1–4]. 当IGCT应用于以上场合时, 负载多为感性, 且器件容易遭受高电压、大电流的冲击. 于是, 器件出厂前需在过应力条件下对其反偏安全工作区(RBSOA)进行测试.
开关自箝位模式(SSCM)是指双极型功率器件进行RBSOA测试时, 由于施加给器件的关断应力较大(即高的电源电压、大的关断电流, 以及高的杂散电感), 在器件端电压上升至电源电压之前, 器件内部存储的等离子体被突然耗尽, 器件端电压迅速爬升并被箝位至接近器件静态雪崩击穿电压的现象. 之前关于功率二极管、IGBT, 以及IGCT的SSCM研究表明[5–8], 类似于IGBT固有的短路特性是一种过流保护机制, SSCM对于设计合理的器件与系统是一种过压保护机制, 由于器件的端电压在SSCM下被箝位. 对于关断过程相当于基极开路pnp晶体管的IGBT与IGCT, 为了增强器件在SSCM期间电压箝位的稳定性, 防止负阻效应的发生[5,7], 需将器件寄生pnp晶体管的电流增益αpnp设计地尽可能高.
然而, 之前的研究仅仅关注了器件的端特性, 本文对于IGCT在SSCM期间器件内部物理效应的研究发现, 虽然从器件的端特性上考虑, 端电压被稳定箝位, 但是器件内部发生了具有毁坏性的电流聚集效应, 并且这种效应随器件αpnp的增加而愈发强烈.
-
本文以直径为91 mm的4.5 kV/4.0 kA IGCT(器件实际雪崩击穿电压超过5.0 kV)为研究对象, 如图1所示, 首先对器件在过应力下的关断特性进行了测试与仿真, 对SSCM的发生进行了初步分析.
GCT管芯正面与门极可关断晶闸管(GTO)类似, 采用了分立的门-阴极结构, 其阴极呈指条状, 被门极所环绕, 并且阴极无短路点, 如图1(b)所示. 与GTO不同的是, GCT背面采用场阻止层(FS层)和透明阳极, 大大提高了关断速度, 如 图1(c)所示. IGCT是将封装好的门极换流晶闸管(GCT)通过印刷电路板与门极驱动器集成在一起而形成的组件, 从而大大降低了门极驱动电路上的杂散电感, 这使得“硬驱动”技术的使用成为可能, 如图1(a)所示. 在IGCT开关过程中, 非常强的门极电流脉冲可以使J3结在很短的时间内全面触发或截止, 使得器件更均与、更快速、更可靠地转换. “硬驱动”技术的典型特征是可实现单位关断增益, 使J3结在阳极电压上升之前就已截止, 因此GCT的关断实质上是一个基极开路的pnp晶体管的关断, 避免了GTO那样在阳极电压上升过程中阴极下方的晶闸管部分仍处于导通的情况, 大大提高了dV/dt耐量和最大可关断电流(MCC). 表1列出了GCT单元的主要结构参数.
-
图2为IGCT关断测试电路示意图, VDC代表电源电压, Li代表限流电感, Lσ为杂散电感, Lload为负载电感, FWD为续流二极管. 图3为IGCT在过应力条件(电源电压VDC = 2900 V, 关断电流IT = 5600 A, 杂散电感Lσ = 1 μH)下的关断测试曲线. t =0 μs, 很强的负电流脉冲被施加至IGCT的门极, 器件在“硬驱动”条件下开始关断; 门极换流过程大约在0.5 μs内完成, 随后阳阴极电压VAK开始上升, 当VAK上升至大约1500 V时, 其上升率明显减小, 标志着动态雪崩效应开始发生; 直至VAK上升至大约3000 V, 器件经受住了动态雪崩效应的冲击, 并未失效; 随后, VAK迅速上升至器件静态雪崩击穿电压附近, 并被箝位, SSCM发生, 直至器件关断过程结束, 即IA = 0 A, 自箝位模式结束.
由图3可见, IGCT在SSCM期间被较稳定地箝位, 器件成功关断且并未出现失效现象. 这说明在相应的测试应力条件下, 器件αpnp的设计是足够大的, 足够多的空穴注入会抑制器件背面高低结(nn-结)处由雪崩产生电子引发的电场峰值, 从而防止pn-结与nn-结相互增强的双侧雪崩效应而使器件失效[5,7]. 然而, 之前对SSCM发生时IGCT内部物理效应的研究只考虑了器件纵向方向, 而忽略了横向效应.
-
实际的IGCT管芯是由数千个单元(数千个阴极条)组成, 如图1(b)所示, 同时为了进一步揭示SSCM发生时器件内部横向上的物理效应, 本文采用Sentaurus-TCAD专业模拟软件建立了多单元IGCT结构模型, 并搭建了如图2所示的关断测试电路, 对器件在过应力条件下的关断特性进行了仿真分析.
为了研究器件内部横向上的物理效应, 所建立的仿真结构模型需在横向方向上有一定的尺寸, 然而较大横向尺寸结构模型的仿真又会降低仿真效率. 因此, 建立了如图4所示的5单元结构模型, 横向与纵向尺寸分别为2000 μm与550 μm, 器件的有效面积通过软件的面积因子(area factor)被调节为56 cm2 (相当于图1(b) GCT管芯有源区的面积), n-基区的电子寿命与空穴寿命分别为10 μs与3 μs. 为了便于抽取器件各个单元各自的电流, 器件的阳极铝电极被分开, 从左至右依次为A1, A2, A3, A4, A5.
特性仿真采用的主要物理模型包括禁带窄化模型, 依赖于掺杂、温度、载流子-载流子散射, 以及高电场造成的载流子漂移速度饱和的迁移率模型, 依赖于掺杂和温度的Shockley-Read-Hall(SRH)体复合模型, 俄歇(Auger)复合模型, van Overstraeten 和 de Man的雪崩产生模型.
首先对具有不同阳极区掺杂浓度(NA1 < NA2 < NA3 < NA4)的IGCT在过应力(关断应力与图3的测试应力相同)条件下的关断特性进行恒温仿真(温度T = 300 K), 结果如图5所示.
t = 500 μs, 施加门极硬驱动关断信号, 门极换流结束后, p基区中存储的载流子被完全抽取, pn-结开始反偏, 电场主要向n-基区展宽, VAK开始上升. 随着IGCT背面阳极区的掺杂浓度增加(即αpnp的增大), 器件导通状态下n-基区的存储载流子浓度越高, 导致在同样的关断电流(IT)下载流子的抽取速度变慢, 反偏pn-结处电场在n-基区的展宽速度变慢, 导致关断时VAK上升率随αpnp的增大而减小.
随着VAK的上升, 剩余等离子体被不断抽取, 等离子体边沿不断向阳极侧移动. 在等离子体边沿处, 受电场的作用, 电子向阳极侧运动并快速通过透明阳极区到达具有高复合速率的阳极, 空穴通过空间电荷区向p基区流动并最终通过门极流出器件. 由于流经空间电荷区的空穴带正电荷, 其与空间电荷区同样带正电的施主电荷相互叠加, 造成VAK上升过程中n-基区的电场梯度远高于器件阻断状态下的电场梯度. 这就造成VAK还远小于器件实际的雪崩击穿电压时, pn-结处的电场峰值就已达到器件发生雪崩的临界击穿电场, 动态雪崩开始发生. 由于动态雪崩的发生产生雪崩载流子, 从而减慢了剩余载流子的抽取与电场在n-基区的展宽速度, 所以VAK上升率会明显变缓. 由图5可见, 随着IGCT的αpnp增加, 动态雪崩发生地更早, 根据对动态雪崩开启电压的理论推导[9], 这是因为αpnp的增加会放大雪崩倍增因子, 并同时降低临界击穿电场.
随着VAK的继续上升, pn-结处电场向n-基区的展宽不断增加, 同时电场强度也愈来愈强, 导致器件的动态雪崩效应增强, VAK上升率亦越来越小. 由于器件在过应力(高的VDC, 大的关断电流IT, 大的杂散电感Lσ)下关断, 所以器件内部存储的载流子被过快地抽取, 在VAK到达电源电压VDC之前, n-基区存储的载流子就已完全被抽取, 电场穿通至n型场阻止层. 由于n型场阻止层的掺杂较n-基区高, 其少子寿命较低, 所以存储的载流子数量较少, 因此, 由图5可见, VAK上升率有一个陡然上升的过程, 这表示pn-结处的电场已穿通至n型场阻止层.
当VAK上升至电源电压时, 与IGCT反并联的二极管FWD (如图2中所示)开始续流, 导致IGCT阳极电流IA开始减小. 在杂散电感Lσ的作用下, IA的下降会导致IGCT两端的VAK进一步快速上升, 直至达到器件的雪崩击穿电压附近后被箝位, SSCM发生.
在SSCM期间, 由于VAK被箝位, 所以IA近似线性减小. 并且, 随着器件αpnp的增大, 箝位电压Vclamp降低, 根据
Vclamp降低会导致IA在SSCM期间的下降率减小, 从而SSCM的持续时间增长.
与图3的测试结果一样, 图5的仿真结果显示, 四种不同αpnp的IGCT的SSCM似乎也是稳定的, 只是SSCM的箝位电压Vclamp随αpnp增大而大大降低, 同时箝位时间也增长.
-
上述基于器件的端特性, 对于IGCT在过应力下的关断特性进行了测试与仿真分析, 下面将重点关注器件内部的物理效应, 进一步研究器件在SSCM下的鲁棒性.
图5中不同阳极区掺杂浓度的IGCT在过应力关断过程中, 随着VAK的上升与动态雪崩效应的增强, VAK特性曲线上出现了电压突然下降的“凹槽”, 这表明器件发生了负微分电阻效应, 负微分电阻效应的发生通常会诱发器件产生电流聚集效应(即电流丝效应)[10]. 采用图4仿真结构模型中分开的阳极电极将流过每个单元的电流单独抽取出来, 结果如图6所示. 图7呈现了图6(d)中不同时刻器件内部的电流密度分布. 图6和图7对于器件内部物理效应的呈现表明了雪崩诱发电流丝的存在及其运动规律.
图7呈现了IGCT中由雪崩诱发的电流丝的形态不同于功率二极管[11–13]. 虽然雪崩效应主要发生在pn-结处的空间电荷区, 但电流丝却是纵向贯穿整个器件的. 当电流丝在某个区域产生后, 由于此处很高的电流密度, 导致此处的雪崩效应比其他区域更强, 且此处pn-结产生的雪崩电子向阳极侧移动, 相当于给器件背面的pnp晶体管施加了一个基极驱动电流, 从而促使此处背面空穴的大量注入, 即pn-结处的雪崩效应与p+n结处的空穴注入相互增强, 形成了GCT中的这种纵向贯穿器件的电流丝.
-
图6中IGCT在不同阳极区掺杂下的过应力关断特性均表明, 在VAK上升过程中由动态雪崩诱发的电流丝在器件内部是频繁移动的, 然而一旦VAK被箝位, SSCM发生, 电流丝几乎不再运动, 停留在某个单元的位置直至IA下降为0 (即SSCM结束).
图6与图7是通过恒温模拟得到的, 而实际器件工作过程中会因功耗的产生而使得晶格温度升高, 尤其是当雪崩效应发生且产生电流丝后, 最高晶格温度必定会明显升高. 温度对载流子的碰撞电离率及其他物理参量产生影响, 因此, 有必要对IGCT过应力下的关断特性进一步进行电热耦合仿真. 图8为IGCT阳极区掺杂为NA1时器件的电热耦合模拟结果, 器件的关断应力与图6(a)相同, 初始晶格温度为300 K. 由图8可见, 随着IGCT换流结束, VAK开始上升, 最高晶格温度Tmax也随之升高, 一旦动态雪崩诱发的电流丝产生, Tmax随之会有明显的升高. 在VAK上升阶段, Tmax较初始温度变化并不是很大, 这是因为电流丝是不断移动的, 然而, 一旦SSCM发生, Tmax将迅速升高. 需要注意的是, 与图6(a)中相比, 图8中在SSCM期间, 本来静止不动的电流丝又发生了移动, 虽然其移动速度远低于VAK上升阶段. 这说明晶格温度的升高是驱动SSCM期间雪崩诱发电流丝移动的决定性因素.
图9呈现了图8中SSCM期间的三维电流密度分布. 由图9可见, 空间电荷区中电流丝中心的最高电流密度已接近103 A/cm2, 电流丝中很高的电流密度必须绕过n+阴极区而流出器件, 导致在n+阴极区下方p基区中的电流密度高达103 A/cm2量级, 这极有可能造成门阴极pn+结的重触发; 另外, 电流丝引起的温升还会进一步降低门阴极pn+结的开启电压. 一旦门阴极pn+结开启, 电流丝所在区域的晶闸管触发开通, 器件承受的电压在此区域有下降的趋势, 导致电流进一步向此处的集中, 最终使器件在此区域因温升过高而被烧毁.
综上所述, IGCT发生SSCM时, 虽然从器件端特性的角度考虑, 器件的总损耗因电压箝位而被限制, 然而, 在此期间器件内部产生了强度非常高的电流丝, 其会使整个器件所产生的功耗在电流丝所在的局部区域通过发热进行释放, 极有可能导致器件失效. 因此, IGCT在SSCM期间的鲁棒性取决于电流丝的强度与移动速度.
需要强调的是, 雪崩产生的电流丝是电流在器件横向上的一种聚集效应[14–16]. 虽然图7中的电流丝仅有1条, 其是通过图4的5单元二维结构模型仿真得到的, 但是实际器件是三维的, 并且是由数千个单元组成, 因此, 通过二维模拟得到的电流丝并不能反映实际器件中电流丝的强度和个数. 然而, 建立等同于实际器件数千个单元的三维器件结构模型进行仿真对于数值计算显然是不可能的. 可以预想, 当雪崩效应发生时, 实际器件中产生的电流丝不止1条, 但是可以肯定的是, 多条电流丝在VAK上升阶段均是不断移动, 并可能相遇或分裂的, 这并不会造成太大的温升, 而一旦SSCM效应发生, 这些电流丝的移动将变得非常缓慢, 极有可能造成器件因局部重触发甚至过热而失效.
-
IGCT在过应力关断过程中由动态雪崩诱 发的电流丝是快速移动的, 其形成机理与影响已 被详细研究. 这部分主要研究SSCM期间产生的极有可能造成器件失效的电流丝形成机理与影响机理.
-
从上述IGCT的关断波形可以看出, IGCT换流过程结束后, 在感性负载的作用下, 器件并未因流过其电流的突然消失而立即关断, 而此时支撑电流流动的是器件中存储载流子的移除, 且当动态雪崩发生后, 还有雪崩产生载流子的移动, 如图10中t = 501 μs和t = 502 μs器件内部的电场与载流子分布. 然而, 一旦电压箝位发生, SSCM开启, 由于器件中的存储载流子已被耗尽, 在器件中没有可移动的被移除的载流子, 因此, 此时支撑电流流动的只有雪崩产生的载流子, 如图10中t = 505 μs和t = 508 μs器件内部的电场与载流子分布. 由此可见, 器件在SSCM期间实质上正工作在其静态雪崩击穿模式下, 所以器件的静态雪崩击穿特性决定了器件在SSCM期间的鲁棒性.
图11模拟了不同阳极区掺杂浓度下IGCT在过电压下的静态雪崩击穿特性曲线, 当器件在相应的击穿特性曲线上工作时, 随着雪崩电流密度JA的增加, 器件的αpnp被提取, 如图12所示. IGCT在阻断状态下, 门阴极被短路, 这相当于一个基区开路的pnp晶体管的阻断. 当器件发生雪崩击穿时, 根据pnp晶体管雪崩击穿理论:
式中, M代表雪崩倍增因子, 其由VAK决定, VAK越大, 电场展宽越大, 强度越强, M越大.
由图12可见, IGCT阳极区的掺杂浓度越高, 器件发生雪崩击穿后的αpnp越大, 根据(2)式, 器件的雪崩击穿后的电压VAK越低, 如图11所示. 由于IGCT发生SSCM时, 器件的端电压被箝位在雪崩击穿电压下, 因此, 图11中器件发生雪崩后在某一雪崩电流下的电压即为器件在SSCM期间相应关断电流下的箝位电压. 这就是图5中IGCT发生SSCM时的箝位电压随器件阳极区掺杂浓度增加而下降的原因.
-
上述分析表明IGCT在SSCM期间实质上工作在其雪崩击穿特性曲线上. 图11显示, 当IGCT雪崩击穿发生后, 随着雪崩电流的增大, 其雪崩击穿曲线上首先出现一个负微分电阻(NDR)分支(NDR1 branch), 当VAK减小至一个谷值点(图11中的V点或V'点)时, 一个正微分电阻(PDR)分支出现, 最后又呈现出第二个NDR分支(NDR2 branch). 由于IGCT的阻断和雪崩击穿相当于pnp的阻断和雪崩击穿, 因此, 其雪崩击穿曲线上NDR和PDR分支的形成机理与IGBT的相同[17], 这里不再赘述.
IGCT在SSCM期间因雪崩效应产生电流聚集效应(电流丝效应)的原因是器件发生SSCM效应时正好工作在其雪崩击穿曲线上的NDR分支上. 由于在NDR分支上, 随着雪崩电流的增大, 器件两端的电压减小, 如果器件因某一因素(结构或工艺的不均匀性等因素)已经发生了电流在局部的聚集效应, 而器件此时正好工作在NDR分支上, 那么此区域由于电流密度的升高而电压也减小, 即此区域的微分电阻有比其他区域减小的趋势, 这将会导致电流进一步向此区域聚集, 从而形成一个正反馈, 造成电流丝中心的电流密度越来越高.
如果器件工作在PDR分支上, 那么电流向某个区域的聚集将导致此区域的微分电阻有比其他区域增大的趋势, 从而不利于电流向此处的继续聚集. 这就是NDR分支和PDR分支对电流丝强度的影响, 由此可见, 如果NDR分支越强烈, 即器件雪崩击穿曲线上的端电压随电流密度的增大而减小得更快, 那么器件的负微分电阻效应越强, 会导致电流更快地向电流丝所处的区域聚集, 电流丝的强度越来越大, 直至此区域的工作状态进入PDR分支.
图9显示IGCT在SSCM期间产生的电流丝会在n+阴极区下方形成非常强烈的电流聚集效应, 从而造成器件因重触发而失效. 所以SSCM下电流丝的强度决定着器件的鲁棒性. 而理论上预估电流丝的最大强度需要判断器件雪崩击穿曲线由NDR分支转换至PDR分支时对应的雪崩电流的大小, 即图11中VAK谷值点V或V'所对应的电流. V点对应的电流密度越大, 意味着此器件产生的电流丝的强度越强.
图8的热电耦合仿真显示, IGCT在电压上升阶段由动态雪崩产生的电流丝是快速移动的, 这是由于在电流丝所在区域剩余等离子体被快速抽 取[18–20]; 在SSCM期间产生的电流丝受温升的影响也是移动的, 但移动速度非常缓慢. 而SSCM下电流丝的移动速度越慢, 意味着其在某个区域停留的时间越长, 从而增大了器件在此局部区域关断失效的风险. 所以SSCM下电流丝的移动速度也决定着器件的鲁棒性. 在SSCM期间电流丝的移动是由于随着温度升高, FS-IGBT雪崩击穿曲线上NDR1 branch向VAK更大的方向漂移. 电流丝在某个区域产生, 将会导致此区域的温度升高, 并且高于其他没有电流丝的区域, 于是, 在电流丝所在区域的微分电阻有增大的趋势, 这就造成电流丝向其他温度较低、微分电阻也较低的区域移动. 并且, 图11中可以看出, NDR1 branch的偏移量ΔVAK越大, 电流丝所在区域由温升导致的正微分电阻越大, 越容易驱动电流丝向温度较低的地方移动. 由图11可见, IGCT阳极区掺杂浓度越高, αpnp越大, 随着温度的升高, ΔVAK越小, SSCM下电流丝的移动速度越缓慢.
-
IGCT在过应力关断过程中, 在电压上升阶段由动态雪崩效应诱发的电流丝是快速移动的, 不会造成太大的温升, 不会对器件鲁棒性造成较大的影响; 然而, 一旦电压上升至静态雪崩击穿电压附近被箝位, SSCM发生, 器件将工作在其静态雪崩击穿模式下, 若器件工作在其静态雪崩击穿特性曲线上的NDR分支上, 器件内部将诱发仅依靠温升驱动、移动速度非常缓慢的电流丝, 这会使得本来需要整个器件承受的功耗仅靠电流丝所在的区域来承受, 从而造成非常高电流密度的电流丝与较大的温升, 器件很容易发生重触发或热击穿.
IGCT在SSCM下产生电流丝的强度与移动速度取决于器件的αpnp. IGCT静态雪崩击穿曲线上由NDR1 branch向PDR分支转化的电压谷值点V对应的电流密度决定了电流丝的强度, 温升引起的雪崩击穿特性曲线的漂移量ΔVAK决定了电流丝的移动速度. 随着器件αpnp的增加, V点对应的电流密度越高, ΔVAK越小, 这会使得电流丝的强度越强, 电流丝的移动速度越慢, 同时, 由于SSCM箝位时间也随αpnp的增加而增长, 从而大大降低器件的鲁棒性. 因此, 在进行GCT芯片设计时, 为了提高器件在SSCM下的鲁棒性, 对于αpnp需较精确地控制, 一方面防止αpnp过小导致SSCM期间高低结处的电场过高而发生双侧雪崩增强效应, 另一方面防止αpnp过大造成SSCM期间雪崩诱发电流丝的强度过大与移动速度过慢; 同时在工艺制造允许的条件下, 尽可能地增加p基区的结深, 降低n+阴极区下方的横向电阻以减小电流丝流经此处时的横向压降, 从而抑制重触发效应.
集成门极换流晶闸管开关自箝位模式下的鲁棒性
Robustness of integrated gate commutated thyristor in switching self-clamping mode
-
摘要: 基于多单元结构模型, 对集成门极换流晶闸管(IGCT)在过应力条件下的关断特性进行了仿真. 发现在开关自箝位模式(SSCM)下, 虽然器件的端电压被箝位, 但其内部产生了移动速度非常缓慢的电流丝, 从而使得器件非常容易发生重触发、甚至热击穿. 并且, IGCT静态雪崩击穿特性决定了器件在SSCM下电流丝的性质. IGCT寄生pnp晶体管的共基极电流增益αpnp越大, SSCM下雪崩诱发电流丝的强度越大, 移动速度越慢, 从而大大降低器件的鲁棒性.
-
关键词:
- 集成门极换流晶闸管(IGCT) /
- 开关自箝位 /
- 雪崩 /
- 电流丝 /
- 鲁棒性
Abstract:As a thyristor-like device, integrated gate commutated thyristor (IGCT) is more applicable to the high-voltage and high-power fields due to the lower on-state voltage drop, and a combination of transparent anode and hard drive enables IGCT to turn off faster and more reliably. However, with an increase in power capacity of IGCT, the reliability of IGCT is becoming an increasing concern. Based on the multi-cell structure model, the turn-off characteristics and robustness of IGCT under over-stress conditions are studied in this work. The results show that during GCT turning off, the modulation of free carriers to the electric field in the space charge region makes the dynamic avalanche effect occur at the anode-cathode voltage much lower than the rated blocking voltage of the device, and the avalanche-induced current filament effect may occur due to the distortion of electric field, resulting in negative differential resistance effect at strong dynamic avalanche. In comparison, the behavioral characteristics of current filament at different stages of turn-off behave differently. During the voltage rising period when IGCT turns off, the avalanche-induced current filament can move rapidly, which will not cause the temperature to rise too much and has little influence on the robustness of the device. In contrast, when the anode-cathode voltage rises close to the static avalanche breakdown voltage, the switching self-clamping mode (SSCM) will occur, and the device will operate in its static avalanche breakdown mode. If the device operates on the negative differential resistance (NDR) branch of its static avalanche breakdown characteristic curve, a very slow moving current filament driven only by temperature rise will appear. This makes the power consumption that is required to be borne by the entire device undertaken only by the area where the current filament is located, thus resulting in a very high local current density and a large local temperature rise, and the device is easy to re-trigger or thermally break down. The static avalanche breakdown characteristics of IGCT determine the nature of the current filament under SSCM. The larger the common-base current gain αpnp of the parasitic pnp transistor of IGCT, the stronger the avalanche-induced current filament under SSCM is and the slower its movement speed, thereby significantly reducing the robustness of the device. Therefore, in order to improve the robustness of the device under SSCM, more precise control of αpnp is required during the designing of GCT chips. -

-
图 10 IGCT过应力关断过程中电压上升阶段(t = 501, 502 μs)与电压箝位期间(t = 505, 508 μs)器件内部的空穴浓度p与电场强度E纵向分布曲线(对应图6(d))
Figure 10. Vertical distribution curves of hole concentration p and electric field intensity E inside the device during the voltage rise stage (t = 501, 502 μs) and voltage clamp period (t = 505, 508 μs) during the IGCT over-stress turn-off (Corresponding to Fig. 6(d)).
表 1 4.5 kV非对称GCT的主要结构参数
Table 1. Main structural parameters of 4.5 kV asymmetry GCT.
掺杂(峰值)
浓度/cm–3厚度/宽度/μm n-基区 1×1013 厚度: 370 n场阻止层 2×1016 厚度: 47 p+透明阳极区 1×1017—5×1018 厚度: 3 浅p基区 5×1016 p基区整体厚度: 110 深p基区 — n+阴极区 1×1020 厚度/宽度: 20/200 单元宽度(阴极条宽度) — 400 -
[1] Stiasny T, Quittard O, Waltisberg C, Meier U 2018 Microelectron. Reliab. 88 510 [2] Kang Z, Tang Y, Zhan C, Wang W, Zhu L, Sun H, Ji S 2024 CPSS & IEEE International Symposium on Energy Storage and Conversion Xi'an, China, November 8–11, 2024 p190 [3] Wu J, Pan J, Ren C, J Liu, Zhao B, Yu Z, Zeng R 2025 IEEE Trans. Power Electron. 40 5223 doi: 10.1109/TPEL.2024.3514459 [4] Wang J, Chen L, Zhang X, Liu J, Zhao B, Yu Z, Wu J, Zeng R 2025 IEEE Trans. Power Electron 40 5309 doi: 10.1109/TPEL.2024.3508835 [5] Lutz J, Schlangenotto H 2020 Semiconductor Power Devices: Physics, Characteristic, Reliability (Vol. 1) (Switzerland: Springer International Publishing AG) p108 [6] Rahimo M, Kopta A, Eicher S, Schlapbach, Linder 2004 Proceedings of the 16th International Symposium on Power Semiconductor Devices and ICs Kitakyushu, Japan, May 24–27, 2004 p437 [7] Rahimo M, Kopta A, Eicher S, Schlapbach U, Linder S 2005 Proceedings of the 16th International Symposium on Power Semiconductor Devices and ICs Santa Barbara, CA, USA, May 23–26, 2005 p67 [8] Stiasny T, Streit P 2005 Proceedings of the 16th International Symposium on Power Semiconductor Devices and ICs Santa Barbara, CA, USA, May 23–26, 2005 p203 [9] Yang W H, Wang C L 2021 Microelectron. Reliab. 120 114111 doi: 10.1016/j.microrel.2021.114111 [10] Yang W H, Wang C L, Yang J 2019 Microelectron. Reliab. 92 34 doi: 10.1016/j.microrel.2018.11.001 [11] Lutz J, Baburske R, Chen M, B Heinze, Domeij M, Felsl HP, Schulze HJ 2009 IEEE Trans. Electron Devices 56 2825 doi: 10.1109/TED.2009.2031019 [12] Schulze H J, Niedernostheide F J, Pfirsch F, Baburske R 2013 IEEE Trans. Electron Devices 60 551 doi: 10.1109/TED.2012.2225148 [13] Baburske R, Niedernostheide F J, Lutz J, Schulze HJ 2013 IEEE Trans. Electron Devices 60 2308 doi: 10.1109/TED.2013.2264839 [14] Lutz J, Baburske R 2012 Microelectron. Reliab. 52 475 doi: 10.1016/j.microrel.2011.10.018 [15] Oetjen J, Jungblut R, Kuhlmann U, Arkenau J, Sittig R 2000 Solid State Electron. 44 117 doi: 10.1016/S0038-1101(99)00209-9 [16] Baburske R, Lutz J, Heinze B 2010 IEEE International Reliability Physics Symposium Proceedings Anaheim, CA, USA, 2010, p162 [17] 杨武华, 王彩琳, 张如亮, 张超, 苏乐 2023 物理学报 72 078501 doi: 10.7498/aps.72.20222248 Yang W H, Wang C L, Zhang R L, Zhang C, Su L 2023 Acta Phys. Sin. 72 078501 doi: 10.7498/aps.72.20222248 [18] Yang W H, Wang C L, Zhang R L, Su L, Zhang Q 2021 IEEE Trans. Electron Devices 68 208 doi: 10.1109/TED.2020.3039224 [19] Dong M L, Yang W H 2024 2024 3rd International Symposium on Semiconductor and Electronic Technology Xi'an, China, August 23–25, 2024 p315 [20] Yang W H, Wang C L, Yang J, Zhang Q, Su L 2021 Microelectron. Reliab. 118 114048 doi: 10.1016/j.microrel.2021.114048 -


 首页
首页 登录
登录 注册
注册



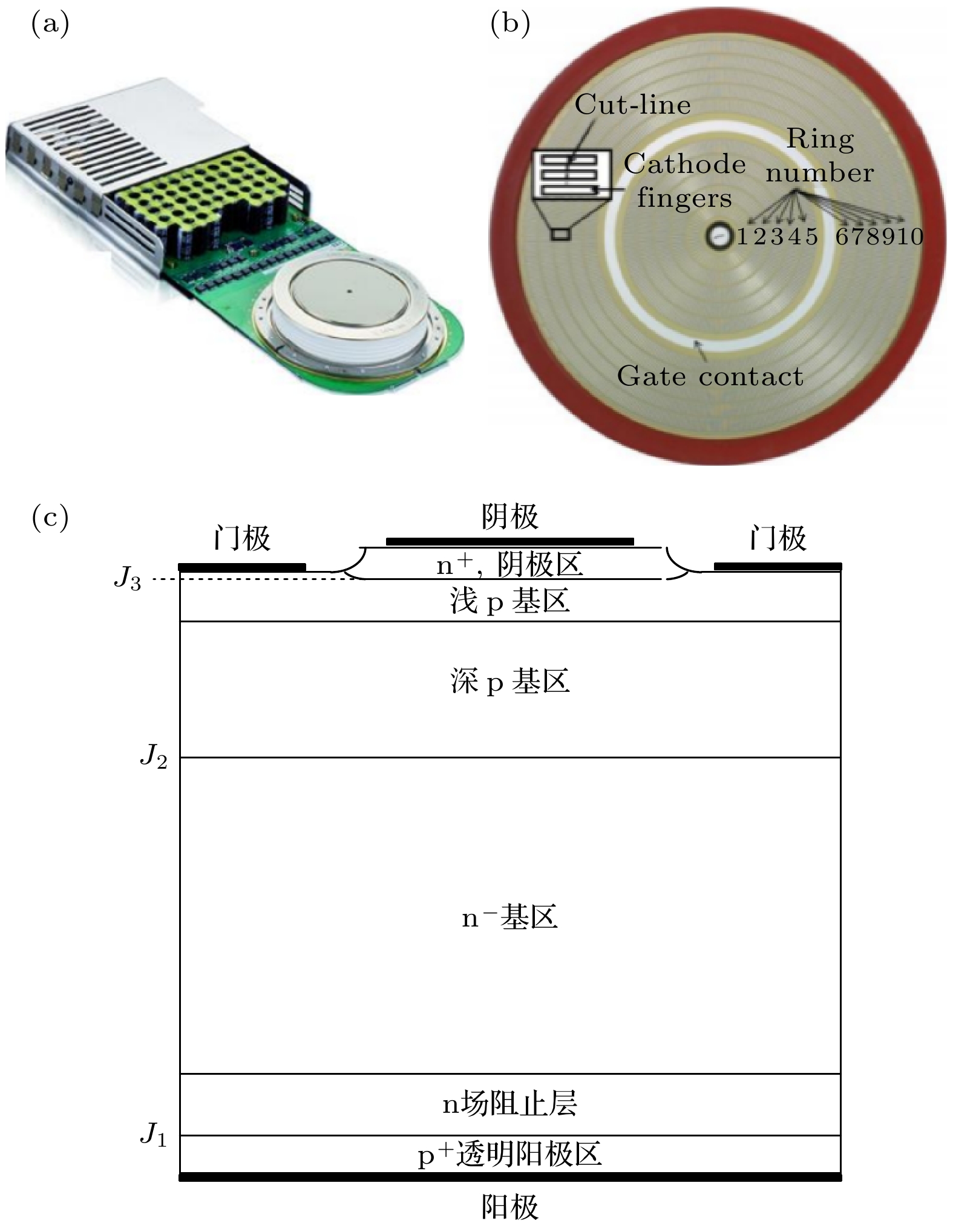
 下载:
下载: