-
在半导体与光学领域中,在进行沉积、刻蚀、测量等工艺时,通常需要对衬底结构进行固定,来保证工艺过程的一致性、测试的准确性。在大多数设备中固定衬底的结构主要包括:机械卡盘、真空吸盘、Electrostatic chuck静电卡盘等结构(ESC)。其中静电卡盘具有固定衬底、控制衬底温度、引入射频电磁场等功能,同时兼具稳定性、低颗粒性、控温良好、适用于多种真空环境等优良特性,使其在半导体、光学领域中受到越来越广泛的应用[1-4]。
在半导体领域中,含有静电卡盘的真空腔室设备通常包括上腔室射频电源、射频线圈、真空腔、晶圆、以及静电卡盘。其中静电卡盘通常处于下腔室位置,用于晶圆的固定以及晶圆的加热,如图1所示。在真空腔室产生等离子体进行工艺时,可以通过静电卡盘加载射频电压,来调节等离子体的状态实现对半导体工艺的控制[5-7]。
静电卡盘的基本结构如图2所示,其结构主要包括介电层、电极、静电卡盘主体结构。静电卡盘利用静电场中的库仑力来吸附衬底结构,其工作原理如图3所示:在晶圆和静电卡盘的电极上施加一个直流电压,晶圆、介电层、电极、直流电压源之间形成一个含有电容的直流电流回路,如图3所示;其中晶圆、介电层以及电极组成一个平行板电容器,晶圆和电极分别作为平行板电容器的两极,电容器的两极分别带极性相反的电荷;静电卡盘利用电容器两极间正负电荷所形成的库仑力,来吸引固定静电卡盘表面的晶圆结构[8-12]。
依据静电卡盘的吸附原理来对静电卡盘进行分类,静电卡盘可以分为库伦型静电卡盘以及Johnsen-Rahbek type 约翰逊-拉别克型(J-R型)静电卡盘[13-16]。库伦型静电卡盘的工作原理如图4 (a)所示,当在吸附电极上施加直流电压时,在电极上聚集静电荷,通过库仑力吸附静电卡盘表面的晶圆结构。库伦型静电卡盘的介电层绝缘电阻的体电阻率较高,多数大于
$ {\text{10}}^{\text{16}} $ Ω·cm,属于绝缘材料。对于J-R型静电卡盘来说,介电层的体电阻率通常在
$ {\text{10}}^{\text{9}} $ Ω·cm−$ {\text{10}}^{\text{11}} $ Ω·cm范围内,该介电层属于半导体材料。响应时间τ<1 s,因此在电极上加载吸附电压后很短的时间内,电极上的电荷就会移动到静电卡盘的上表面。其工作原理如图4(b)所示,静电卡盘表面的电荷产生的静电场,会吸引晶圆上相反电荷聚集到晶圆的下表面。静电卡盘表面和晶圆上极性相反的电荷之间会产生库仑力,从而实现静电卡盘吸附晶圆的功能。在实际使用中J-R型静电卡盘结构在吸附晶圆的过程中使用的吸附电压更低,对晶圆造成静电损伤的影响更小,对腔室等离子的干扰更小。所以J-R型静电卡盘更广泛应用于半导体的先进制程中。
但是中国半导体领域对J-R静电卡盘的研究较少,多数研究围绕于介电层材料对晶圆吸附力的影响。但对于J-R型静电卡盘来说,静电卡盘表面的凸点结构、电学性能等参数对静电卡盘吸附力有着极大的影响。然而目前中国很少开展关于此方面的研究。
为深入研究介电层、凸点表面参数对静电卡盘吸附力的影响。本文将搭建了静电卡盘的真空测试平台,依据极限背吹气压方法,测试不同J-R型静电卡盘极限吸附力。
-
本文采用气体背吹法[17]测试静电卡盘的吸附力。气体背吹法的工作原理是:将静电卡盘和晶圆置于真空环境中,使用静电卡盘吸附住晶圆,在晶圆与静电卡盘之间通入背吹气,通过晶圆脱离静电卡盘时的背吹气压,即可计算出静电卡盘的吸附力。气体背吹法具有测试平台搭建简单,并且晶圆受力均匀,测试结果误差较小等优点。可以准确测试出静电卡盘的吸附力。
本文中测试双极J-R型静电卡盘吸附力的方法如图5(a)所示。首先搭建好真空腔室结构,将晶圆放置在静电卡盘的吸附面结构上,静电卡盘表面的凸点结构对晶圆起到支撑作用,同时凸点间的间隙可以起到均匀晶圆上背吹气压的作用。将真空腔室抽真空到1×10−7 Torr环境下,然后给静电卡盘施加吸附电压,使静电卡盘吸附表面的晶圆结构。之后在静电卡盘的背吹气路中通入一定气量的背吹气,可以通过背吹气路上的真空规读出此时背吹气压。由于此时腔室真空度(约<1×10−4 Torr)远小于背吹气压值(>1 Torr)这时背吹气产生的压力
${{F}}_{\text{Gas}}$ 加上凸点的支撑力${{F}}_{\text{Sustain}}$ 等于静电卡盘的吸附力${{F}}_{\text{Chuck}}$ 加上晶圆自身的重力G,如式(1)所示。其晶圆受力示意图如图5(b)所示。其中背吹气压力
${{F}}_{\text{Gas}}$ 可以通过背吹气压p乘以晶圆面积A得到。如式(2)所示。当逐渐增加背吹气的流量时,背吹气压升高,
${{F}}_{\text{Gas}}$ 增加,但是此时静电卡盘的吸附力${{F}}_{\text{Chuck}}$ 和晶圆自身的重力G的大小不变,凸点的支撑力${{F}}_{\text{Sustain}}$ 降低,如式(1)所示。当背吹气压增加到一定大小时,晶圆脱离静电卡盘,此时可以认为支撑力${{F}}_{\text{Sustain}}$ 为0,晶圆刚好脱离静电卡盘时的背吹气压等于吸附力${{F}}_{\text{Chuck}}$ 和晶圆自身的重力G之和。由此即可测出静电卡盘的吸附力${{F}}_{\text{Chuck}}$ 。 -
基于上述测试静电卡盘吸附力的原理,本文搭建了包括软件控制系统和硬件测试系统的实验装置。实验装置主要包括:真空腔室、干泵、分子泵、静电卡盘固定结构(具有封真空作用)、直流电源、气源、针阀、气体流量计、真空规、真空控制系统、气体流量控制系统、气压测试系统、吸附电压控制系统。具体的实验装置如图6所示。其中具体的软件、硬件控制系统的结构示意图7中。
实验装置的安装及测试过程如下,首先搭建好真空腔室结构及控制系统后,将静电卡盘通过固定结构固定在真空腔室中,其中静电卡盘的电引入结构、及背吹气路在大气中,其吸附面被固定结构封在真空腔室中。将静电卡盘吸附面擦拭干净去除表面污渍及残余电荷,放上一片标准晶圆结构。直流电源接在静电卡盘的两极。静电卡盘背吹气路与气体流量计、真空规、以及气源相连。在本实验中,使用氩气作为静电卡盘的背吹气。安装好静电卡盘之后将腔室密封,并通过真空控制系统将腔室的气压抽到本底气压,并使腔室保持本底气压在两个小时以上,防止静电卡盘表面水汽干扰测试结果。开通直流电源,在静电卡盘的两极施加吸附电压,使静电卡盘吸附晶圆。通过控制增加通入静电卡盘气体流量的大小,来逐步增加背吹气压的大小,直到晶圆脱离静电卡盘。在晶圆刚脱离静电卡盘时,(在晶圆脱离静电卡盘时,背吹气压会迅速降低)通过记录背吹气路上真空规的读数,得到背吹气的最大背压值,即可计算出静电卡盘吸附力的大小。
-
本实验中所用到的J-R型静电卡盘如图8所示,该图为实验中其中一块静电卡盘结构,其他静电卡盘结构表面陶瓷结构相同,仅凸点高度不同。静电卡盘主要包括以下结构:氮化铝材料的陶瓷盘主体,双D型吸附电极,电引入端子结构,静电卡盘表面气道结构,背吹气路结构,承载盘体的金属法兰结构。制作的静电卡盘时表面没有凸点结构,如果使用该静电卡盘直接吸附晶圆,那么在使用中会引起晶圆和陶瓷盘表面的摩擦,从而损坏静电卡盘的性能,使之不能满足半导体工艺中的使用。因此,通常会在静电卡盘表面制作硬度较高的凸点结构,从而减少晶圆对静电卡盘的损伤。
由此可知凸点对静电卡盘来说是至关重要的结构,影响静电卡盘的使用寿命以及吸附性能。接下来本文将对静电卡盘上凸点的尺寸、电学性能进行研究。
-
本文使用物理气相沉积的方法制作静电卡盘的凸点结构。实验制作的凸点结构主要材料为碳,其结构为金刚石结构,因此硬度较大(大于50 GPa),可以有效的防止晶圆对凸点的磨损,单个凸点的电阻率约为500 Ω为导体材料。静电卡盘上凸点的尺寸通常在微米量级,在这一尺度上,使用白光干涉仪可以准确测量静电卡盘表面凸点形貌及对应尺寸。
测量得到静电卡盘表面凸点形貌的一维轮廓图如图9所示,从图中可以测量得到凸点的高度、凸点的面积以及凸点的表面形貌。
从图9可以看到,凸点表面具有一定弧度及粗糙度。依据J-R型静电卡盘的工作原理,凸点表面也会累积电荷,同时也会对晶圆产生吸附力。为了更好地研究凸点的吸附力,利用等效电容法,将凸点与晶圆之间的不规则间隙等效成一个光滑的接触层结构,如图10所示,其中
${h}_{{\rm{Mesa}}}$ 为凸点的高度、${h}_{{\rm{n}}}$ 为某一凸点上等效的间隙层厚度,${\delta }_{{\rm{n}}}$ 为某一凸点上等效间隙层厚度。并且由于晶圆表面粗糙度远小于凸点及介电层表面粗糙度,在本研究中认为晶圆表面为光滑平面,因此可以认为静电卡盘上等效间隙层厚度δ都来自于凸点表面粗糙度。在本文的研究中晶圆的材料为硅,属于半导体材料,因此可以认为静电卡盘表面电荷产生的电场将晶圆极性相反的电荷吸引到靠近静电卡盘一侧的表面。通过静电卡盘表面的电荷与晶圆表面的电荷之间的库仑力实现静电卡盘对晶圆的吸附。因此在本文中可以认为测量得到的第n个凸点的高度
${h}_{{\rm{Mesa}}\_{\rm{n}}}$ 为该凸点周围局部间隙层厚度${h}_{{\rm{n}}}$ 与接触层厚度$ {\mathrm{\delta }}_{\mathrm{n}} $ 之和,见图10,即在使用干涉仪测量凸点高度发现,虽然不同凸点之间高度相差在±1 μm之间,但是测试发现在静电卡盘同一半径上凸点之间的高度相差在±0.05 μm范围内,而通常凸点高度的平均值约为4 μm,因此可以认为在静电卡盘同一半径上的凸点高度相同,通过该假设可以计算出静电卡盘表面到晶圆下底面等效高度
$ h+\delta $ 与测量得到的凸点高度之间的关系,即:其中
$ {r}_{1} $ 、$ {r}_{2} $ 、…、${r}_{{\rm{n}}}$ 为静电卡盘某一半径上第1、2、…、n个凸点到静电卡盘中心的距离。${h}_{{\rm{Mesa}}\_1}$ 、${h}_{{\rm{Mesa}}\_2}$ 、…、${h}_{{\rm{Mesa}}\_n}$ 为静电卡盘某一半径上第1、2、……、n个凸点的高度。并且通过计算凸点的总面积与静电卡盘上的面积之比,可以计算出静电卡盘上有凸点区域面积占比η。
使用白光干涉仪测得凸点表面形貌结构,可以利用体积等效的方法,将晶圆与介电层之间粗糙的凸点加接触层结构等效成光滑的凸点加接触层结构。这样就可以等效计算出第n个点对应的接触层厚度
${\mathrm{\delta }}_{{\rm{n}}}$ 。使用物理气相沉积法得到的凸点高度为4.5 μm时,经等效计算得到凸点与晶圆之间接触层的厚度约为1.42 μm。由于需要计算的凸点结构较多,本文对接触层厚度进行如下假设:(1)在相同高度下,使用物理气相沉积法制备的凸点,经等效计算得到的接触层厚度相同。(2)使用物理气相沉积法制备的凸点,经等效计算得到的接触层厚度与凸点的高度成正比。本文通过上述两个假设,可以计算得到其他不同凸点对应的接触层厚度。 -
对于J-R型静电卡盘来说,凸点材料、硬度、压力,以及环境状态都会对凸点与晶圆之间的接触电阻造成极大的影响。很难通过理论计算来得到凸点与晶圆之间的接触电阻。在本文设计了如下实验来测试静电卡盘凸点结构与晶圆之间的接触电阻。实验所用腔室结构如图11所示,该结构测试晶圆与凸点之间接触电阻的方法如下:在晶圆靠近边缘处部分区域镀上一层铝薄膜,薄膜面积略微大于凸点的面积。按照同样的物理气相沉积的方法在静电卡盘的边缘位置再镀上一个凸点结构,再在静电卡盘的侧壁上镀上部分铝薄膜,并且使铝薄膜连接到靠近静电卡盘边缘的凸点上。将晶圆放置在静电卡盘凸点上,并且使晶圆上镀铝薄膜的区域完全覆盖在边缘的凸点上。之后使用金属导线,将晶圆上的铝薄膜和静电卡盘侧壁上的铝薄膜分别导通连接到腔室上的两个电引入(Feed-through)结构上。在腔室外,将两个电引入之间串联直流稳压测试电源与电流表结构。这样就使稳压电测试源、电流表、电引入结构、晶圆上铝薄膜、凸点晶圆之间接触电阻、凸点、静电卡盘上铝薄膜以及另一电引入结构之间连接成直流电路回路。由此可以通过稳压测试电源上电压除以电流表测得的电流值得到测试回路上的电阻值。在该测试回路中,铝薄膜的电阻值小于1 Ω,可以忽略铝薄膜对回路电阻的影响,因此可以认为测试回路测得的电阻为凸点与晶圆之间的接触电阻与凸点电阻串联之后的等效电阻。并且可以设置不同的吸附电压,测试不同吸附力下,晶圆与凸点之间的接触电阻。
通过实验测得的凸点上接触电阻与静电卡盘吸附电压之间的关系如图12所示。从测试结果中可以看到随着吸附电压的增加静电卡盘对晶圆的吸附力变大,凸点的接触电阻降低,并且凸点与晶圆之间的接触电阻
${\text{R}}_{{\rm{Contact}}}$ 小于$ {1\times 10}^{7} $ Ω,该测试结果对J-R型静电卡盘吸附力的研究至关重要,需要进一步讨论。接下来将根据凸点的机械尺寸以及电学性能,利用等效电容理论,建立物理计算模型,研究凸点、介电层的物理参数对静电卡盘吸附的影响。
-
本文依据等效电容理论建立静电卡盘吸附力计算模型。等效的电容方法的原理是,将静电卡盘表面划分成有凸点的结构以及没有凸点的结构,分别计算这两个结构内,电极与晶圆之间的等效电容值。最后通过并联电容计算,得到静电卡盘整个电极与晶圆之间的等效电容值,并依据电容电极间库仑力计算公式,计算得到静电卡盘对晶圆的吸附力。
静电卡盘的基本结构如图13所示,对于J-R型静电卡盘主要考虑以下结构晶圆、凸台、介电层、电极[18]。
其中对于局部单元结构放大图如图14所示。依据图14的结构和几何特征,其中关键的几何尺寸物理量包括介电层的厚度d,间隙层高度h,以及接触层的厚度δ。可以将电极和晶圆之间分为以下两种单元结构类型:(1)电极——介电层——间隙层——晶圆结构;(2)电极——介电层——凸点——接触界面——晶圆结构。
-
(1)电极——介电层——间隙层——晶圆结构中,对晶圆的吸附力主要来自于介电层表面电荷对晶圆的吸附力,其电路结构可以等效为间隙层电阻
${{R}}_{\text{Interval}}$ 与间隙层电容${{C}}_{\text{Interval}}$ 并联结构后与介电层电阻${{R}}_{{\rm{Dielectric}}}$ 串联。特别说明的是在本研究中所用到的J-R型静电卡盘介电层的厚度d远大于间隙h加接触层δ的高度,因此在本研究中忽略了电极本身对晶圆吸附的作用。对于(2)电极——介电层——凸点——接触界面——晶圆结构上,静电卡盘对晶圆的吸附主要来自于凸点表面的电荷对晶圆的吸引,其电路结构可以等效为接触层电阻${{R}}_{{\rm{Contact}}}$ 与接触层电容${{C}}_{{\rm{Contact}}}$ 并联结构后与凸点电阻${{R}}_{{\rm{Mesa}}}$ 及介电层电阻${{R}}_{{\rm{Dielectric}}}$ 串联结构。由上所述双极J-R型电路结构可以等效为电阻和电容如图15所示。在等效电路图15中,静电卡盘吸附电源的电压为U,静电卡盘正极和负极到晶圆之间的电阻几乎相同,并且正极到晶圆之间电阻与负极到晶圆之间电阻形成的是串联回路,因此每个电极到晶圆之间的电压为:通过图15的等效电路,可以建立计算J-R型静电卡盘对晶圆吸附力大小的仿真模型。在(1)电极——介电层——间隙层——晶圆结构中,间隙层的等效电容
${{C}}_{{\rm{Interval}}}$ 为:其中,
${\varepsilon }_{{\rm{g}}}$ 为间隙层和接触界面狭缝内填充气体的相对介电常数,$ {\varepsilon }_{0} $ 为真空介电常数,$ \varphi $ 为正电极或负电极有效面积与介电层表面积之比,在本研究中认为双D结构电极正极或负极介电层表面积之比相同都为$ \varphi $ ,A为介电层表面积,$ \eta $ 为所有凸点的总面积占介电层表面积的比例,h为间隙层高度,δ为接触层的厚度。在图15的等效电路中介电层电阻
${{R}}_{{\rm{Dielectric}}}$ 约在$ {1\times 10}^{10} $ ~$ {1\times 10}^{12} $ Ω的范围内,而间隙层电阻${{R}}_{\text{Interval}}$ 约在$ {1\times 10}^{15} $ ~$ {1\times 10}^{17} $ Ω范围内。因此可以忽略介电层电阻${{R}}_{{\rm{Dielectric}}}$ 对吸附电压的分压。因此在该结构中,介电层表面电荷与晶圆之间的电势为$ {U}_{\text{p}} $ 。而在凸点对晶圆吸附力的计算中,通过物理气象沉积制备得到的凸点结构电阻
${{R}}_{{\rm{Mesa}}}$ 的大小约为500 Ω,其阻值相对于介电层电阻${{R}}_{{\rm{Dielectric}}}$ 来说可以忽略不计;接下来将着重讨论接触层电阻对J-R型静电卡盘吸附力的影响。接触层的等效电容
${{C}}_{{\rm{Contact}}}$ 两极的电压可以通过接触电阻的大小${{R}}_{{\rm{Contact}}}$ 与介电层电阻${{R}}_{{\rm{Dielectric}}}$ 之间的分压来决定。因此接触层电容${{C}}_{{\rm{Contact}}}$ 两极之间的电压为:依据图13中得到的接触电阻随吸附电压变化的曲线可以看到接触电阻
${{R}}_{{\rm{Contact}}}$ 小于$ {1\times 10}^{7} $ Ω,并且该电阻值随着吸附力随着吸附电压增加而减小。依据J-R型静电卡盘的介电层本身电阻率特性,可以计算出凸点与电极之间介电层电阻${{R}}_{{\rm{Dielectric}}}$ 在$ {1\times 10}^{9} $ ~$ {1\times 10}^{12} $ Ω之间。因此,依据图13中电阻率曲线,可以知道,在静电卡盘吸附晶圆时,接触层电阻${{R}}_{{\rm{Contact}}}$ 远小于该面元处介电层电阻${{R}}_{{\rm{Dielectric}}}$ 。所以由式(7)中可以计算得到电容${{C}}_{{\rm{Contact}}}$ 两极之间的分压$ {U}_{{\rm{Contact}}} $ 相对吸附电压低得多,可以忽略。由此可以得出如下结论,在本文中使用物理气相沉积得到的J-R性静电卡盘中,静电卡盘的吸附力主要来自于介电层表面的电荷。由此可以计算静电卡盘对硅晶圆的吸附力公式为: -
在本文中,选取一个静电卡盘结构测试吸附电压对吸附力的影响。得到的实验与模型仿真结果如图16所示。由于在实验过程是非连续性增加背吹气体流量,因此测试得到的背吹气压值有10 N左右的测试误差。限于气体流量计以及真空规的量程所限,测试吸附电压的大小最大能达到420 V。从图中可以看到,在实验结果中随着吸附电压的升高,静电卡盘的吸附力成指数增长。仿真结果中吸附力大小随凸点高度变化的趋势与实验结果一致,并且仿真结果在测试结果的误差范围内。由此来看建立的仿真模型可以预测该种静电卡盘吸附力的大小。
-
在本文中,对四个具有不同凸点高度的静电卡盘进行测试,分别测试了静电卡盘在加载400 V吸附电压的情况下,静电卡盘的吸附力。由于制作凸点工艺的限制,这四块静电卡盘凸点的平均高度在3.2~3.8 μm的范围内。制作的平均凸点高度在这个范围内,静电卡盘的吸附力较稳定;如果凸点高度偏低,那么晶圆有可能会与静电卡盘陶瓷面接触,干扰测试结果;如果凸点偏高,那么凸点高度的均匀性会变差,会导致局部吸附力偏低,干扰测试结果。接下来将对比讨论实验测试结果与仿真计算的结果。
图17为具有凸点高度的J-R型静电卡盘,在使用400 V吸附电压下,吸附力的实验与仿真结果。从图中可以看到无论是实验还是仿真结果,随着凸点高度的增加,静电卡盘的吸附力降低。仿真结果在测试结果的误差范围内,并且仿真结果中吸附力大小随凸点高度变化的趋势与实验结果一致。从结果来看在3.2~3.8 μm凸点高度范围内,建立的静电卡盘吸附力仿真模型可以有效计算静电卡盘的吸附力的大小。但是从结果来看随着凸点高度的增加仿真与实验结果偏差变大,这是由于凸点高度增加,凸点高度分布不均匀所导致的。
本文以后的研究工作需要改进实验,使制作的静电卡盘的凸点结构具有更多的高度大小,而这些静电卡盘结构将用于凸点高度分布对静电卡盘吸附力影响的研究。从本文研究的结果来看,凸点接触层的厚度对静电卡盘吸附力的大小影响很小,这是由于实验使用的是硅材料晶圆。但是在半导体领域中还经常使用氧化硅、氮化硅材料晶圆,他们属于绝缘材料,而对于该种绝缘材料对J-R型静电卡盘吸附力大小的影响需要进一步的研究。
-
本文以半导体装中使用的J-R型静电卡盘为研究对象,使用物理气相沉积的方法制备了静电卡盘凸点结构。并搭建介绍了静电卡盘吸附测试的真空腔室平台。
本文依据等效电容方法并通过合理的简化与相关测试,建立了文中这种J-R型静电卡盘的等效电路模型,并从中得到了描述静电随凸点结构、参数变化的解析表达式,进而研究了文中提到的这种J-R型静电卡盘的吸附力随凸点电学性能、尺寸结构变化的规律。即,(1)由于凸点与硅晶圆接触电阻远低于介电层的电阻,J-R型静电卡盘上的凸点几乎不为硅晶圆提供吸附力。(2)凸点的高度、凸点占比增加,会使J-R型静电卡盘对硅晶圆的吸附力降低。(3)仿真结果显示凸点表面形貌几乎不影响静电卡盘对硅晶圆的吸附力。
本文的实验与仿真结果,可以为今后静电卡盘的改进、新需求静电卡盘的设计提供理论依据。但是由于制备工艺的限制,文中的理论具有一定的局限性,接下来还需要在凸点对J-R型静电卡盘吸附力影响方面进行进一步的研究。其中包括(1)凸点形状、高度分布对J-R型静电卡盘吸附力的影响;(2)该种结构静电卡盘对绝缘材料晶圆吸附力的影响。
凸点结构及电学性能对J-R型静电卡盘吸附力影响的研究
The Effect of Structure and Electrical Properties of the Mesa on the Electrostatic Chuck Force
-
摘要: 真空静电卡盘是半导体工艺中最重要的元件之一,主要应用于集成电路设备和光学设备,起到承载晶圆或衬底的作用。本文利用物理气相沉积的方法制备了J-R型静电卡盘的凸点结构。本研究中搭建了真空腔室,利用了气体背吹法,测试了不同凸点高度、不同吸附电压下约翰逊-拉别克型静电卡盘的吸附力。利用等效电容法,建立了计算凸点电学性能、结构尺寸对静电卡盘吸附力影响的仿真模型。通过仿真计算对吸附力大小的研究表明,由于接触电阻相对较低,文中方法制备的J-R型静电卡盘凸点结构几乎不对硅晶圆产生吸附力。并且随着凸点高度及凸点面积占比增加,静电卡盘对硅晶圆的吸附力降低,同时凸点表面形貌几乎不影响凸点吸附力。本文的研究对J-R效应理论的完善以及静电卡盘的设计具有重要指导意义,为半导体设备的发展提供重要的理论基础。Abstract: Electrostatic chuck is one of the most important elements in the semiconductor field, mainly used in integrated circuit equipment and optical equipment, playing the role of carrying wafers and substrates. In this article, we use the physical vapor deposition method to make the mesa of Johnsen-Rahbek type electrostatic chuck. In this research, we built a vacuum chamber and used the back gas method to test the chuck force of the Johnsen-Rahbek type electrostatic chuck with different mesa heights and different chuck voltages. We built the mathematical model to study the effect of electrical properties and mechanical dimensions in chuck force with the equivalent capacitance method. The experiment and simulation results show that because of the low contact resistance, there is nearly no chuck force between the mesa and silicon wafers. And with the increasing height of the mesa and increasing the proportion of the area of the mesa, the chuck force between the mesa and silicon wafer decreases. In addition, we found that the surface topography has nearly no effect on the chuck force between the mesa and silicon wafer. This research has important guidance for the improvement of Johnsen-Rahbek effect theory and the structure designing of the electrostatic chuck, and provides a theoretical basis for the development of semiconductor equipment.
-

-
-
[1] Choe H H. Basic study of a glass substrate in dry etching system[J]. Vacuum,2006,81(3):344−346 doi: 10.1016/j.vacuum.2006.06.010 [2] Goodman D L. Effect of wafer bow on electrostatic chucking and back side gas cooling[J]. Journal of Applied Physics,2008,104(12):124902 doi: 10.1063/1.3043843 [3] Wright D R. Chen L, Federlin P, et al. Manufacturing issues of electrostatic chucks[J]. Journal of Vacuum Science and Technology B,1995,13(4):1910−1916 doi: 10.1116/1.588108 [4] Kurkowski P, Drizlikh S, Sarver R, et al. Effects of wafer bow and warpage on performance of electrostatic chucks in high volume manufacturing[C]. Advanced Semiconductor Manufacturing Conference and Workshop, 2005 IEEE/SEMI. Munich: IEEE, 2005: 127-129 [5] Chang C H. Leou K C, Lin C, et al. Real-time control of ion density and ion energy in chlorine inductively coupled plasma etch processing[J]. Journal of Vacuum Science and Technology A,2003,21(4):1183−1187 doi: 10.1116/1.1575222 [6] Choi D Y. Kim N H, Kim S Y. Reduction of loading effects with the sufficient vertical profile for deep trench silicon etching by using decoupled plasma sources[J]. Journal of Materials Processing Technology,2009,209(17):5818−5829 doi: 10.1016/j.jmatprotec.2009.06.014 [7] Abraham I C. Woodworth J R, Riley M E, et al. Electrical and plasma property measurements of a deep reactive ion etching Bosch process[J]. Journal of Vacuum Science and Technology B,2003,21(3):1112−1117 doi: 10.1116/1.1565145 [8] Wright D R. Hartman D C, Sridharan U C, et al. Low temperature etch chuck: modeling and experimental results of heat transfer and wafer temperature[J]. Journal of Vacuum Science and Technology A,1992,10(4):1065−1070 doi: 10.1116/1.578203 [9] Meyer J A. Kirmse K H R, Jenq J S, et al. Experiments with back side gas cooling using an electrostatic wafer holder in an electron cyclotron resonance etching tool[J]. Applied Physics Letters,1994,64(15):1926−1928 doi: 10.1063/1.111744 [10] Shan H. Pu B Y, Gao H, et al. Process kit and wafer temperature effects on dielectric etch rate and uniformity of electrostatic chuck[J]. Journal of Vacuum Science and Technology B,1996,14(1):521−526 doi: 10.1116/1.588507 [11] Kalkowski G, Peschel T, Hassall G, et al. Investigations into an electrostatic chuck design for 450 mm Si wafer[C]. Starikov A eds. Proceedings of SPIE 8324, Metrology, Inspection, and Process Control for Microlithography XXVI, San Jose, USA, 12 February 2012, paper no. 83242Z, pp. 1-9. Bellingham: SPIE [12] Qiu X. Tang R, Zhu J, et al. The effects of temperature, relative humidity and reducing gases on the ultraviolet response of ZnO based film bulk acoustic-wave resonator[J]. Sensors and Actuators B:Chemical,2011,151(2):360−364 doi: 10.1016/j.snb.2010.07.052 [13] Qin S. McTeer A. Wafer dependence of Johnsen-Rahbek type electrostatic chuck for semiconductor processes[J]. Journal of Applied Physics,2007,102(6):064901 doi: 10.1063/1.2778633 [14] Watanabe T. Kitabayashi T, Nakayama C. Electrostatic force and absorption current of alumina electrostatic chuck[J]. Japanese Journal of Applied Physics,1992,31(7):2145−2150 [15] Field J. Electrostatic wafer clamping for next-generation manufacturing[J]. Solid State Technology,1994,37(9):91−93 [16] Wardly G A. Electrostatic wafer chuck for electron beam microfabrication[J]. Review of Scientific Instruments,1973,44(10):1506−1509 doi: 10.1063/1.1685985 [17] Shim G II. Sugai H. Temporal analysis of electrostatic chuck characteristics in inductively coupled plasma[J]. Plasma and Fusion Research,2008,3:028 doi: 10.1585/pfr.3.028 [18] Wang K S. Cheng J, Zhong Y, Ji L H. A novel measuring method of clamping force for electrostatic chuck in semiconductor devices[J]. Journal of Semiconductors,2016,37:044012 doi: 10.1088/1674-4926/37/4/044012 -


 首页
首页 登录
登录 注册
注册



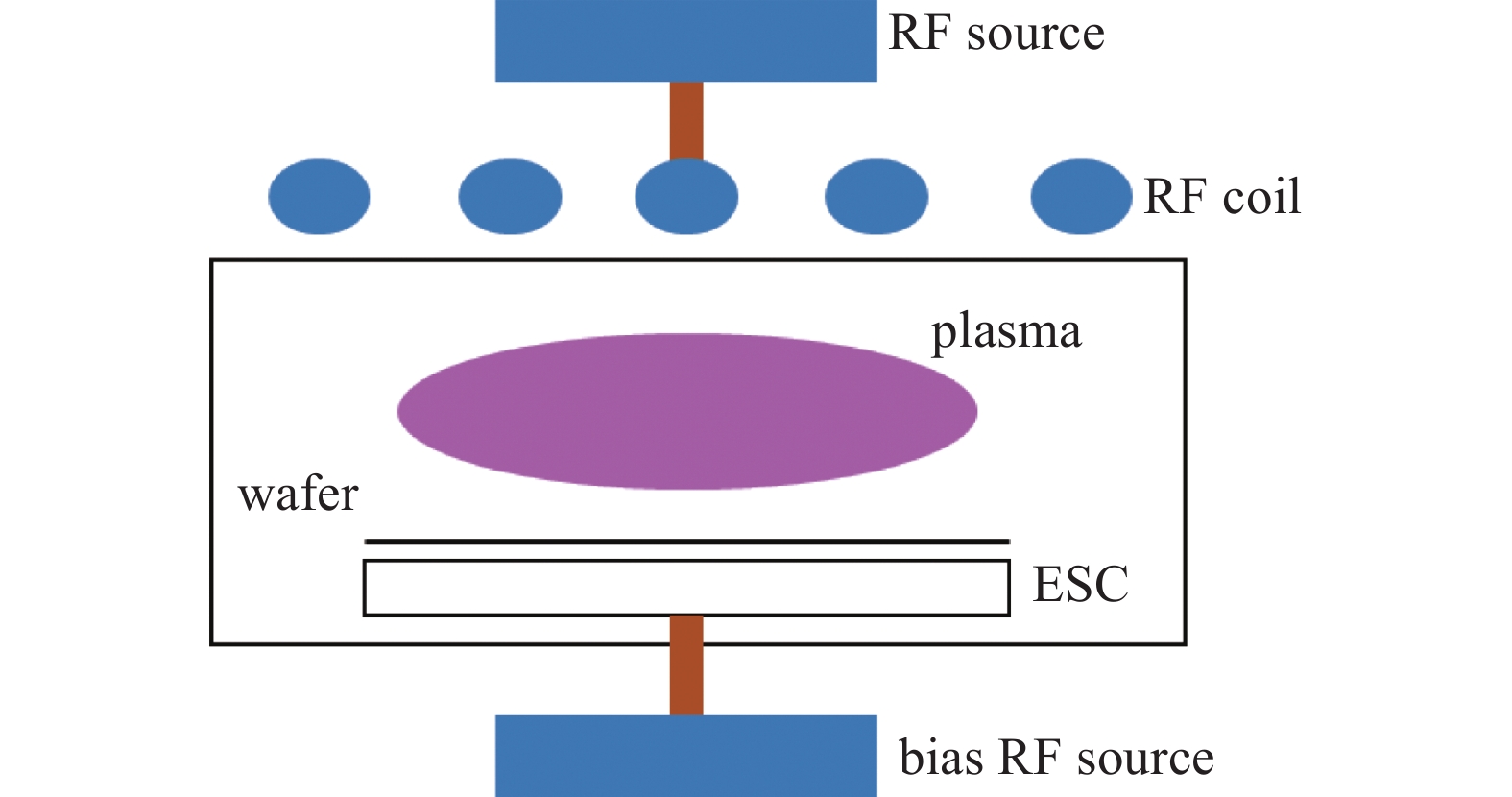
 下载:
下载: